Управление изолированными затворами MOSFET/IGBT, базовые принципы и основные схемы
Управление изолированным затвором: основные положения
В общем случае процесс перезаряда емкостей затвора может контролироваться сопротивлением, напряжением и током (рис. 1) [2].
Рис. 1. Управление затвором:
а) с помощью сопротивления;
б) напряжения;
в) тока
На практике чаще всего используется самый простой вариант (рис. 1а) с двумя раздельными резисторами для режимов включения и выключения, при этом одним из наиболее важных параметров является уровень «Плато Миллера», соответствующий плоской части характеристики затвора (рис. 2). Скорость и время коммутации задаются величиной RG при фиксированном напряжении управления VGG; чем меньше резистор затвора, тем быстрее происходит переключение. Отметим, что при использовании новейших поколений IGBT (например, Trench 4) может наблюдаться аномальная картина: при изменении RG в некотором диапазоне скорость выключения di/dt растет вместе с сопротивлением. Этот факт требует очень внимательного анализа, особенно при замене транзисторов предыдущих генераций [3].
Этот факт требует очень внимательного анализа, особенно при замене транзисторов предыдущих генераций [3].
Рис. 2. Ток и напряжение на затворе:
а) при включении;
б) выключении
К недостаткам «резистивного» метода управления можно отнести влияние разброса емкостей затвора на время коммутации и величину динамических потерь, а также упомянутую выше неопределенность зависимости di/dt от RG для некоторых типов современных транзисторов.
Прямое управление от источника напряжения (рис. 1б) устраняет данную зависимость, скорость коммутации в этом случае определяется фронтом прикладываемого к затвору сигнала dv/dt. Как следствие, на характеристике затвора наблюдается только незначительный участок «плато Миллера» или он отсутствует вообще. При использовании такого метода выходной каскад драйвера должен обеспечивать достаточный уровень напряжения и тока в течение всего времени коммутации. По сравнению со схемой 1а управление по напряжению требует применения гораздо более сложного и дорогого драйвера.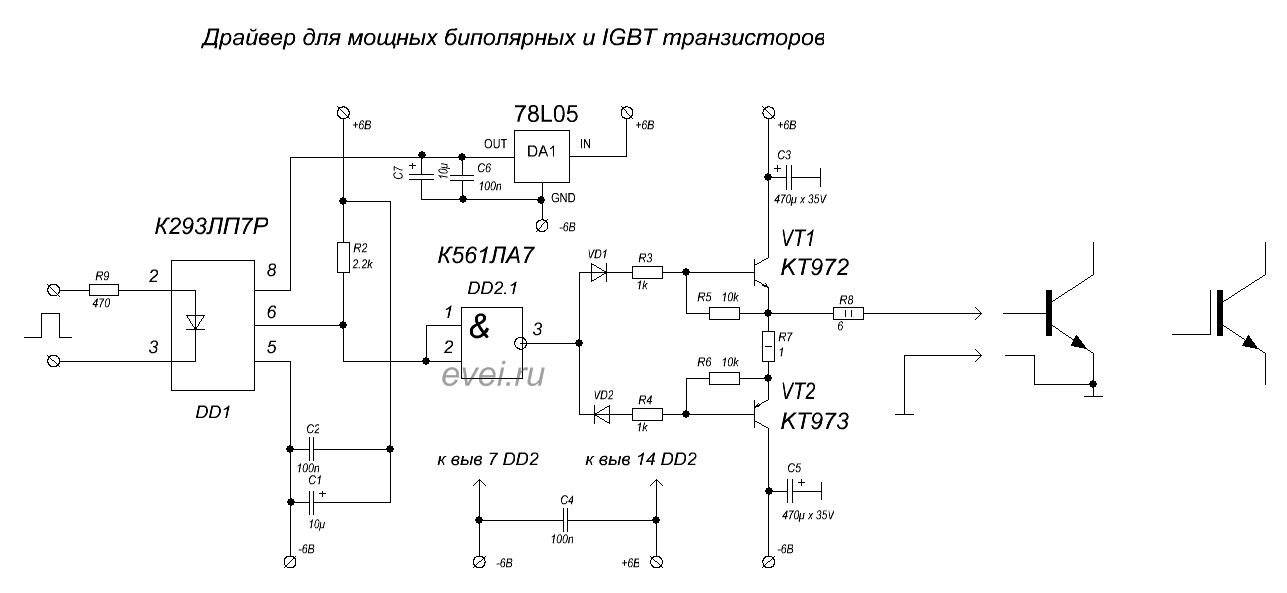 Возможным компромиссом является использование комбинированного динамического метода контроля, при котором сигнал на затвор подается через резистор от регулируемого источника напряжения.
Возможным компромиссом является использование комбинированного динамического метода контроля, при котором сигнал на затвор подается через резистор от регулируемого источника напряжения.
Токовое управление предусматривает использование источника «положительного» и «отрицательного» тока (рис. 1в), величина которого определяет скорость перезаряда затвора. Этот метод сопоставим с «резистивным», на практике он, как правило, используется в аварийных режимах для безопасного прерывания тока перегрузки или КЗ.
На рис. 2 показаны эпюры тока затвора iG и напряжения «затвор-эмиттер» VGE для схемы с «резистивным» контролем. Абсолютное максимальное значение напряжения управления VGG обеих полярностей определяется электрической прочностью изоляции затвора, для всех современных MOSFET/IGBT оно ограничено на уровне ±20 В. Эта величина не должна превышаться при всех условиях эксплуатации, включая аварийные режимы, что требует в ряде случаев принятия специальных мер.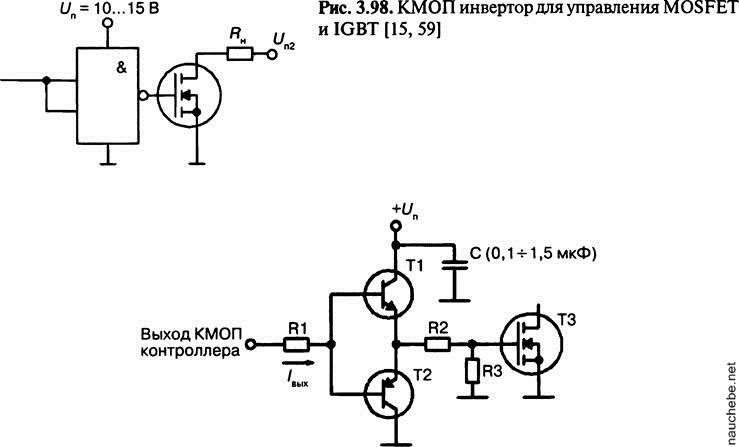
Сопротивление открытого канала полевого транзистора RDS(on) и напряжение насыщения IGBT VCE(sat) снижаются при увеличении амплитуды сигнала управления. Рекомендуемая номинальная величина VGS(on) для MOSFET составляет 10 В, VGE(on) для IGBT — 15 В, все статические и динамические характеристики полупроводников нормируются при данных условиях. При этих значениях обеспечивается приемлемый компромисс между мощностью рассеяния, пиковым током включения и стойкостью к КЗ. Есть также отдельный класс полевых транзисторов, управляемых непосредственно от логических элементов (logic-level MOSFET), они включаются при VGS(on) = +5 В.
Как показано на рис. 2, блокирование IGBT должно производиться отрицательным напряжением, рекомендуемые уровни VGE_off (в зависимости от мощности прибора): -5/-8/-15 В. В течение всего времени toff (даже если напряжение управления достигает величины VGE(th)) это позволяет поддерживать отрицательный ток затвора, что необходимо для быстрого и безопасного отключения.
В некоторых источниках рекомендуется использование нулевого напряжения выключения VGEoff = 0. Однако в мощных полумостовых каскадах в этом случае возникает опасность появления сквозного тока при обратном восстановлении антипараллельного диода вследствие обратной связи по dvCE/dt (рис. 3). Крутой фронт напряжения «коллектор-эмиттер» vCE2 при восстановлении D2 приводит к образованию тока смещения iv (iv = CGC2 × dvCE/dt) через емкость Миллера, который создает падение напряжения на RG (или RGE/RG). При этом уровень наведенного на затворе сигнала может превысить порог VGE(th), вследствие чего транзистор Т2 перейдет в активную зону. Генерируемый в процессе обратного восстановления сквозной ток создает дополнительные потери мощности на ключах Т1 и Т2.
Рис. 3. Сквозной ток в полумостовом каскаде IGBT из-за ложного включения Т2 вследствие обратной связи по dv/dt:
а) электрическая схема;
б) эпюры тока и напряжения
Сказанное выше не относится к мощным MOSFET-ключам, хотя ложное срабатывание из-за наличия паразитных элементов может произойти и в них. При коммутации MOSFET точно так же возникает ток смещения, проходящий через емкость CDS к базе паразитной биполярной n-p-n-структуры. Если падение напряжения на резисторе RW в поперечном р-кармане (рис. 4) превысит пороговый уровень отпирания n-p-n-транзистора, то он откроется, и это может привести к полному разрушению MOSFET вследствие локального перегрева.
При коммутации MOSFET точно так же возникает ток смещения, проходящий через емкость CDS к базе паразитной биполярной n-p-n-структуры. Если падение напряжения на резисторе RW в поперечном р-кармане (рис. 4) превысит пороговый уровень отпирания n-p-n-транзистора, то он откроется, и это может привести к полному разрушению MOSFET вследствие локального перегрева.
Рис. 4. Ячейка MOSFET:
а) структура с основными паразитными элементами;
б) эквивалентная электрическая схема
Однако паразитное включение полевого канала при VGS = 0 снижает величину dvDS/dt в заблокированном состоянии и таким образом ослабляет негативный эффект от наличия паразитного транзистора. Кроме того, при этом уменьшается значение dv/dt в момент запирания внутреннего диода MOSFET и, следовательно, исключается возможность его повреждения вследствие динамического стресса.
В практических схемах драйверов MOSFET иногда применяется режим запирания нулевым напряжением на время коммутации диода и отрицательным сигналом в статическом состоянии.
Ток и мощность управления
Общая мощность PGavg, необходимая для управления MOSFET/IGBT, определяется на основе значения заряда затвора QGtot, приводимого в технических характеристиках:
Пиковый ток затвора зависит от напряжения управления и сопротивления в цепи затвора:
Формула позволяет получить идеальные значения; в реальности ток всегда меньше, поскольку он ограничен выходным импедансом драйвера, индуктивностью цепи управления и входными емкостями MOSFET/IGBT. Чем меньше резистор затвора RG, тем больше разница расчетных и реальных значений IGM.
Для определения мощности управления (на один канал) используются следующие формулы):
Параметры драйвера и динамические характеристики
Как было сказано выше, статические и динамические характеристики силовых ключей во многом определяются параметрами схемы управления (табл. 1).
| Характеристика | VGG+ | VGG- | RG |
| RDSon, VCEsat | > | — | — |
| ton | > | < | < |
| Eon | > | — | < |
| toff | < | > | < |
| Eoff | — | > | < |
| Пиковый ток включения транзистора* | < | — | > |
| Пиковый ток выключения диода* | < | — | > |
| Пиковое напряжение при включении транзистора* | — | < | > |
| di/dt | < | < | >** |
| dv/dt | < | < | > |
| Ток самоограничения ID, IC | < | — | — |
| Стойкость к КЗ нагрузки | > | — | < |
Примечания: «<» — увеличение; «>» — уменьшение; «-» — нет влияния; * — в режиме «жесткого переключения» при активно-индуктивной нагрузке; ** — не постоянно в диапазоне изменения RG при выключении.
Прямые характеристики R
DSon, VCEsat
Зависимость прямых характеристик MOSFET и IGBT от параметров управления может быть определена на основе их выходных характеристик. На рис. 5 это поясняется на примере графиков, взятых из спецификаций модулей SEMITRANS компании SEMIKRON.
Рис. 5. Прямые характеристики при разных значениях VG:
а) MOSFET;
б) IGBT
Время коммутации и энергия потерь (t
on, toff, Eon, Eoff)
Напряжение управления и сопротивление в цепи затвора влияют на время включения ton = td(on)+tr, выключения toff = td(off) + tf и продолжительность «хвостового» тока t. Поскольку для включения IGBT емкости затвора необходимо зарядить до порогового уровня, время перезаряда между циклами коммутации (задержка включения и выключения td(on) и tdff)) будет снижаться при уменьшении резистора RG.
С другой стороны, время нарастания и спада тока (tr/tf) и, следовательно, значительная часть энергии потерь Eon и Eoff в высокой степени зависят от параметров цепи управления: VGG+, VGG- и RG. В технических характеристиках IGBT приводятся графики зависимости времени коммутации и энергии переключения от сопротивления затвора; в большинстве случаев они нормированы для номинального тока и режима «жесткой» коммутации активно-индуктивной нагрузки (рис. 6).
Рис. 6. Зависимость от RG: а) временных характеристик IGBT; б) потерь переключения (режим «жесткой коммутации», активно-индуктивная нагрузка; Tj = +125 °C, Vce = 600 B, IC = 75 A, VGE = ±15 В)
Динамические характеристики оппозитного диода
На графике Eon, приведенном на рис. 6б, учтено влияние процесса обратного восстановления оппозитного диода на ток коллектора и потери включения IGBT.
Время нарастания tr тока коллектора/стока (ID/Ic) снижается с ростом тока затвора (при увеличении VGG+ или уменьшении RG). При этом также возрастает скорость коммутации dIF/dt оппозитного диода, его заряд Qrr и пиковый ток восстановления IRRM. Все эти зависимости приводятся в спецификациях силовых ключей (рис. 7 и 8). В свою очередь, увеличение Qrr и IRRM приводит к росту потерь выключения диода.
При этом также возрастает скорость коммутации dIF/dt оппозитного диода, его заряд Qrr и пиковый ток восстановления IRRM. Все эти зависимости приводятся в спецификациях силовых ключей (рис. 7 и 8). В свою очередь, увеличение Qrr и IRRM приводит к росту потерь выключения диода.
Рис. 7. Заряд Qrr:
а) и пиковый ток восстановления IRRM;
б) оппозитного диода IGBT модуля SKM100GB123D в зависимости от скорости изменения тока диода dlF/dt
Рис. 8. Потери выключения EoffD оппозитного диода в зависимости от RG при включении транзистора
Поскольку повышение dIF/dt вызывает соответствующее изменение Qrr и IRRM, а IRRM в свою очередь добавляется к IC (ID), то пиковый ток транзистора и его потери включения увеличиваются пропорционально скорости включения (рис. 6).
При увеличении напряжения выключения VGG- (или снижении RG) начинает расти ток выключения затвора. Как показано на рисунке 6а, время спада tf при этом снижается, соответственно растет di/dt. Негативным следствием увеличения скорости коммутации является появление опасных коммутационных всплесков напряжения на распределенных индуктивностях Ls силовых цепей, амплитуда которых пропорциональна di/dt и Ls. Более подробно вопросы нормирования параметров цепей управления рассмотрены в [8, 9, 10].
Как показано на рисунке 6а, время спада tf при этом снижается, соответственно растет di/dt. Негативным следствием увеличения скорости коммутации является появление опасных коммутационных всплесков напряжения на распределенных индуктивностях Ls силовых цепей, амплитуда которых пропорциональна di/dt и Ls. Более подробно вопросы нормирования параметров цепей управления рассмотрены в [8, 9, 10].
Базовая схема управления затвором
На рис. 9 приведена блок-схема высококачественного устройства управления полумостовым каскадом MOSFET/IGBT. В дополнение к базовым функциям такой драйвер блокирует одновременное включение транзисторов стойки (функция TOP/BOTTOM Interlock), а также осуществляет защиту от перегрузок, мониторинг основных режимов и нормирование формы входных импульсов.
Рис. 9. Базовая структура полумостового каскада со схемой управления, осуществляющей функции защиты и мониторинга
Устройство обрабатывает сигналы управления ключами верхнего (ТОР) и нижнего (ВОТ) уровня, полученные от центрального процессора, осуществляет их потенциальную изоляцию, доводит амплитуду и мощность до уровня, необходимого для перезаряда затвора на частоте коммутации. Кроме того, схема защиты анализирует аварийные состояния и формирует обобщенный сигнал неисправности, который передается во входной низковольтный каскад.
Кроме того, схема защиты анализирует аварийные состояния и формирует обобщенный сигнал неисправности, который передается во входной низковольтный каскад.
В маломощных и недорогих драйверах может отсутствовать гальваническая развязка, в этом случае для передачи сигнала управления на затвор ТОР транзистора используется каскад сдвига уровня. Как правило, в подобных устройствах питание верхних каскадов осуществляется от бутстрепных емкостей. Самая простая схема без потенциальной изоляции и сдвига уровня применяется для управления одиночными ключами нижнего уровня (например, тормозным чоппером). В этом случае задачей драйвера является только обеспечение достаточного напряжения и тока затвора.
Каскад управления затвором является ключевым узлом драйвера, определяющим его временные характеристики, требования к изоляции, уровень и мощность сигнала VGE. Он также осуществляет защиту ключа от перегрузки по току и КЗ, в ряде случаев в устройство может быть интегрирована цепь активного ограничения напряжения на коллекторе.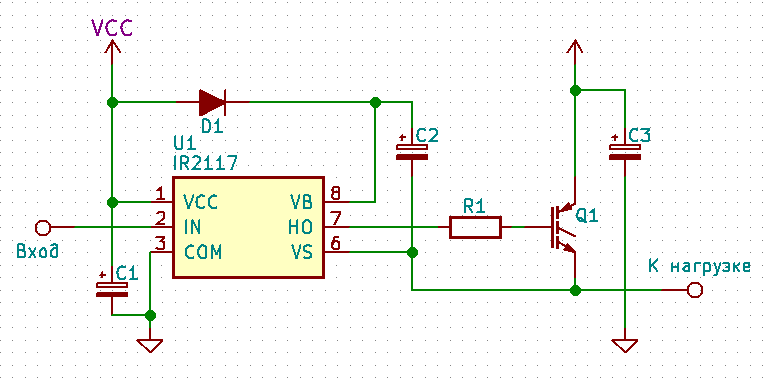 На рис. 10 приведена базовая схема выходного каскада с раздельными цепями включения (положительным напряжением VGG+) и выключения (отрицательным напряжением VGG-) затвора. В двухтактной («пушпульной») схеме обычно используется комплементарная пара полевых или биполярных транзисторов.
На рис. 10 приведена базовая схема выходного каскада с раздельными цепями включения (положительным напряжением VGG+) и выключения (отрицательным напряжением VGG-) затвора. В двухтактной («пушпульной») схеме обычно используется комплементарная пара полевых или биполярных транзисторов.
Рис. 10. Выходной каскад драйвера с раздельными цепями управления включением и выключением затвора
Резистор затвора на рис. 10 разделен на две составляющие: RGon и RGoff, что позволяет независимо оптимизировать динамические характеристики в режиме включения и выключения. Такая схема также ограничивает уровень сквозного тока в цепи VGG+/VGG-, возникающего при коммутации MOSFET. Если у драйвера есть только один выход, то для разделения на RGon и RGoff используется диод, подключенный последовательно с одним из резисторов [9].
Установка резистора утечки RGE (10-100 кОм) не является обязательной, однако это полезно, например, для защиты затвора от статического разряда в тех случаях, когда выход драйвера подключается с помощью разъема и есть вероятность пропадания контакта. Кроме того, использование RGE позволяет предотвратить нежелательный заряд емкостей затвора, который может произойти в режимах, характеризующихся высоким импедансом цепи управления (коммутация, выключенное состояние, повреждение источника питания драйвера).
Кроме того, использование RGE позволяет предотвратить нежелательный заряд емкостей затвора, который может произойти в режимах, характеризующихся высоким импедансом цепи управления (коммутация, выключенное состояние, повреждение источника питания драйвера).
Низкоиндуктивная емкость (С) на выводах питания драйвера работает как буфер, позволяющий снизить динамическое выходное сопротивление драйвера и обеспечить высокое пиковое значение тока затвора при коммутации. Она также выполняет полезную функцию при пассивном ограничении напряжения на затворе с помощью диода Шоттки, подключаемого между затвором и цепью VGG+.
Кроме сказанного выше, при проектировании выходного каскада драйвера необходимо принимать во внимание следующие аспекты:
- Цепь управления затвором должна иметь минимальную индуктивность, для чего ее рекомендуется выполнять витой парой, особенно если длина соединения превышает 5 см.
- Следует минимизировать влияние силовых линий на цепь затвора, оно может вызваться паразитной обратной связью по выводу эмиттера или контуру заземления.

- Следует исключить трансформаторные и емкостные связи цепей затвора и коллектора, наличие которых может привести к возникновению паразитных осцилляций.
Как видно из блок-схемы, представленной на рис. 9, в состав высококачественного устройства управления входит входной фильтр, блок нормирования формы импульсов, генератор «мертвого времени» и подавитель коротких импульсов. Все эти узлы не только вносят временную задержку, но и влияют на глубину модуляции, что необходимо учитывать при проектировании системы [8].
Защитные и контрольные функции драйверов
Защита силовых ключей от разного рода аварийных ситуаций является одной из важнейших функций схемы управления. Для ее реализации драйверы снабжаются блоками оперативного мониторинга перегрузки по току и КЗ, перенапряжения на коллекторе и затворе, перегрева, а также падения напряжения управления VGG+/VGG-.
Защита от перегрузки по току
Измерение тока коллектора/стока производится с помощью резистивных шунтов, токовых трансформаторов, индукционных сенсоров и т. д. Одним из самых распространенных методов мониторинга состояния токовой перегрузки является измерение напряжения насыщения транзистора. Выход из насыщения (Desaturation), при котором величина VCEsat достигает определенного порога, рассматривается как аварийная ситуация. При этом драйвер блокирует силовые транзисторы и формирует сигнал неисправности ERROR, который через изолирующий барьер передается на входной каскад и далее на контроллер. Интеллектуальные модули высокой степени интеграции (например, SKiiP компании SEMIKRON) имеют в своем составе датчики тока, информация с которых используется схемой защиты вместе с напряжением насыщения, что позволяет сократить время реакции и отключить IGBT при меньшем уровне перегрузки.
д. Одним из самых распространенных методов мониторинга состояния токовой перегрузки является измерение напряжения насыщения транзистора. Выход из насыщения (Desaturation), при котором величина VCEsat достигает определенного порога, рассматривается как аварийная ситуация. При этом драйвер блокирует силовые транзисторы и формирует сигнал неисправности ERROR, который через изолирующий барьер передается на входной каскад и далее на контроллер. Интеллектуальные модули высокой степени интеграции (например, SKiiP компании SEMIKRON) имеют в своем составе датчики тока, информация с которых используется схемой защиты вместе с напряжением насыщения, что позволяет сократить время реакции и отключить IGBT при меньшем уровне перегрузки.
Защита от перенапряжения на затворе
Функцию ограничения напряжения на затворе рекомендуется реализовывать в любом драйвере, независимо от наличия аварийной ситуации. Кроме защиты затвора от пробоя, это позволяет ограничить ток КЗ. Подробнее данный вопрос будет рассмотрен далее.
Защита от перенапряжения на коллекторе (стоке)
Ограничение напряжения на силовых терминалах может осуществляться самим модулем (большинство MOSFET обладает стойкостью к лавинному пробою), внешними пассивными снабберами, а также активными цепями, переводящими транзистор в линейный режим при возникновении опасного перенапряжения.
В ряде интеллектуальных модулей (например, SKiiP) реализована функция запрета коммутации при достижении напряжением DC-шины порогового уровня. Эта опция не способна защитить от внешних перенапряжений, однако она позволяет исключить влияние коммутационных выбросов в критических режимах, что существенно повышает надежность работы преобразовательного устройства. Мониторинг напряжения питания производится «квази-изолированным» датчиком на основе высокоомного дифференциального усилителя, передающего аналоговый сигнал, пропорциональный VDC, на схему управления. Если величина VDC превышает заданный уровень, силовые транзисторы отключаются, и схема защиты формирует сигнал неисправности. В ряде случаев параллельно цепи питания инвертора устанавливается тормозной чоппер, активно разряжающий конденсаторы звена постоянного тока при опасном увеличении напряжения. Такая схема чаще всего применяется в приводах, где используется режим динамического торможения (электротранспорт, лифты и т. д.).
В ряде случаев параллельно цепи питания инвертора устанавливается тормозной чоппер, активно разряжающий конденсаторы звена постоянного тока при опасном увеличении напряжения. Такая схема чаще всего применяется в приводах, где используется режим динамического торможения (электротранспорт, лифты и т. д.).
Защита от перегрева
Температура силовых кристаллов, а также изолирующей подложки рядом с чипами, корпуса модуля и радиатора может быть определена расчетным методом или с помощью сенсоров. Если термодатчик гальванически изолирован, то его выходной сигнал передается на схему управления и используется для отключения силового каскада и формирования сигнала неисправности.
Защита от падения напряжения управления V
GG+, VGG- (Under Voltage LockOut, UVLO)
Падение напряжения питания выходного каскада драйвера и, соответственно, уровня VGE нежелательно по многим причинам. В первую очередь при этом возрастает опасность перехода ключа в линейный режим работы и резкого увеличения рассеиваемой мощности.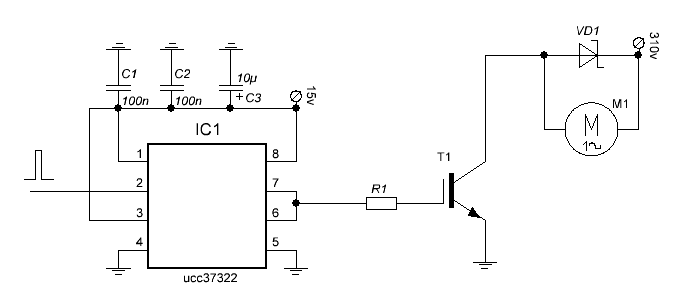 Кроме того, в этом случае теряется управляемость: транзистор не может быть полностью открыт или заблокирован. Мониторинг критического состояния производится путем измерения величин VGG+, VGG- с последующим отключением силового каскада при их снижении до опасного уровня.
Кроме того, в этом случае теряется управляемость: транзистор не может быть полностью открыт или заблокирован. Мониторинг критического состояния производится путем измерения величин VGG+, VGG- с последующим отключением силового каскада при их снижении до опасного уровня.
Временные характеристики и предотвращение сквозного тока
Подавление коротких импульсов (Short Pulse Suppression, SPS)
При использовании импульсных трансформаторов или оптопар для гальванической
изоляции контрольных сигналов очень важно обеспечить защиту канала управления от воздействия помех. Отличительными признаками шумовых сигналов являются их амплитуда и длительность, которые, как правило, гораздо меньше, чем у импульсов, формируемых контроллером. Для подавления помех в состав драйверов SEMIKRON включен фильтр, не пропускающий сигналы длительностью меньше 0,2-0,5 мс.
«Мертвое время» t
dt, защита от одновременного включения (Interlock) и время блокирования tbl
Для предотвращения сквозного тока в инверторах напряжения драйвер должен исключать одновременное включение транзисторов ТОР и ВОТ полумоста. Для этой цели используется функция Interlock, имеющаяся в подавляющем большинстве современных драйверов. Эта опция не применяется в инверторах тока и трехуровневых инверторах напряжения, где открывание ключей одной стойки необходимо в некоторых рабочих состояниях.
Для этой цели используется функция Interlock, имеющаяся в подавляющем большинстве современных драйверов. Эта опция не применяется в инверторах тока и трехуровневых инверторах напряжения, где открывание ключей одной стойки необходимо в некоторых рабочих состояниях.
После запирания одного из ключей полумоста включение оппозитного транзистора должно происходить с некоторой задержкой. Время tdt, называемое «мертвым», учитывает задержку включения и выключения драйвера и транзистора, в течение tdt должны закончиться все переходные процессы. В зависимости от типа транзистора и области применения «мертвое» время находится в диапазоне 2-8 мкс. В первую очередь это относится к режиму «жесткой» коммутации, для работы в резонансных режимах значение tdt снижают вплоть до 0.
При использовании напряжения насыщения VCEsat в качестве критерия токовой перегрузки схема защиты должна быть блокирована на некоторое время tbl, необходимое для полного отпирания транзистора. Чтобы реакция на неисправность была максимально быстрой, рекомендуется изменять опорный сигнал схемы защиты Vref по такому же динамическому закону, по которому происходит спад напряжения «коллектор-эмиттер» VCE. Как видно на рис. 11, в первый момент после открывания ключа величина VCE намного выше установившегося значения VCEsat, определяемого прямой характеристикой.
Чтобы реакция на неисправность была максимально быстрой, рекомендуется изменять опорный сигнал схемы защиты Vref по такому же динамическому закону, по которому происходит спад напряжения «коллектор-эмиттер» VCE. Как видно на рис. 11, в первый момент после открывания ключа величина VCE намного выше установившегося значения VCEsat, определяемого прямой характеристикой.
Рис. 11. Динамическое насыщение IGBT и пороговый уровень напряжения Vref
При использовании динамического опорного напряжения время блокирования можно существенно снизить tmin. Чтобы удовлетворить требованиям области безопасной работы для режима короткого замыкания (SC-SOA), tbl ни при каких условиях не должно превышать предельно допустимой длительности КЗ (для последних поколений IGBT максимальное значение tSCmax составляет 6 мкс) (рис. 12).
Рис. 12. Возможные сценарии выхода транзистора из насыщения
Передача и усиление сигнала управления
Сигналы управления, формируемые центральным процессором, информация о состоянии вторичных каскадов (статус и ошибка), а также выходные сигналы датчиков (ток, напряжение, температура, напряжение DC-шины) должны передаваться между узлами драйвера, имеющими различный потенциальный уровень.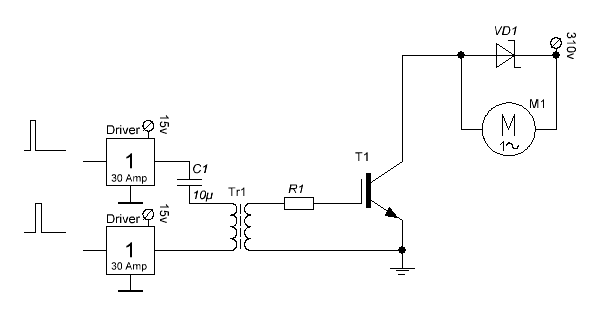
В подавляющем большинстве выпускаемых драйверов для потенциальной развязки используются импульсные трансформаторы, оптопары или «квази-потенциальные» изоляторы, к которым относятся каскады сдвига уровня с бутстрепным питанием каналов верхнего уровня.
На рис. 13 показаны базовые схемы передачи сигналов управления. Самая сложная конфигурация, используемая в преобразователях высокой мощности (рис. 13а), обеспечивает потенциальную развязку импульсов S и энергии управления Р по каждому каналу. Такая топология является наиболее предпочтительной, она отличается высокой помехозащищенностью и минимальным уровнем взаимного влияния ключей.
Рис. 13. Принципы передачи энергии управления:
а) полная схема для применений высокой мощности;
б) общий источник питания для драйверов ключей ВОТ;
в) принцип бутстрепного питания;
г) принцип сдвига уровня (STOP, SBOT: сигналы управления для ключей TOP/BOT; PTOP, PBOT: передача энергии управления для ключей TOP/BOT)
Вариант на рис.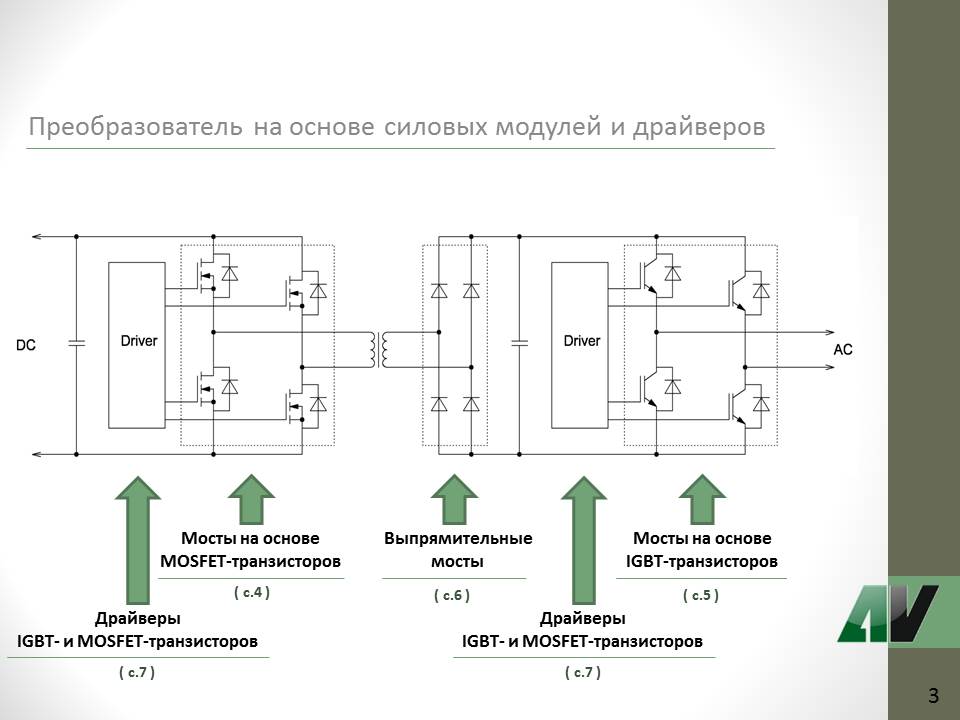 13б содержит раздельные каналы потенциальной изоляции для всех драйверов ТОР и только один общий изолятор для драйверов нижнего уровня ВОТ. Как правило, такая структура применяется в маломощных схемах, кроме этого, она широко распространена в интеллектуальных модулях (IPM).
13б содержит раздельные каналы потенциальной изоляции для всех драйверов ТОР и только один общий изолятор для драйверов нижнего уровня ВОТ. Как правило, такая структура применяется в маломощных схемах, кроме этого, она широко распространена в интеллектуальных модулях (IPM).
Принцип «бутстрепного» питания, позволяющий передавать энергию управления транзисторам верхнего плеча без потенциальной изоляции, поясняется на рис. 13в. На рис. 13г показан каскад сдвига уровня, транслирующий контрольный сигнал STOP без гальванической развязки посредством высоковольтного источника тока. Подобная топология, как правило, применяется в монолитных интегральных схемах драйверов.
Наиболее важным требованием, предъявляемым к каскадам гальванической развязки, является высокая статическая прочность изоляции (2,5-4,5 кВ в соответствии со стандартами) и иммунитет к наведенным фронтам dv/dt (15-100 кВ/мкс). Последнее требование выполняется за счет применения изоляционных барьеров со сверхнизкой проходной емкостью (1-10 пФ) между первичными и вторичными каскадами. Это позволяет минимизировать или даже полностью устранить влияние помех, вызванных коммутационными токами смещения.
Это позволяет минимизировать или даже полностью устранить влияние помех, вызванных коммутационными токами смещения.
Рис. 14. Эквивалентные емкости полумостового каскада с потенциальной изоляцией
(Cps1: емкость между первичным и вторичным каскадом канала ВОТ; Cps2: емкость между первичным и вторичным каскадом канала ТОР; Css: емкость между вторичными каскадами каналов ТОР и ВОТ]
Сигналы управления и обратной связи
В таблице 2 приведены характеристики основных методов передачи сигналов управления и обратной связи с потенциальной изоляцией и без нее, используемые в драйверах MOSFET/IGBT.
| Характеристика | Импульсный трансформатор (с магнитным сердечником), трансформатор без сердечника | Оптопара | Волоконно-оптическая линия связи |
| Принцип потенциальной изоляции | Магнитный | Оптический | Волоконно-оптический |
| Гальваническая изоляция | + | + | + |
| Направление передачи | Двунаправленный | Двунаправленный | Двунаправленный |
| Разброс времени задержки | Низкий | Высокий | Высокий |
| Реакция на воздействие магнитного поля | + | — | — |
| Реакция на воздействие электрического поля | — | — | — |
| Иммунитет к dv/dt | 35…50…100 кВ/мкс | 15-25 кВ/мкс | ND |
Информация с датчиков тока, напряжения, температуры может транслироваться на схему управления через те же изолирующие барьеры с помощью широтно-импульсной модуляции.
В таблице 3 приведен обзор наиболее известных принципов изолированной передачи энергии управления к драйверу.
| Характеристика | Сетевой трансформатор 50 Гц | Низковольтные каскады | Высоковольтные каскады | Бутстрепная схема |
| Источник питания | ||||
| Принцип потенциальной изоляции | Магнитный (трансформаторная развязка) | Высоковольтный p-n-переход | ||
| Гальваническая изоляция | + | + | + | — |
| Питание | Вспомогательный или основной источник питания | Вспомогательный источник питания | DC-шина | Рабочее напряжение транзистора ВОТ |
| АС-частота | Низкая | Очень высокая | Средняя | Средняя (частота ШИМ) |
| Требования по сглаживанию | Высокие | Очень низкие | Низкие | Низкие |
| Ограничение скважности | Нет | Нет | Нет | Есть |
Твердотельные и интегральные микросхемы драйверов
В большинстве случаев устройства управления затворами строятся на базе интегральных схем, доступных в различных конфигурациях: одиночной, полумостовой и трехфазной.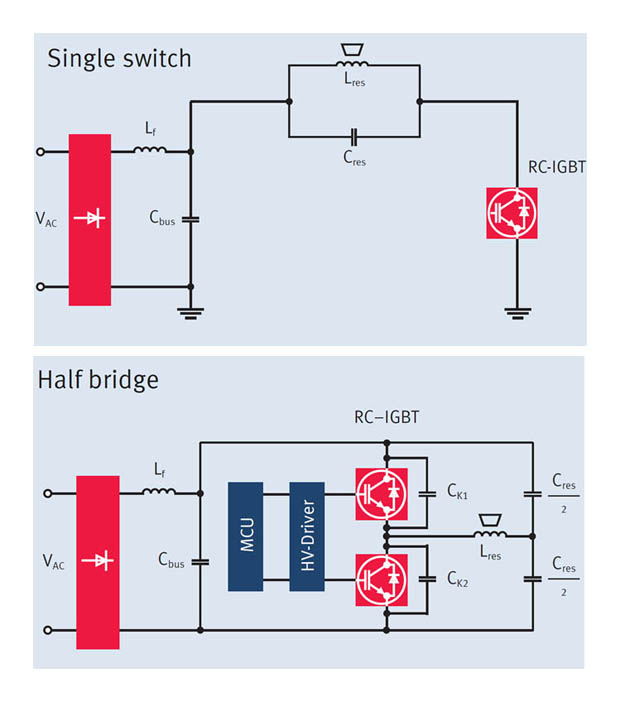
Как правило, они выполняют следующие функции:
- формирование импульсов управления затвором;
- мониторинг напряжения насыщения (VCEsat, VDSon) или сигнала, снимаемого с резистивного шунта для индикации состояния перегрузки;
- мониторинг падения напряжения управления (UVLO) для исключения перехода силового транзистора в линейный режим работы;
- формирование сигнала ошибки;
- формирование «мертвого времени»;
- бутстрепное питание верхнего каскада драйвера;
- блокировка входных импульсов;
- потенциальный сдвиг уровня сигнала ТОР в неизолированных драйверах.
Современные твердотельные микросхемы драйверов производятся на основе технологии SOI (Silicon On Insulator), в которой полностью подавлен эффект защелкивания благодаря изоляции каждого активного элемента структуры. Это позволяет расширить диапазон рабочих температур, повысить надежность каскада сдвига уровня, улучшить иммунитет к dv/dt и стойкость к наведенным помехам отрицательной полярности.
Еще одной возможностью реализации интегрального драйвера MOSFET/IGBT является комбинация быстрой оптопары с выходным каскадом. Для создания законченного устройства управления в состав изделия необходимо включить DC/DC-преобразователь или бутстрепную схему для питания каналов ТОР, а также элементы обвязки.
В условиях растущего многообразия функций и алгоритмов защиты драйверов затворов к элементам, ставшим обязательными для устройств управления, добавляются и новые узлы. К ним относятся, например, блок формирования входных импульсов, фильтр подавления шумов, генератор «мертвого» времени, память схемы защиты, управление DC/DC-конвертером источника питания и т. д. Все описанные функции реализованы в специализированных интегральных схемах, используемых в драйверах SEMIKRON.
Литература
- Arendt Wintrich, Ulrich Nicolai, Werner Tursky, Tobias Reimann. Application Notes for IGBT and MOSFET modules. SEMIKRON International. 2010.
- Scheuermann U.
 Paralleling of Chips — From the Classiacl «Worst Case» Consideration to a Statistical Approach // PCIM Europe 2005. Conference Proceedings.
Paralleling of Chips — From the Classiacl «Worst Case» Consideration to a Statistical Approach // PCIM Europe 2005. Conference Proceedings. - Bruckmann M., Sigg J. Reihenschaltung von IGBT in Experiment und Simulation // Conference Proceeding. Freiburg. 1995.
- Bruckmann M. Einsatz von IGBT fur Hochleistungsstromrichter. Bad Nauheim. 1998. Proc.
- Gerster Ch., Hofer P., Karrer N. Gate-control Strategies for Snubberless Operation of Series Connected IGBTs. // PESC’96. Baveno. Proc. Vol. II.
- Ruedi H., Kohli P. Dynamic Gate Control (DGC) — A New IGBT gate Unit for High Current IGBTs // PCIM Europe 1995. Conference Proceedings.
- Helsper F. Adaptation of IGBT Switching Behaviour by Means of Active gate Drive Control for Low and Medium Power // EPE 2003. Conference Proceedings.
- AN3 AN-7002: Connection of Gate Drivers.
- AN5 AN-7003: Gate resistors.
- AN6 AN-7004: IGBT Driver Calculation.
IGBT транзисторы
Добавлено 17 сентября 2018 в 21:34
Сохранить или поделиться
Биполярный транзистор с изолированным затвором (IGBT)
Из-за своих изолированных затворов IGFET транзисторы всех типов имеют чрезвычайно высокий коэффициент усиления по току: не может быть устойчивого тока затвора, если нет замкнутой цепи затвора, в которой электроны могут непрерывно протекать. Таким образом, единственный ток, который мы видим на выводе затвора полевого транзистора с изолированным затвором, – это ток во время временного перехода (кратковременный импульс), который может потребоваться для зарядки емкости затвора и смещения обедненной области, когда транзистор переключается из состояния «открыт» в состояние «закрыт», и наоборот.
Таким образом, единственный ток, который мы видим на выводе затвора полевого транзистора с изолированным затвором, – это ток во время временного перехода (кратковременный импульс), который может потребоваться для зарядки емкости затвора и смещения обедненной области, когда транзистор переключается из состояния «открыт» в состояние «закрыт», и наоборот.
Этот высокий коэффициент усиления по току, по-видимому, дает технологии IGFET решающее преимущество по сравнению с биполярными транзисторами в плане управления большими токами. Если для управления большим током используется биполярный транзистор, то схемой управления в соответствии с коэффициентом β должен быть обеспечен существенный ток базы. Для примера, для того, чтобы мощный биполярный транзистор с β=20 проводил ток коллектора 100 ампер, ток базы должен быть не менее 5 ампер, что само по себе является значительной величиной тока для небольших дискретных или интегральных схем управления:
Ключ на биполярном транзисторе
Было бы хорошо с точки зрения схемы управления иметь силовые транзисторы с высоким коэффициентом усиления по току так, чтобы для управления током нагрузки требовалось гораздо меньше управляющего тока. Разумеется, мы можем использовать транзисторные пары Дарлингтона, чтобы увеличить усиление по току, но для такого устройства всё равно будет требоваться гораздо больший управляющий ток, чем для эквивалентной схемы на мощном полевом транзисторе с изолированным затвором:
Разумеется, мы можем использовать транзисторные пары Дарлингтона, чтобы увеличить усиление по току, но для такого устройства всё равно будет требоваться гораздо больший управляющий ток, чем для эквивалентной схемы на мощном полевом транзисторе с изолированным затвором:
Ключ на паре ДарлингтонаКлюч на полевом транзисторе с изолированным затвором
Однако, к сожалению, полевые транзисторы с изолированным затвором имеют проблемы с управлением высокими токами: они, как правило, демонстрируют большее падение напряжения сток-исток, чем падение напряжения коллектор-эмиттер у насыщенного биполярного транзистора. Это большее падение напряжения соответствует более высокой рассеиваемой мощности при той же величине тока нагрузки, что ограничивает полезность полевых транзисторов с изолированным затвором в качестве мощных устройств. Хотя некоторые специализированные конструкции, такие как так называемый VMOS транзистор, были разработаны для минимизации этого недостатка, биполярный транзистор по-прежнему превосходит их по своей способности коммутировать большие токи.
Интересное решение этой дилеммы использует лучшие качества полевых транзисторов с изолированным затвором в сочетании с лучшими качествами биполярных транзисторов в одном устройстве, называемом биполярный транзистор с изолированным затвором (БТИЗ, англ. Insulated-gate bipolar transistor, IGBT). Также известный как MOSFET с биполярным режимом, полевой транзистор с модуляцией проводимости (Conductivity-Modulated Field-Effect Transistor, COMFET) или просто транзистор с изолированным затвором (Insulated-Gate Transistor, IGT), он эквивалентен паре Дарлингтона из полевого транзистора с изолированным затвором и биполярного транзистора:
Биполярный транзистор с изолированным затвором (IGBT) (N-канальный)
По сути, полевой транзистор с изолированным затвором управляет током базы биполярного транзистора, который управляет током основной нагрузки между коллектором и эмиттером. Таким образом, получается чрезвычайно высокий коэффициент усиления по току (поскольку изолированный затвор IGFET транзистора практически не потребляет ток от схемы управления), и при этом падение напряжения коллектор-эмиттер в режиме полной проводимости ниже, чем у обычного биполярного транзистора.
Одним из недостатков IGBT транзистора по сравнению с обычным биполярным транзистором является его более медленное время выключения. Относительно быстроты переключения и способности работать с большими токами, победить биполярный транзистор сложно. Более быстрое время выключения для IGBT транзистора может быть достигнуто путем определенных изменений в конструкции, но только за счет более высокого падения напряжения между коллектором и эмиттером в режиме насыщения. Однако IGBT транзистор в приложениях управления большими мощностями обеспечивает хорошую альтернативу и полевым транзисторам с изолированным затвором, и биполярным транзисторам.
Оригинал статьи:
Теги
IGBT / БТИЗ транзистор (биполярный транзистор с изолированным затвором)IGFET / МДП транзистор (полевой транзистор с изолированным затвором)Биполярный транзисторОбучениеПара ДарлингтонаПолевой транзисторТранзисторный ключЭлектроника
Сохранить или поделиться
Особенности применения драйверов MOSFET и IGBT — Компоненты и технологии
Введение
Силовые транзисторы IGBT и MOSFET стали основными элементами, применяемыми в мощных импульсных преобразователях.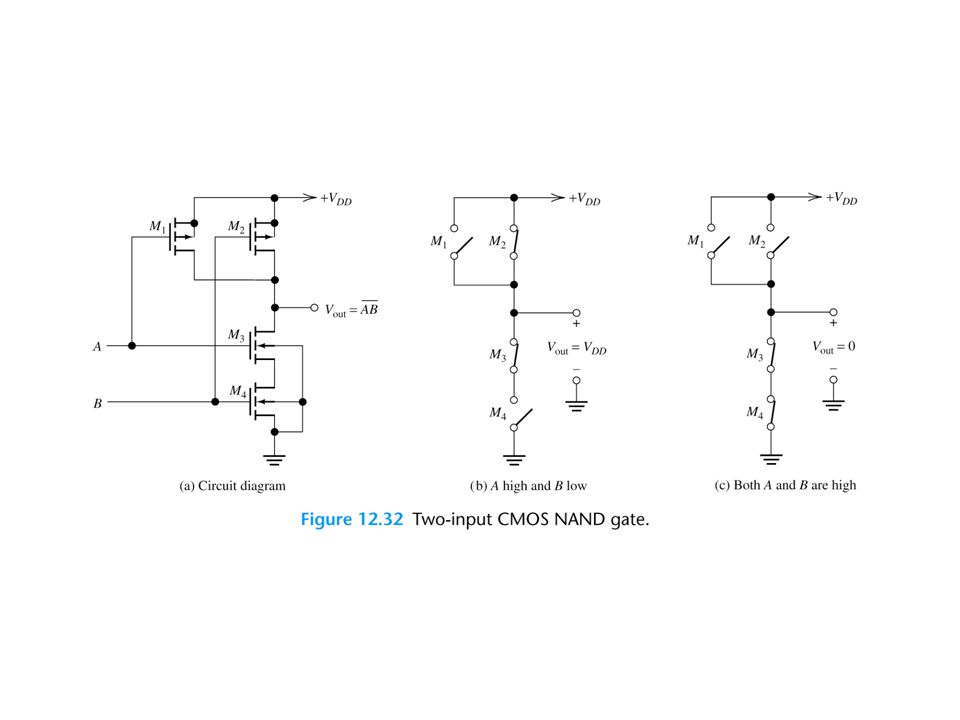 Их уникальные статические и динамические характеристики позволяют создавать устройства, способные отдать в нагрузку десятки и даже сотни киловатт при минимальных габаритах и КПД, превышающем 95 %.
Их уникальные статические и динамические характеристики позволяют создавать устройства, способные отдать в нагрузку десятки и даже сотни киловатт при минимальных габаритах и КПД, превышающем 95 %.
Общим у IGBT и MOSFET является изолированный затвор, в результате чего эти элементы имеют схожие характеристики управления. Благодаря отрицательному температурному коэффициенту тока короткого замыкания появилась возможность создавать транзисторы, устойчивые к короткому замыканию. Сейчас транзисторы с нормированным временем перегрузки по току выпускаются практически всеми ведущими фирмами.
Отсутствие тока управления в статических режимах позволяет отказаться от схем управления на дискретных элементах и создать интегральные схемы управления — драйверы. В настоящее время ряд фирм, таких как International Rectifier, Hewlett-Packard, Motorola, выпускает широкую гамму устройств, управляющих одиночными транзисторами, полумостами и мостами — двух- и трехфазными. Кроме обеспечения тока затвора, они способны выполнять и ряд вспомогательных функций, таких как защита от перегрузки по току и короткого замыкания (
Overcurrent Protection, Short Circuit Protection) и падения напряжения управления (
Under Voltage LockOut — UVLO). Для ключевых элементов с управляющим затвором падение напряжения управления является опасным состоянием. При этом транзистор может перейти в линейный режим и выйти из строя из-за перегрева кристалла.
Для ключевых элементов с управляющим затвором падение напряжения управления является опасным состоянием. При этом транзистор может перейти в линейный режим и выйти из строя из-за перегрева кристалла.
Пользователям бывает нелегко разобраться в широкой гамме микросхем, выпускаемых сейчас для использования в силовых схемах, несмотря на схожесть их основных характеристик. В данной статье рассматриваются особенности использования наиболее популярных драйверов, выпускаемых различными фирмами.
Режимы короткого замыкания
Основной вспомогательной функцией драйверов является защита от перегрузки по току. Для лучшего понимания работы схемы защиты необходимо проанализировать поведение силовых транзисторов в режиме короткого замыкания (или КЗ — привычная для разработчиков аббревиатура).
Причины возникновения токовых перегрузок разнообразны. Чаще всего это аварийные случаи, такие как пробой на корпус или замыкание нагрузки.
Перегрузка может быть вызвана и особенностями схемы, например переходным процессом или током обратного восстановления диода оппозитного плеча. Такие перегрузки должны быть устранены схемотехническими методами: применением цепей формирования траектории (снабберов), выбором резистора затвора, изоляцией цепей управления от силовых шин и др.
Такие перегрузки должны быть устранены схемотехническими методами: применением цепей формирования траектории (снабберов), выбором резистора затвора, изоляцией цепей управления от силовых шин и др.
Включение транзистора при коротком замыкании в цепи нагрузки
Принципиальная схема и эпюры напряжения, соответствующие этому режиму, приведены на рис. 1 а и 2. Все графики получены при анализе схем с помощью программы PSpice. Для анализа были использованы усовершенствованные модели транзисторов MOSFET фирмы International Rectifier и макромодели IGBT и драйверов, разработанные автором статьи.
Рис. 1. Режимы короткого замыкания
Максимальный ток в цепи коллектора транзистора ограничен напряжением на затворе и крутизной транзистора. Из-за наличия емкости в цепи питания внутреннее сопротивление источника питания не влияет на ток КЗ. В момент включения ток в транзисторе нарастает плавно из-за паразитной индуктивности LS в цепи коллектора (средний график на рис. 2). По этой же причине напряжение имеет провал (нижний график). После окончания переходного процесса к транзистору приложено полное напряжение питания, что приводит к рассеянию огромной мощности в кристалле. Режим КЗ необходимо прервать через некоторое время, необходимое для исключения ложного срабатывания. Это время обычно составляет 1–10 мкс. Естественно, что транзистор должен выдерживать перегрузку в течение этого времени.
2). По этой же причине напряжение имеет провал (нижний график). После окончания переходного процесса к транзистору приложено полное напряжение питания, что приводит к рассеянию огромной мощности в кристалле. Режим КЗ необходимо прервать через некоторое время, необходимое для исключения ложного срабатывания. Это время обычно составляет 1–10 мкс. Естественно, что транзистор должен выдерживать перегрузку в течение этого времени.
Рис. 2
Короткое замыкание нагрузки у включенного транзистора
Принципиальная схема и эпюры напряжения, соответствующие этому режиму, приведены на рис. 1 б и 3. Как видно из графиков, процессы в этом случае происходят несколько иначе. Ток, как и в предыдущем случае, ограниченный параметрами транзистора, нарастает со скоростью, определяемой паразитной индуктивностью Ls (средний график на рис. 3). Прежде чем ток достигнет установившегося значения, начинается рост напряжения Vce (нижний график). Напряжение на затворе возрастает за счет эффекта Миллера (верхний график). Соответственно возрастает и ток коллектора, который может превысить установившееся значение. В этом режиме кроме отключения транзистора необходимо предусмотреть и ограничение напряжения на затворе.
Соответственно возрастает и ток коллектора, который может превысить установившееся значение. В этом режиме кроме отключения транзистора необходимо предусмотреть и ограничение напряжения на затворе.
Рис. 3
Как было отмечено, установившееся значение тока КЗ определяется напряжением на затворе. Однако уменьшение этого напряжения приводит к повышению напряжения насыщения и, следовательно, к увеличению потерь проводимости. Устойчивость к КЗ тесно связана и с крутизной транзистора. Транзисторы IGBT с высоким коэффициентом усиления по току имеют низкое напряжение насыщения, но небольшое допустимое время перегрузки. Как правило, транзисторы, наиболее устойчивые к КЗ, имеют высокое напряжение насыщения и, следовательно, высокие потери.
Допустимый ток КЗ у IGBT гораздо выше, чем у биполярного транзистора. Обычно он равен 10-кратному номинальному току при допустимых напряжениях на затворе. Ведущие фирмы, такие как International Rectifier, Siemens, Fuji, выпускают транзисторы, выдерживающие без повреждения подобные перегрузки. Этот параметр оговаривается в справочных данных на транзисторы и называется Short Circuit Ration, а допустимое время перегрузки — tsc —
Этот параметр оговаривается в справочных данных на транзисторы и называется Short Circuit Ration, а допустимое время перегрузки — tsc —
Short Circuit Withstand Time.
Быстрая реакция схемы защиты вообще полезна для большинства применений. Использование таких схем в сочетании с высокоэкономичными IGBT повышают эффективность работы схемы без снижения надежности.
Применение драйверов для защиты от перегрузок
Рассмотрим методы отключения транзисторов в режиме перегрузки на примере драйверов производства фирм International Rectifier, Motorola и Hewlett-Packard, так как эти микросхемы позволяют реализовать функции защиты наиболее полно.
Драйвер верхнего плеча
Рис. 4. Структура драйвера IR2125
На рис. 4 приведена структурная схема, а на рис. 5 — типовая схема подключения драйвера IR2125 с использованием функции защиты от перегрузки. Для этой цели используется вывод 6 — CS. Напряжение срабатывания защиты — 230 мВ. Для измерения тока в эмиттере установлен резистор RSENSE, номинал которого и делителя R1, R4 определяют ток защиты.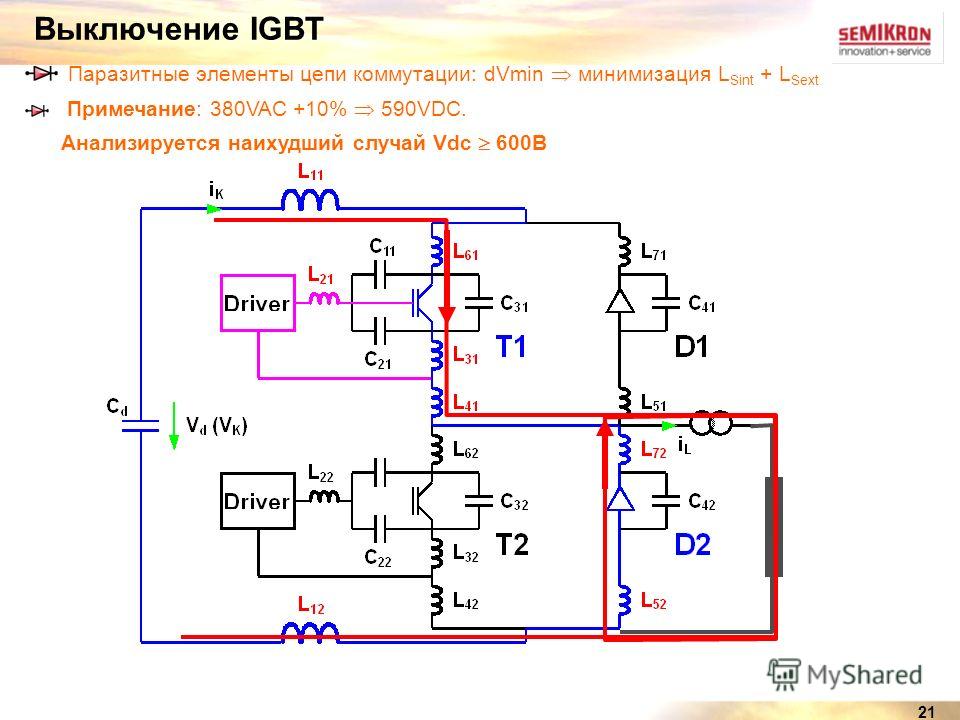
Рис. 5. Схема включения IR2125
Как было указано выше, если при появлении перегрузки уменьшить напряжение на затворе, период распознавания аварийного режима может быть увеличен. Это необходимо для исключения ложных срабатываний. Данная функция реализована в микросхеме IR2125. Конденсатор С1, подключенный к выводу ERR, определяет время анализа состояния перегрузки. При С1 = 300 пФ время анализа составляет около 10 мкс (это время заряда конденсатора до напряжения 1,8 В — порогового напряжения компаратора схемы
ERROR TIMING драйвера). На это время включается схема стабилизации тока коллектора, и напряжение на затворе снижается. Если состояние перегрузки не прекращается, то через 10 мкс транзистор отключается полностью.
Отключение защиты происходит при снятии входного сигнала, что позволяет пользователю организовать триггерную схему защиты. При ее использовании особое внимание следует уделить выбору времени повторного включения, которое должно быть больше тепловой постоянной времени кристалла силового транзистора. Тепловая постоянная времени может быть определена по графику теплового импеданса Zthjc для одиночных импульсов.
Тепловая постоянная времени может быть определена по графику теплового импеданса Zthjc для одиночных импульсов.
Описанный способ включения транзистора имеет свои недостатки. Резистор RSENSE должен быть достаточно мощным и иметь сверхмалую индуктивность. Серийно выпускаемые витые мощные резисторы обычно имеют недопустимо высокую паразитную индуктивность. Специально для прецизионного измерения импульсных токов фирма
CADDOCK выпускает резисторы в корпусах ТО-220 и ТО-247. Кроме того, измерительный резистор создает дополнительные потери мощности, что снижает эффективность схемы. На рис. 6 приведена схема, свободная от указанных недостатков. В ней для анализа ситуации перегрузки используется зависимость напряжения насыщения от тока коллектора. Для MOSFET транзисторов эта зависимость практически линейна, так как сопротивление открытого канала мало зависит от тока стока. У IGBT график Von = f(Ic) нелинеен, однако точность его вполне достаточна для выбора напряжения, соответствующего току требуемому защиты.
Рис. 6
Для анализа состояния перегрузки по напряжению насыщения измерительный резистор не требуется. При подаче положительного управляющего сигнала на затвор на входе защиты драйвера SC появляется напряжение, определяемое суммой падения напряжения на открытом диоде VD2 и на открытом силовом транзисторе Q1 и делителем R1, R4, который задает ток срабатывания. Падение напряжения на диоде практически неизменно и составляет около 0,5 В. Напряжение открытого транзистора при выбранном токе короткого замыкания определяется из графика Von = f(Ic). Диод VD4, как и VD1, должен быть быстродействующим и высоковольтным.
Кроме защиты от перегрузки по току драйвер анализирует напряжение питания входной части VСС и выходного каскада VB, отключая транзистор при падении VB ниже 9 В, что необходимо для предотвращения линейного режима работы транзистора. Такая ситуация может возникнуть как при повреждении низковольтного источника питания, так и при неправильном выборе емкости С2. Величина последней должна вычисляться исходя из значений заряда затвора, тока затвора и частоты следования импульсов. Для расчета значения бутстрепной емкости Cb в документации фирмы International Rectifier рекомендуются следующие формулы:
Для расчета значения бутстрепной емкости Cb в документации фирмы International Rectifier рекомендуются следующие формулы:
Cb = 15*2*(2*Qg + Igbs/f + It)/(Vcc – Vf – Vls),
It = (Ion + Ioff)*tw.
где
- Ion и Ioff — токи включения и выключения затвора,
- tw = Qg/Ion — время коммутации,
- Qg — заряд затвора,
- f — частота следования импульсов,
- Vcc — напряжение питания,
- Vf — прямое падение напряжения на диоде зарядового насоса (VD1 на рис. 6),
- Vls — прямое падение напряжения на оппозитном диоде (VD3 на рис. 6),
- Igbs — ток затвора в статическом режиме.
- tw = Qg/Ion — время коммутации,
При невозможности питания драйвера от бутстрепной емкости необходимо использовать «плавающий» источник питания.
Драйвер трехфазного моста
На рис. 7 приведена схема подключения драйвера трехфазного моста IR213* с использованием функции защиты от перегрузки. Для этой цели используется вход ITR. Напряжение срабатывания защиты — 500 мВ. Для измерения полного тока моста в эмиттерах установлен резистор RSENSE, номинал которого вместе с делителем R2, R3 определяет ток защиты.
Для измерения полного тока моста в эмиттерах установлен резистор RSENSE, номинал которого вместе с делителем R2, R3 определяет ток защиты.
Рис. 7. Схема включения IR2130
Драйвер IR2130 обеспечивает управление MOSFET и IGBT транзисторами при напряжении до 600 В, имеет защиту от перегрузки по току и от снижения питающих напряжений. Схема защиты содержит полевой транзистор с открытым стоком для индикации неисправности (FAULT). Он также имеет встроенный усилитель тока нагрузки, что позволяет вырабатывать контрольные сигналы и сигналы обратной связи. Драйвер формирует время задержки (tdt —
deadtime) между включением транзисторов верхнего и нижнего плеча для исключения сквозных токов. Это время составляет от 0,2 до 2 мкс для различных модификаций.
Для правильного использования указанной микросхемы и создания на ее основе надежных схем надо учитывать несколько нюансов.
Особенностью драйверов IR213* является отсутствие функции ограничения напряжения на затворе при КЗ. По этой причине постоянная времени цепочки R1C1, предназначенной для задержки включения защиты, не должна превышать 1 мкс. Разработчик должен знать, что отключение моста произойдет через 1 мкс после возникновения КЗ, в результате чего ток (особенно при активной нагрузке) может превысить расчетное значение. Для сброса защиты необходимо отключить питание драйвера или подать на входы нижнего уровня запирающее напряжение (высокого уровня). Отметим также, что среди микросхем данной серии имеется драйвер IR2137, в котором предусмотрена защита по напряжению насыщения верхних транзисторов и формируется необходимое время задержки срабатывания этой защиты. Такая защита очень важна для драйверов, управляющих трехфазными мостовыми схемами, так как при возникновении пробоя на корпус ток КЗ течет, минуя измерительный резистор RSENSE. В этой микросхеме предусмотрено раздельное подключение резисторов затвора для включения, отключения и аварийного выключения, что позволяет реализовать наиболее полно все динамические особенности транзисторов с изолированным затвором.
По этой причине постоянная времени цепочки R1C1, предназначенной для задержки включения защиты, не должна превышать 1 мкс. Разработчик должен знать, что отключение моста произойдет через 1 мкс после возникновения КЗ, в результате чего ток (особенно при активной нагрузке) может превысить расчетное значение. Для сброса защиты необходимо отключить питание драйвера или подать на входы нижнего уровня запирающее напряжение (высокого уровня). Отметим также, что среди микросхем данной серии имеется драйвер IR2137, в котором предусмотрена защита по напряжению насыщения верхних транзисторов и формируется необходимое время задержки срабатывания этой защиты. Такая защита очень важна для драйверов, управляющих трехфазными мостовыми схемами, так как при возникновении пробоя на корпус ток КЗ течет, минуя измерительный резистор RSENSE. В этой микросхеме предусмотрено раздельное подключение резисторов затвора для включения, отключения и аварийного выключения, что позволяет реализовать наиболее полно все динамические особенности транзисторов с изолированным затвором.
Ток включения/выключения для IR213* составляет 200/420 мА (120/250 мА для IR2136). Это необходимо учитывать при выборе силовых транзисторов и резисторов затвора для них. В параметрах на транзистор указывается величина заряда затвора (обычно в нК), которая определяет при данном токе время включения/выключения транзистора. Длительность переходных процессов, связанных с переключением, должна быть меньше времени задержки tdt, формируемого драйвером. Применение мощных транзисторов может также привести к ложному открыванию и возникновению сквозного тока из-за эффекта Миллера. Уменьшение резистора затвора или использование резисторов затвора, раздельных для процессов включения и выключения, не всегда решает проблему вследствие недостаточного тока выключения самого драйвера. В этом случае необходимо использование буферных усилителей.
Преимуществом микросхем производства International Rectifier является то, что эти устройства способны выдерживать высокие перепады напряжения между входной и выходной частью. Для драйверов серии IR21** это напряжение составляет 500–600 В, что позволяет управлять транзисторами в полумостовых и мостовых схемах при питании от выпрямленного промышленного напряжения 220 В без гальванической развязки. Для управления транзисторами в схемах, рассчитанных на питание от выпрямленного напряжения 380 В, International Rectifier выпускает драйверы серии IR22**. Эти микросхемы работают при напряжении выходной части до 1200 В. Все драйверы International Rectifier выдерживают фронты наведенного напряжения до 50 В/нс. Этот параметр называется dv/dt immune. Он свидетельствует о высокой устойчивости к режиму защелкивания, который представляет исключительную опасность для импульсных высоковольтных схем.
Для драйверов серии IR21** это напряжение составляет 500–600 В, что позволяет управлять транзисторами в полумостовых и мостовых схемах при питании от выпрямленного промышленного напряжения 220 В без гальванической развязки. Для управления транзисторами в схемах, рассчитанных на питание от выпрямленного напряжения 380 В, International Rectifier выпускает драйверы серии IR22**. Эти микросхемы работают при напряжении выходной части до 1200 В. Все драйверы International Rectifier выдерживают фронты наведенного напряжения до 50 В/нс. Этот параметр называется dv/dt immune. Он свидетельствует о высокой устойчивости к режиму защелкивания, который представляет исключительную опасность для импульсных высоковольтных схем.
Драйвер нижнего плеча
Для управления транзисторами нижнего плеча хорошую альтернативу представляют микросхемы, выпускаемые фирмой Motorola. Структурная схема одной из них — МС33153 приведена на рис. 8.
Рис. 8. Структурная схема MC33153
Особенностью данного драйвера является возможность использования двух способов защиты (по току и напряжению насыщения) и разделение режима перегрузки и режима короткого замыкания.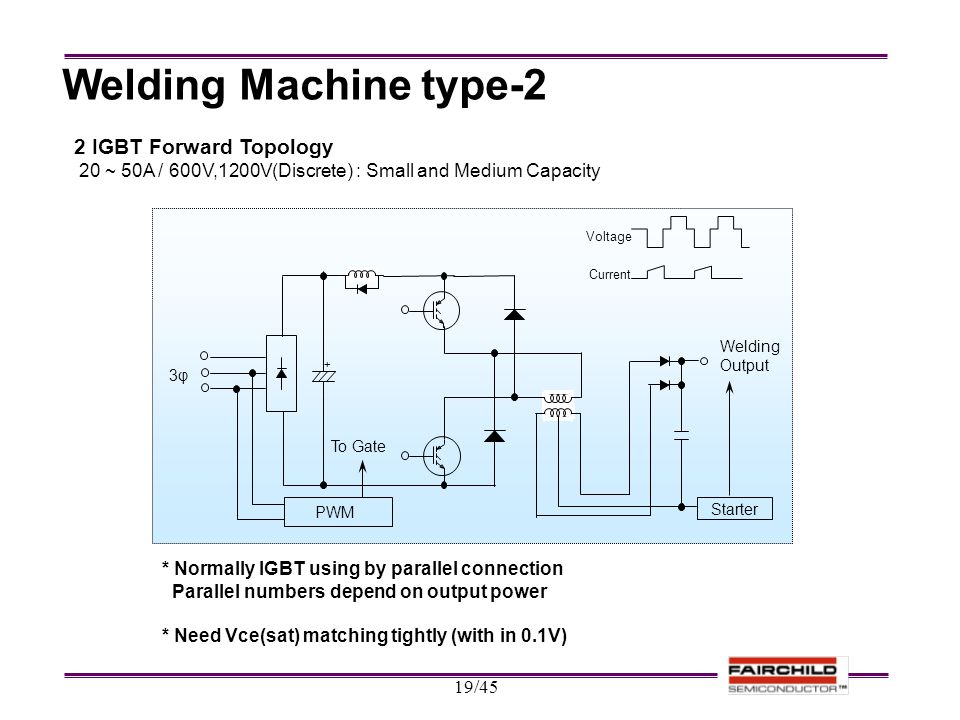 Предусмотрена также возможность подачи отрицательного напряжения управления, что может быть очень полезно для управления мощными модулями с большими значениями заряда затвора. Отключение при падении напряжения управления — UVLO осуществляется на уровне 11 В.
Предусмотрена также возможность подачи отрицательного напряжения управления, что может быть очень полезно для управления мощными модулями с большими значениями заряда затвора. Отключение при падении напряжения управления — UVLO осуществляется на уровне 11 В.
Вывод 1 (
Current Sense Input) предназначен для подключения токового измерительного резистора. В микросхеме этот вывод является входом двух компараторов — с напряжением срабатывания 65 и 130 мВ. Таким образом, в драйвере анализируется состояние перегрузки и короткого замыкания. При перегрузке срабатывает первый компаратор (
Overcurrent Comparator) и отключает сигнал управления затвором. Сброс защиты производится при подаче запирающего сигнала (высокого уровня, так как вход Input — инвертирующий). При этом сигнал неисправности на выход (
Fault Output) не подается. Если ток превышает заданный в два раза, это расценивается как КЗ. При этом опрокидывается второй компаратор (
Short Circuit Comparator), и на контрольном выходе появляется сигнал высокого уровня. По этому сигналу контроллер, управляющий работой схемы, должен произвести отключение всей схемы. Время повторного включения должно определяться, как было сказано выше, тепловой постоянной времени силовых транзисторов.
По этому сигналу контроллер, управляющий работой схемы, должен произвести отключение всей схемы. Время повторного включения должно определяться, как было сказано выше, тепловой постоянной времени силовых транзисторов.
Вывод 8 (
Desaturation Input) предназначен для реализации защиты по напряжению насыщения. Напряжение срабатывания по этому входу — 6,5 В. Этот же вход предназначен для подключения конденсатора Cblank, формирующего время задержки срабатывания защиты. Такая задержка необходима, поскольку после подачи отпирающего напряжения на затвор на транзисторе некоторое время, пока идет восстановление оппозитного диода, поддерживается высокое напряжение.
Рис. 9. Защита по напряжению насыщения
На рис. 9 и 10 показаны схемы подключения МС33153 с использованием защиты по напряжению насыщения и току коллектора. В обеих схемах использованы оптопары для развязки сигнала управления и сигнала ошибки. В схеме на рис. 10 показан транзистор IGBT со специальным токовым выходом. Как правило, IGBT не имеют такого вывода, и измерительный резистор устанавливается непосредственно в силовую цепь эмиттера. При этом необходимо учесть, что этот резистор должен иметь минимальную паразитную индуктивность, а номинал его должен быть выбран с учетом необходимого тока срабатывания защиты. Иногда в качестве датчика тока целесообразно применить отрезок высокоомного провода, например манганинового или нихромового. Обратите внимание, что порог срабатывания схем защиты микросхем Motorola ниже, чем International Rectifier, что позволяет использовать меньшие измерительные резисторы и снизить потери мощности на них. Однако в этом случае предъявляются повышенные требования к помехозащищенности.
Как правило, IGBT не имеют такого вывода, и измерительный резистор устанавливается непосредственно в силовую цепь эмиттера. При этом необходимо учесть, что этот резистор должен иметь минимальную паразитную индуктивность, а номинал его должен быть выбран с учетом необходимого тока срабатывания защиты. Иногда в качестве датчика тока целесообразно применить отрезок высокоомного провода, например манганинового или нихромового. Обратите внимание, что порог срабатывания схем защиты микросхем Motorola ниже, чем International Rectifier, что позволяет использовать меньшие измерительные резисторы и снизить потери мощности на них. Однако в этом случае предъявляются повышенные требования к помехозащищенности.
Рис. 10. Защита по току
Драйвер с гальванической развязкой
Гальваническая развязка бывает необходима в схемах, где мощный силовой каскад питается от сетевого напряжения, а сигналы управления вырабатываются контроллером, связанным по шинам с различными периферийными устройствами. Изоляция силовой части и схемы управления в таких случаях снижает коммутационные помехи и позволяет в экстремальных случаях защитить низковольтные схемы.
Изоляция силовой части и схемы управления в таких случаях снижает коммутационные помехи и позволяет в экстремальных случаях защитить низковольтные схемы.
Рис. 11. Структурная схема HCPL316
На наш взгляд, одной из наиболее интересных микросхем для данного применения является HCPL316 производства фирмы Hewlett-Packard. Его структура приведена на рис. 11, а схема подключения — на рис. 12.
Рис. 12. Схема подключения HCPL316
Сигнал управления и сигнал неисправности имеют оптическую развязку. Напряжение изоляции — до 1500 В. В драйвере предусмотрена защита только по напряжению насыщения (вывод 14 — DESAT). Интересной особенностью является наличие прямого и инверсного входа, что упрощает связь с различными типами контроллеров. Так же как и в случае с МС33153 микросхема может вырабатывать двуполярный выходной сигнал, причем пиковый выходной ток может достигать 3 А. Благодаря этому драйвер способен управлять IGBT транзисторами с током коллектора до 150 А, что является его большим преимуществом по сравнению с аналогичными устройствами.
Вспомогательные схемы
В высоковольтных драйверах фирмы International Rectifier благодаря низкому потреблению питание выходных каскадов может осуществляться с помощью так называемых «бутстрепных» емкостей небольших номиналов. Если такой возможности нет, необходимо использовать «плавающие» источники питания. В качестве таких источников дешевле всего применять многообмоточные трансформаторы с выпрямителем и стабилизатором на каждой обмотке. Естественно, если вы хотите иметь двуполярный выходной сигнал, то и каждый такой источник должен быть двуполярным. Однако более изящным решением является использование изолирующих DC-DC конверторов, например серии DCP01* производства Burr-Brown. Эти микросхемы рассчитаны на мощность до 1Вт и могут формировать двуполярный выходной сигнал из однополярного входного. Напряжение развязки — до 1 кВ. Изоляция осуществляется с помощью трансформаторного барьера на частоте 800 кГц. При использовании нескольких микросхем они могут синхронизироваться по частоте.![]()
В силовых приводах часто бывает необходимо иметь сигнал, пропорциональный выходному току, для формирования обратных связей. Эта задача решается разными способами: с помощью трансформаторов тока, шунтов и дифференциальных усилителей и т. д. Все эти методы имеют свои недостатки. Для наиболее успешного решения задачи формирования токового сигнала и связи его с контроллером фирма International Rectifier разработала микросхемы — токовые сенсоры IR2171 и IR2172, в которых токовый сигнал преобразуется в ШИМ-сигнал. Схема включения IR2171 приведена на рис. 13. Микросхема выдерживает перепад напряжения до 600 В и питается от «бутстрепной» емкости. Несущая частота ШИМ — 35 кГц для IR2171 и 40 кГц для IR2172. Диапазон входных напряжений ±300 мВ. Выходное напряжение снимается с открытого коллектора, что позволяет легко подключить оптическую развязку.
Описать все микросхемы, выпускаемые сейчас в мире для использования в силовых приводах, вряд ли возможно. Однако даже приведенные сведения должны помочь разработчику сориентироваться в океане современной элементной базы. Главный вывод из всего сказанного можно сделать следующий: не пытайтесь сделать что-нибудь на дискретных элементах, пока не будете уверены в том, что никто не выпускает интегральную микросхему, решающую вашу задачу.
Главный вывод из всего сказанного можно сделать следующий: не пытайтесь сделать что-нибудь на дискретных элементах, пока не будете уверены в том, что никто не выпускает интегральную микросхему, решающую вашу задачу.
Литература
- Use Gate Charge to Design the Gate Drive Circuit for Power MOSFETs and IGBTs. AN-944.
- Application Characterization of IGBTs. INT990.
- IGBT Characteristics. AN-983.
- Short Circuit Protection. AN-984.
- HV Floating MOS-Gate Driver Ics. AN-978.
- Motorola MC33153 Technical Data.
- Hewlett Packard HCPL316 Technical Data.
- Burr Brown DCP011515 Technical Data.
- Иванов В. В., Колпаков А. Применение IGBT. Электронные компоненты, 1996, № 1.
Страница не найдена — Время электроники
Кажется мы ничего не нашли. Может быть вам помогут ссылки ниже или поик?
Архивы
Архивы
Выберите месяц Февраль 2021 Январь 2021 Декабрь 2020 Ноябрь 2020 Октябрь 2020 Сентябрь 2020 Август 2020 Июль 2020 Июнь 2020 Май 2020 Апрель 2020 Март 2020 Февраль 2020 Январь 2020 Декабрь 2019 Ноябрь 2019 Октябрь 2019 Сентябрь 2019 Август 2019 Июль 2019 Июнь 2019 Май 2019 Апрель 2019 Март 2019 Февраль 2019 Январь 2019 Декабрь 2018 Ноябрь 2018 Октябрь 2018 Сентябрь 2018 Август 2018 Июль 2018 Июнь 2018 Май 2018 Апрель 2018 Март 2018 Февраль 2018 Январь 2018 Декабрь 2017 Ноябрь 2017 Октябрь 2017 Сентябрь 2017 Август 2017 Июль 2017 Июнь 2017 Май 2017 Апрель 2017 Март 2017 Февраль 2017 Январь 2017 Декабрь 2016 Ноябрь 2016 Октябрь 2016 Сентябрь 2016 Август 2016 Июль 2016 Июнь 2016 Май 2016 Апрель 2016 Март 2016 Февраль 2016 Январь 2016 Декабрь 2015 Ноябрь 2015 Октябрь 2015 Сентябрь 2015 Август 2015 Июль 2015 Июнь 2015 Май 2015 Апрель 2015 Март 2015 Февраль 2015 Январь 2015 Декабрь 2014 Ноябрь 2014 Октябрь 2014 Сентябрь 2014 Август 2014 Июль 2014 Июнь 2014 Май 2014 Апрель 2014 Март 2014 Февраль 2014 Январь 2014 Декабрь 2013 Ноябрь 2013 Октябрь 2013 Сентябрь 2013 Август 2013 Июль 2013 Июнь 2013 Май 2013 Апрель 2013 Март 2013 Февраль 2013 Январь 2013 Декабрь 2012 Ноябрь 2012 Октябрь 2012 Сентябрь 2012 Август 2012 Июль 2012 Июнь 2012 Май 2012 Апрель 2012 Март 2012 Февраль 2012 Январь 2012 Декабрь 2011 Ноябрь 2011 Октябрь 2011 Сентябрь 2011 Август 2011 Июль 2011 Июнь 2011 Май 2011 Апрель 2011 Март 2011 Февраль 2011 Январь 2011 Декабрь 2010 Ноябрь 2010 Октябрь 2010 Сентябрь 2010 Август 2010 Июль 2010 Июнь 2010 Май 2010 Апрель 2010 Март 2010 Февраль 2010 Январь 2010 Декабрь 2009 Ноябрь 2009 Октябрь 2009 Сентябрь 2009 Август 2009 Июль 2009 Июнь 2009 Май 2009 Апрель 2009 Март 2009 Февраль 2009 Январь 2009 Декабрь 2008 Ноябрь 2008 Апрель 2008 Март 2008 Февраль 2008 Январь 2008 Декабрь 2007 Ноябрь 2007 Октябрь 2007 Сентябрь 2007
Что такое IGBT-транзисторы
Транзистор, полупроводниковый триод — радиоэлектронный компонент из полупроводникового материала, обычно с тремя выводами, способный от небольшого входного сигнала управлять значительным током в выходной цепи, что позволяет использовать его для усиления, генерирования, коммутации и преобразования электрических сигналов.
IGBT-транзистор (сокращение от англоязычного Insulated-gate bipolar transistor) или биполярный транзистор с изолированным затвором (сокращенно БТИЗ) — представляет собой полупроводниковый прибор с тремя выводами, сочетающий внутри одного корпуса силовой биполярный транзистор и управляющий им полевой транзистор.
IGBT-транзисторы являются на сегодняшний день основными компонентами силовой электроники (мощные инверторы, импульсные блоки питания, частотные преобразователи и т.д.), где они выполняют функцию мощных электронных ключей, коммутирующих токи на частотах измеряемых десятками и сотнями килогерц. Транзисторы данного типа выпускаются как в виде отдельных компонентов, так и в виде специализированных силовых модулей (сборок) для управления трехфазными цепями.
То что IGBT-транзистор включает в себя транзисторы сразу двух типов (включенных по каскадной схеме), позволяет объединить достоинства двух технологий внутри одного полупроводникового прибора.
Биполярный транзистор в качестве силового позволяет получить большее рабочее напряжение, при этом сопротивление канала в открытом состоянии оказывается пропорционально току в первой степени, а не квадрату тока как у обычных полевых транзисторов. А то что в качестве управляющего транзистора используется именно полевой транзистор — сводит затраты мощности на управление ключом к минимуму.
Названия электродов характеризуют структуру IGBT-транзистора: управляющий электрод именуется затвором (как у полевого транзистора), а электроды силового канала — коллектором и эмиттером (как у транзистора биполярного).
Немного истории
Исторически биполярные транзисторы использовались наравне с тиристорами в качестве силовых электронных ключей до 90-х годов. Но недостатки биполярных транзисторов были всегда очевидны: большой ток базы, медленное запирание и от этого перегрев кристалла, сильная зависимость основных параметров от температуры, ограниченное напряжение насыщения коллектор-эмиттер.
Появившиеся позже полевые транзисторы (структуры МОП) сразу изменили ситуацию в лучшую сторону: управление напряжением уже не требует столь больших токов, параметры ключа слабо зависят от температуры, рабочее напряжение транзистора не ограничено снизу, низкое сопротивление силового канала в открытом состоянии расширяет диапазон рабочих токов, частота переключения легко может достигать сотен килогерц, кроме того примечательна способность полевых транзисторов выдерживать сильные динамические нагрузки при высоких рабочих напряжениях.
Поскольку управление полевым транзистором реализуется значительно проще и получается по мощности существенно легче чем биполярным, да к тому же внутри имеется ограничительный диод, — транзисторы с полевым управлением сразу завоевали популярность в схемах импульсных преобразователей напряжения, работающих на высоких частотах, а также в акустических усилителях класса D.
Владимир Дьяконов
Первый силовой полевой транзистор был разработан Виктором Бачуриным еще в Советском Союзе, в 1973 году, после чего он был исследован под руководством ученого Владимира Дьяконова. Исследования группы Дьяконова относительно ключевых свойств силового полевого транзистора привели к разработке в 1977 году составного транзисторного ключа, внутри которого биполярный транзистор управлялся посредством полевого с изолированным затвором.
Исследования группы Дьяконова относительно ключевых свойств силового полевого транзистора привели к разработке в 1977 году составного транзисторного ключа, внутри которого биполярный транзистор управлялся посредством полевого с изолированным затвором.
Ученые показали эффективность такого подхода, когда токовые свойства силовой части определяются биполярным транзистором, а управляющие параметры — полевым. Причем насыщение биполярного транзистора исключается, а значит и задержка при выключении сокращается. Это — важное достоинство любого силового ключа.
На полупроводниковый прибор нового типа советскими учеными было получено авторское свидетельство №757051 «Побистор». Это была первая структура, содержащая в одном корпусе мощный биполярный транзистор, поверх которого находился управляющий полевой транзистор с изолированным затвором.
Что касается промышленного внедрения, то уже в 1983 году фирмой Intarnational Rectifier был запатентован первый IGBT-транзистор. А спустя два года был разработан IGBT-транзистор с плоской структурой и более высоким рабочим напряжением. Это сделали одновременно в лабораториях двух компаний — General Electric и RCA.
Это сделали одновременно в лабораториях двух компаний — General Electric и RCA.
Первые версии биполярных транзисторов с изолированным затвором имели один серьезный недостаток — медленное переключение. Название IGBT было принято в 90-е, когда были созданы уже второе и третье поколение IGBT-транзисторов. Тогда уже этих недостатков не стало.
Отличительные преимущества IGBT-транзисторов
По сравнению с обычными полевыми транзисторами, IGBT-транзисторы обладают более высоким входным сопротивлением и более низким уровнем мощности, которая тратится на управление затвором.
В отличие от биполярных транзисторов — здесь более низкое остаточное напряжение во включенном состоянии. Потери в открытом состоянии, даже при больших рабочих напряжениях и токах, достаточно малы. При этом проводимость как у биполярного транзистора, а управляется ключ напряжением.
Диапазон рабочих напряжений коллектор-эмиттер у большинства широко доступных моделей варьируется от десятков вольт до 1200 и более вольт, при этом токи могут доходить до 1000 и более ампер. Есть сборки на сотни и тысячи вольт по напряжению и на токи в сотни ампер.
Есть сборки на сотни и тысячи вольт по напряжению и на токи в сотни ампер.
Считается, что для рабочих напряжений до 500 вольт лучше подходят полевые транзисторы, а для напряжений более 500 вольт и токов больше 10 ампер — IGBT-транзисторы, так как на более низких напряжениях крайне важно меньшее сопротивление канала в открытом состоянии.
Применение IGBT-транзисторов
Главное применение IGBT-транзисторы находят в инверторах, импульсных преобразователях напряжения и частотных преобразователях (пример — полумостовой модуль SKM 300GB063D, 400А, 600В) — там, где имеют место высокое напряжение и значительные мощности.
Сварочные инверторы — отдельная важная область применения IGBT-транзисторов: большой ток, мощность более 5 кВт и частоты до 50 кГц (IRG4PC50UD – классика жанра, 27А, 600В, до 40 кГц).
Не обойтись без IGBT и на городском электрcтранспорте: с тиристорами тяговые двигатели показывают более низкий КПД чем с IGBT, к тому же с IGBT достигается более плавный ход и хорошее сочетание с системами рекуперативного торможения даже на высоких скоростях.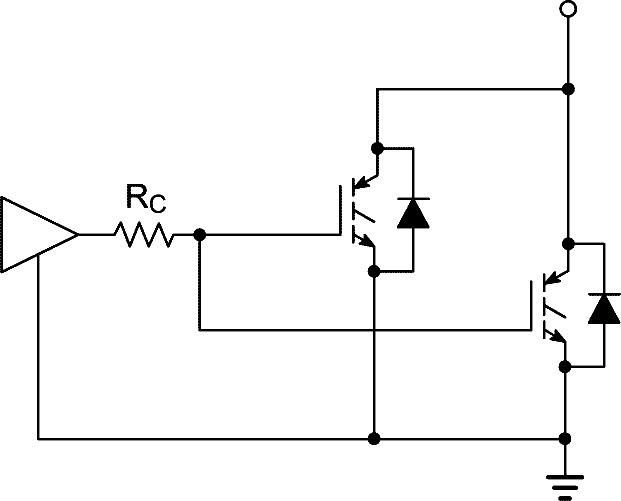
Нет ничего лучше чем IGBT, когда требуется коммутировать на высоких напряжениях (более 1000 В) или управлять частотно-регулируемым приводом (частоты до 20 кГц).
На некоторых схемах IGBT и MOSFET транзисторы полностью взаимозаменяемы, так как их цоколевка схожа, а принципы управления идентичны. Затворы в том и в другом случае представляют собой емкость до единиц нанофарад, с перезарядкой у удержанием заряда на которой легко справляется драйвер, устанавливаемый на любой подобной схеме, и обеспечивающий адекватное управление.
Ранее ЭлектроВести писали, что немецкие инженеры разработали полевой транзистор на основе оксида галлия с пробивным напряжением 1,8 кВ и рекордной добротностью — 155 МВт на квадратный сантиметр. Такие показатели приближают элемент к теоретическому лимиту оксида галлия.
По материалам: electrik.info.
Особенности применения биполярных транзисторов с изолированным затвором
Современные силовые устройства преобразования параметров электроэнергии строятся на силовых полупроводниковых ключах, отличающихся от биполярных транзисторов. Особое место среди них занимают рассматриваемые в статье IGBT технологии, то есть устройства с использованием БТИЗ транзисторов (биполярных транзисторов с изолированным затвором) или в английской аббревиатуре IGBT (Insulated Gate Bipolar Transistors) транзисторов. Применение этих технологий существенно расширяет энергетические возможностями и повышает надежность силовых электротехнических устройств.
Особое место среди них занимают рассматриваемые в статье IGBT технологии, то есть устройства с использованием БТИЗ транзисторов (биполярных транзисторов с изолированным затвором) или в английской аббревиатуре IGBT (Insulated Gate Bipolar Transistors) транзисторов. Применение этих технологий существенно расширяет энергетические возможностями и повышает надежность силовых электротехнических устройств.
Биполярные транзисторы с изолированным затвором
Различают две технологии реализации IGBT транзисторов, которые поясняются эквивалентными схемами, приведенными на рис.1а, б, а для маломощных транзисторов – на рис.1, в [2]. Как следует из рис.1, IGBT транзисторы имеют три электрода: эмиттер (э), коллектор (к) и затвор (з).
Рис.1 Tехнологии реализации IGBT транзисторов |
Сочетание двух полупроводниковых приборов в одной структуре позволило объединить преимущества полевых и биполярных транзисторов: высокое входное сопротивление и малое сопротивление между силовыми электродами во включенном состоянии.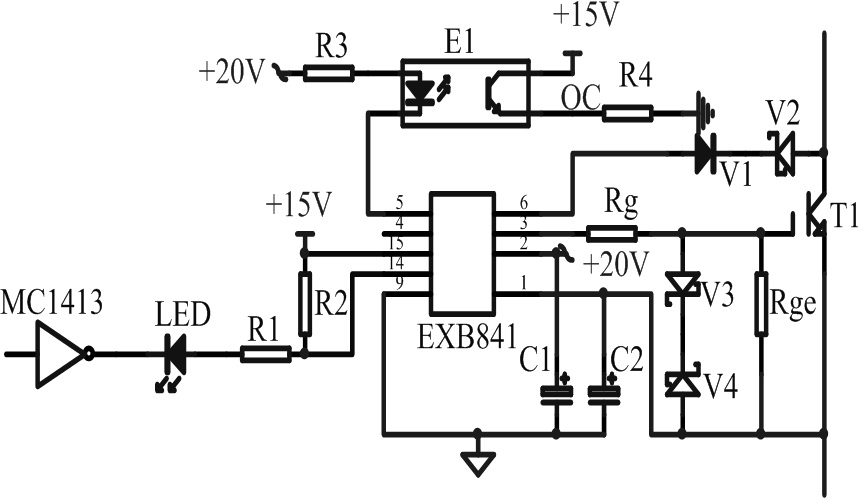
Обратим внимание на то, что на эквивалентных схемах у силового транзистора в том месте, где обозначен эмиттер, написано «коллектор», а где обозначен коллектор написано «эмиттер». Это общепринятое обозначение по принципу управления, указывающее, что входной сигнал управления подается между затвором и эмиттером.
Кратко охарактеризуем историю создания и развития IGBT транзисторов, являющихся продуктом развития технологии силовых транзисторов. Эта история насчитывает несколько десятилетий. С 80-х годов прошлого века и по сегодняшний день создано четыре поколения этих приборов: первое поколение – с 1985 года, когда были достигнуты максимальные значения напряжения Uмакс=1000В, тока Iмакс≈ 25А и минимальное значение времени переключения tпер.мин≈1мкс второе – с 1990 года, когда были достигнуты максимальные значения Uмакс=1600В, Iмакс≈ 50А и минимальное значение времени переключения tпер.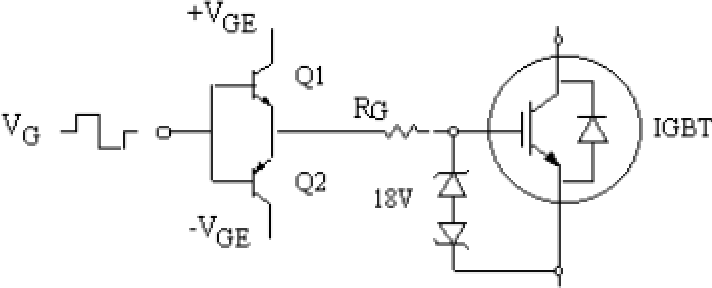 мин≈0.5мкс третье – с 1994 года, когда были достигнуты максимальные значения напряжения Uмакс=3500В тока Iмакс≈ 100А и минимальное значение времени переключения tпер.мин≈0.25мкс и, наконец, четвертое поколение – с 1998 года, для которого характерны следующие достижения:Uмакс=4500В, Iмакс≈ 150А, время переключения tпер.мин≈0.2мкс
мин≈0.5мкс третье – с 1994 года, когда были достигнуты максимальные значения напряжения Uмакс=3500В тока Iмакс≈ 100А и минимальное значение времени переключения tпер.мин≈0.25мкс и, наконец, четвертое поколение – с 1998 года, для которого характерны следующие достижения:Uмакс=4500В, Iмакс≈ 150А, время переключения tпер.мин≈0.2мкс
Для входного пробивного напряжение Uвх.пр современных IGBT транзисторов в справочных данных практически всех фирм-производителей транзисторов приводится значение, равное Uвх.пр=±20В, и таким образом при работе с этими приборами необходимо следить, чтобы напряжение затвор-эмиттер не превышало указанное значение напряжения. Далее, напряжение на затворе IGBT транзистора, при котором входной МОП и выходной биполярный транзистор начинают отпираться, составляет от 3,5 до 6,0 В, и гарантированное напряжение, при котором транзистор полностью открыт, то есть может пропускать максимально допустимый ток через коллектор-эмиттерный переход, составляет от 8 до предельного значения 20 В.
Максимальные токи, которые могут коммутировать современные IGBT транзисторы, находятся в пределах от 7 до 150 А, а их допустимый импульсный ток, как правило, в 2,5 – 3,0 раза превышает максимальный. Для больших мощностей выпускаются составленные из нескольких транзисторов модули с предельными значениями тока до 1000 А. Пробивные напряжения IGBT транзисторов находятся в пределах от 400 до 4500 В.
Основные параметры некоторых IGBT транзисторов приведены в табл.1, а параметры модулей, выпускаемых по технологии Trench или NPT, – в табл. 2 [1].
Табл.1 | |||||
Тип элемента | Uкэ В | Uкэн В | Iк при А | Iк при А | Р
|
IRG4BC30FD | 600 | 1,6 | 31 | 17 | 100 |
IRGBC30MD2 | 600 | 3,9 | 26 | 16 | 100 |
IRG4PC30FD | 600 | 1,6 | 31 | 17 | 100 |
IRG4PC40FD | 600 | 1,5 | 49 | 27 | 160 |
IRG4PC50FD | 600 | 1,5 | 70 | 39 | 200 |
IRGPC40MD2 | 600 | 4,0 | 40 | 24 | 160 |
IRGPC50MD2 | 600 | 3,0 | 59 | 35 | 200 |
IRGPh40MD2 | 1200 | 4,5 | 15 | 9 | 100 |
IRGPh50FD2 | 1200 | 4,3 | 29 | 17 | 160 |
IRGPh50MD2 | 1200 | 4,4 | 31 | 18 | 160 |
IRGPH50FD2 | 1200 | 3,9 | 45 | 25 | 200 |
IRGPH50MD2 | 1200 | 3,9 | 42 | 23 | 200 |
OM6516SC | 1000 | 4,0 | – | 25 | 125 |
OM6520SC | 1000 | 4,0 | – | 25 | 125 |
Табл. | |||||
Тип модуля | Uкэ В | Uкэн В | Iк при А | Iк при А | Р Вт |
IRGDDN300M06 | 600 | 3,0 | 399 | 159 | 1563 |
IRGDDN400M06 | 600 | 3,0 | 599 | 239 | 1984 |
IRGDDN600M06 | 600 | 3,7 | 799 | 319 | 2604 |
IRGRDN300M06 | 600 | 3,0 | 399 | 159 | 1563 |
IRGRDN400M06 | 600 | 3,0 | 599 | 239 | 1984 |
IRGRDN600M06 | 600 | 3,7 | 799 | 319 | 2604 |
IRGTDN200M06 | 600 | 3,0 | 299 | 119 | 1000 |
IRGTDN300M06 | 600 | 3,0 | 399 | 159 | 1316 |
Где:
- Uкэ — Напряжение коллектор-эмиттер
- Uкэн— Напряжение коллектор-эмиттер открытого транзистора
- Iк — Постоянный ток коллектора
- Р — Максимальная рассеиваемая мощность
Напряжение коллектор-эмиттерного перехода открытого транзистора находится в пределах от 1,5 до 4,0 В (в зависимости от типа, значений тока и предельного напряжения IGBT транзистора) в одинаковых режимах работы. Для различных типов приборов напряжение на переходе открытого транзистора тем выше, чем выше значение пробивного напряжения и скорость переключения.
Для различных типов приборов напряжение на переходе открытого транзистора тем выше, чем выше значение пробивного напряжения и скорость переключения.
Вследствие низкого коэффициента усиления выходного биполярного транзистора в целом, IGBT транзистор защищен от вторичного пробоя и имеет (что особо важно для импульсного режима) прямоугольную область безопасной работы.
С ростом температуры напряжение на коллектор-эмиттерном переходе транзистора несколько увеличивается, что дает возможность включать приборы параллельно на общую нагрузку и увеличивать суммарный выходной ток.
Также как МОП транзисторы, IGBT транзисторы имеют емкости затвор-коллектор, затвор-эмиттер, коллектор-эмиттер. Величины этих емкостей обычно в 2 – 5 раз ниже, чем у МОП транзисторов с аналогичными предельными параметрами. Это связано с тем, что у IGBT транзисторов на входе размещен маломощный МОП транзистор. Для управления им в динамических режимах нужна меньшая мощность.
Для управления им в динамических режимах нужна меньшая мощность.
Время нарастания или спада напряжения на силовых электродах IGBT транзисторов при оптимальном управлении составляет около 50 – 200 нс и определяется в основном скоростью заряда или разряда емкости затвор-коллектор от схемы управления.
Существенным преимуществом IGBT транзисторов по сравнению с биполярными транзисторами является то, что биполярные транзисторы в структуре IGBT не насыщаются и, следовательно, у них отсутствует время рассасывания. Однако после уменьшения напряжения на затворе ток через силовые электроды еще протекает в течение от 80 – 200 нс до единиц мкс в зависимости от типа прибора. Уменьшить эти временные параметры невозможно, так как база p-n-p транзистора недоступна.
Технологические методы уменьшения времени спада ведут к увеличению напряжения насыщения коллектор-эмиттерного перехода. Поэтому чем более быстродействующим является транзистор, тем выше напряжение насыщения.
IGBT транзисторы по сравнению с МОП транзисторами обладают следующими преимуществами:
- Экономичностью управления, связанной с меньшим значением емкости затвора и, соответственно, меньшими динамическими потерями на управление.
- Высокой плотностью тока в переходе эмиттер-коллектор – такой же, как и у биполярных транзисторов.
- Меньшими потери в режимах импульсных токов.
- Практически прямоугольной областью безопасной работы.
- Возможностью параллельного соединения транзисторов для работы на общую нагрузку.
- Динамическими характеристиками у транзисторов, выпущенных за последние годы, приближающимися к характеристикам МОП транзисторов.
Основным недостатком IGBT транзисторов является сравнительно большое время выключения, что ограничивает частоты переключения до 20 – 100 кГц даже у самых быстродействующих транзисторов. Кроме того, с ростом частоты необходимо уменьшать ток коллектора. Например, из зависимости тока коллектора IGBT транзистора от частоты для транзистора IRGPC50UD2, приведенной на рис. 2, следует, что при частотах работы транзисторов, превышающих 10 кГц, приходится уменьшать ток коллектора более чем в два раза. Но все же для силовых инверторов с увеличением мощности преобразования рабочую частоту необходимо уменьшать также из соображений уменьшения влияния паразитных индуктивностей монтажа.
Например, из зависимости тока коллектора IGBT транзистора от частоты для транзистора IRGPC50UD2, приведенной на рис. 2, следует, что при частотах работы транзисторов, превышающих 10 кГц, приходится уменьшать ток коллектора более чем в два раза. Но все же для силовых инверторов с увеличением мощности преобразования рабочую частоту необходимо уменьшать также из соображений уменьшения влияния паразитных индуктивностей монтажа.
Рис.2 Зависимость тока коллектора IGBT транзистора от частоты |
Процесс включения IGBT транзистора разделяется на два этапа. При подаче положительного напряжения между затвором и истоком открывается полевой транзистор, и далее движение зарядов из области n в область p приводит к открыванию биполярного транзистора, то есть к появлению тока между эмиттером и коллектором. Таким образом, полевой транзистор управляет биполярным.
Таким образом, полевой транзистор управляет биполярным.
У IGBT транзисторов с максимальным значением напряжения в пределах 500 – 1200 В падение напряжения в насыщенном состоянии находится в диапазоне 1,2 – 3,5 В, то есть оно приблизительно такое же, как и у биполярных транзисторов. Однако эти значения падения напряжения намного меньшие по сравнению со значениями падения напряжения на силовых MOП транзисторах в проводящем состоянии с аналогичными параметрами.
С другой стороны, MOП транзисторы с максимальными значениями напряжения, не превышающими 200 В, имеют меньшие значения падения напряжения между силовыми электродами во включенном состоянии, чем IGBT транзисторы. В связи с этим применение МОП транзисторов является более предпочтительным в области низких рабочих напряжений и коммутируемых токов до 70 А.
По быстродействию IGBT транзисторы превосходят биполярные транзисторы, однако уступают MOП транзисторам. Значения времен рассасывания накопленного заряда и спада тока при выключении IGBT транзисторов находятся в пределах 0,2 – 0,4 мкс.
Значения времен рассасывания накопленного заряда и спада тока при выключении IGBT транзисторов находятся в пределах 0,2 – 0,4 мкс.
Область безопасной работы IGBT транзисторов позволяет обеспечить надежную работу этих устройств без усложнений дополнительными цепями ускорения переключения при частотах от 10 до 20 кГц. Этого не могут обеспечить биполярные транзисторы.
IBGT транзисторы относятся к приборам силовой электроники, и выпускаемые промышленностью на сегодняшний день реальные приборы имеют предпочтение в их использовании в диапазоне мощностей от единиц киловатт до единиц мегаватт. Дальнейшее совершенствование IGBT транзисторов проводится по пути повышения быстродействия, предельных коммутируемых токов и напряжений.
Управление МОП и IGBT транзисторами
МОП и IGBT транзисторы являются полупроводниковыми приборами, управляемыми напряжением. Из обширного круга вопросов, относящихся к проблеме управления этими приборами, особый интерес представляет наиболее сложный случай управления, который имеет место в мостовой или полумостовой схеме включения с индуктивной погрузкой.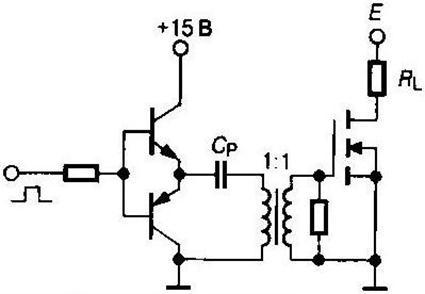
Отметим, что управление транзисторами инверторов можно осуществлять через импульсные высокочастотные трансформаторы, хотя такое управление усложняет конструкцию и принципиальную схему инвертора. Отсутствие тока потребления на управление в статических режимах и низкое общее потребление мощности затворами транзисторов позволяют отказаться от трансформаторных схем питания.
Компаниями-производителями силовых полупроводников выпускается ряд драйверов управления, которые согласовывают маломощную схему управления с выходными транзисторами верхнего и нижнего плеча силового инвертора. Выходные каскады этих драйверов выполняются, как правило, в виде двухтактных усилителей мощности на полевых транзисторах, обеспечивающих импульсный выходной ток до 2 А. Организация питания верхнего плеча инвертора осуществляется по схеме зарядного «насоса», показанной на рис. 3.
Рис. |
Схемы формирования, гальваническая развязка и усилитель нижнего плеча драйверов получают питание от низковольтного вспомогательного источника питания Uн. При включении транзистора нижнего плеча VT2 (в первом полупериоде работы) диод VD1 открывается и заряжает накопительный конденсатор С1, в дальнейшем питающий усилитель верхнего плеча. В каждом полупериоде при открытом транзисторе VT2 конденсатор C1 подзаряжается, а при открытом транзисторе VT1 питается выходной усилитель верхнего плеча.
В последнее время фирмы-производители полупроводниковых приборов начали выпускать различные драйверы отдельных транзисторов полумостовых и мостовых схем, выдерживающие напряжение до 600 В. В качестве примера приведем наименование некоторых из этих драйверов [3]:
- IR2125 – драйвер верхнего плеча;
- IR2110, Н1Р25001Р, PWR 200/201– драйверы полумостового инвертора;
- IR2130 – драйвер трехфазной мостовой схемы;
- IR2155 – драйвер полумостового инвертора с автогенератором.

Эти драйверы надежно работают и обеспечивают оптимальные параметры в работе с МОП и IGBT транзисторами. К тому же их стоимость небольшая, а схемы инверторов требуют установки всего лишь одного драйвера и нескольких внешних компонентов.
Переключение больших токов с высокими скоростями переключения сопряжено с рядом трудностей. Для получения надежно работающих устройств основные усилия должны быть направлены на создание конструкции с минимизированными величинами паразитных индуктивностей, которые в случае не принятия специальных мер могут запасать значительное количество энергии в силовых шинах тока и вызывать нежелательные переключения силовых ключей, всплески высокого напряжения, дополнительную мощность рассеяния на силовых транзисторах, ложные срабатывания и т.д.
Микросхема драйвера IR2110 является одной из многих схем, применяемых для полумостовых высоковольтных инверторов. Полумостовой инвертор на IGBT транзисторах показан на рис. 4. Резисторы R2 и R3 служат для уменьшения скорости переключения силовых транзисторов. Дело в том, что управление затворами мощных IGBT или МОП транзисторов непосредственно от драйвера IR2110 или ему аналогичного может привести к нежелательно высоким скоростям переключения.
4. Резисторы R2 и R3 служат для уменьшения скорости переключения силовых транзисторов. Дело в том, что управление затворами мощных IGBT или МОП транзисторов непосредственно от драйвера IR2110 или ему аналогичного может привести к нежелательно высоким скоростям переключения.
Реальная конструкция инвертора обладает конечными значениями величин индуктивностей соединений, на которых выделяются всплески напряжений при переключениях плеч, причем чем меньше время переключения, тем больше амплитуда всплеска. Величины резисторов R2 и R3 выбираются таким образом, чтобы фронты переключений не порождали значительных потерь и больших импульсных амплитуд, нарушающих работу инвертора.
Рис.4 Схема полумостового инвертора на IGBT транзисторах |
На входы 10 и 12 драйвера должны поступать две импульсные последовательности, причем вход 10 управляет транзистором VT1, а вход 12 – транзистором VT2. Вход 11 включает или выключает инвертор и может использоваться для защиты, то есть при подаче напряжения на вход 11 работа преобразователя прекращается.
Вход 11 включает или выключает инвертор и может использоваться для защиты, то есть при подаче напряжения на вход 11 работа преобразователя прекращается.
Драйвер IR2155, позволяющий получить самую простую схему полумостового преобразователя, представляет собой монолитную интегральную схему, способную управлять двумя транзисторами в полумостовом преобразователе. Они могут работать при напряжениях питания до 600 В, имеют четкие формы выходных импульсов с коэффициентами заполнения от 0 до 99 %.
Функциональная схема драйвера IR 2151 показана на рис. 5.
Рис.5 Функциональная схема драйвера IR 2151 |
Драйвер содержит входную часть на операционных усилителях, которая может работать в автогенераторном режиме. Частота определяется дополнительными навесными элементами, подключаемыми к выводам C1, R1.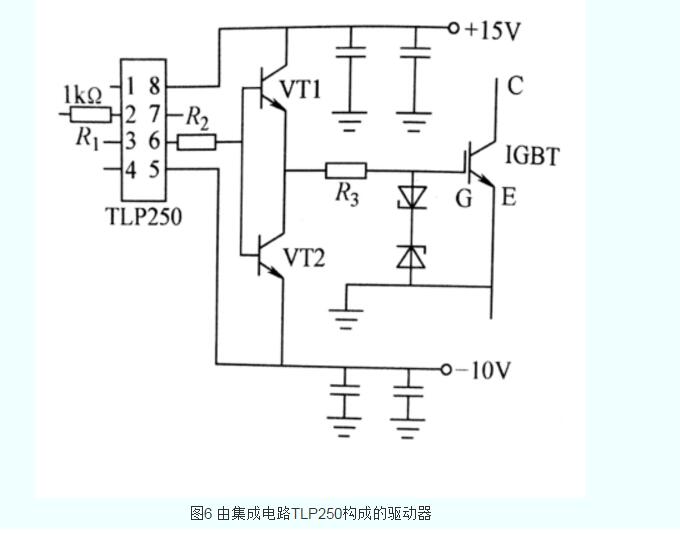 Генераторы паузы на нуле обеспечивают задержки во включении выходного транзистора на 1 мкс после закрытия предыдущего транзистора. В канале верхнего плеча осуществляется гальваническая развязка, далее напряжение усиливается усилителем мощности на полевых транзисторах и выходное напряжение с выхода HO(7) поступает на затвор силового транзистора. Нижнее плечо работает от задающего генератора через генератор паузы на нуле и устройство задержки.
Генераторы паузы на нуле обеспечивают задержки во включении выходного транзистора на 1 мкс после закрытия предыдущего транзистора. В канале верхнего плеча осуществляется гальваническая развязка, далее напряжение усиливается усилителем мощности на полевых транзисторах и выходное напряжение с выхода HO(7) поступает на затвор силового транзистора. Нижнее плечо работает от задающего генератора через генератор паузы на нуле и устройство задержки.
Для обеспечения стабильности работы драйвера внутри имеется стабилитрон, ограничивающий напряжение Vcc(1) на уровне 15 В.
Литература
- Short form catalog International Rectifier. Product Digest.
- В.И. Сенько и др. Электроника и микросхемотехника (на укр. яз.). Том 1. – К.: Обереги, 2000.
- М. Браун. Источники питания. Расчет и конструирование. Пер. с англ. – К.: МК-Прогрес, 2007.
- Микросхемы для импульсных источников питания – 3.
 – М.: Изд. дом «Додека – ХХI», 2002.
– М.: Изд. дом «Додека – ХХI», 2002.
IGBT транзисторы — определение, схематическое обозначение, упрощенная эквивалентная схема и основные применения
Биполярный транзистор с изолированным затвором (БТИЗ) или IGBT от английского Insulated-gate bipolar transistor — прибор совмещающий в одном корпусе два электронных компонента — полевой и биполярный транзисторы.
Рис. 2 Схематическое обозначение IGBT и упрощенная эквивалентная схема
По своей структуре igbt представляет собой составной транзистор включенный по каскадной схеме. Схематическое обозначение IGBT показано на рисунке 2 справа. Транзистор имеет три вывода: G – «затвор», C – «коллектор», E – «эмиттер». Входная часть транзистора изображается как вход МОП — транзистора с индуцированным каналом, выходная часть как выход биполярного p-n-p транзистора. Упрощенная эквивалентная схема IGBT показана на рисунке 2 слева. Интересно, что «коллектору» IGBT соответствует «эмиттер» выходного биполярного p-n-p транзистора, а «эмиттеру» наоборот «коллектору».
Такое составное включение двух электронных ключей: входной ключ на низковольтном полевом транзисторе управляет мощным оконечным ключом на высоковольтном биполярном транзисторе, позволило объединить преимущества обеих типов полупроводниковых приборов в одном корпусе.
IGBT сочетает преимущества полевых и биполярных транзисторов:
- высокое входное сопротивление, малый ток управления — от полевых транзисторов с изолированным затвором (МОП)
- низкое значение остаточного напряжения во включенном состоянии — от биполярных транзисторов.
- малые потери в открытом состоянии при больших токах и высоких напряжениях;
- характеристики переключения и проводимость биполярного транзистора;
- управление не током, а напряжением как у МОП.
Основное применение IGBT транзисторов
IGBT применяют при работе с высокими напряжениями — более 1000 Вольт, высокой температурой — более 100 °C и высокой выходной мощностью — более 5 кВт.
Основное применение IGBT транзисторов — это импульсные регуляторы тока, частотно-регулируемые приводы, инверторы.
Широкое применение igbt транзисторы нашли в схемах управления импульсной лампы во внешних вспышках для зеркальных фотоаппаратов, управлении мощным электроприводом, в источниках сварочного тока, источниках бесперебойного питания и т.д.
Пример реализации схемы управления импульсной лампой во внешней вспышке Nissin Di 866 на igbt транзисторе RJP4301 купить который можно в нашем магазине.
Что такое IGBT — работа, работа, приложения и различные типы IGBT
Самыми популярными и часто используемыми силовыми электронными переключателями являются биполярный транзистор BJT и MOSFET. Мы уже подробно обсудили работу BJT и MOSFET, а также то, как они используются в схемах. Но оба этих компонента имели некоторые ограничения для использования в приложениях с очень высоким током. Итак, мы переместили еще одно популярное силовое электронное коммутационное устройство, называемое IGBT.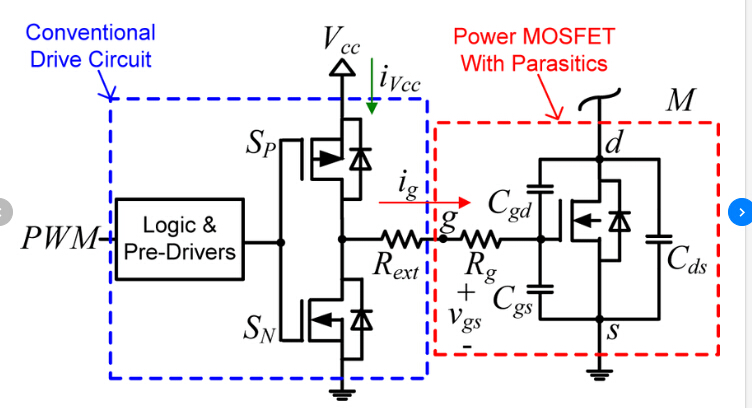 Вы можете думать о IGBT как о слиянии BJT и MOSFET, эти компоненты имеют входные характеристики BJT и выходные характеристики MOSFET. В этой статье мы познакомимся с основами IGBT , с тем, как они работают и как использовать их в схемах.
Вы можете думать о IGBT как о слиянии BJT и MOSFET, эти компоненты имеют входные характеристики BJT и выходные характеристики MOSFET. В этой статье мы познакомимся с основами IGBT , с тем, как они работают и как использовать их в схемах.
Что такое IGBT?
IGBT — это сокращенная форма биполярного транзистора с изолированным затвором . Это трехконтактное полупроводниковое переключающее устройство, которое может использоваться для быстрого переключения с высокой эффективностью во многих типах электронных устройств.Эти устройства в основном используются в усилителях для коммутации / обработки сложных волновых схем с широтно-импульсной модуляцией (ШИМ). Типичный символ IGBT вместе с его изображением показан ниже.
Как упоминалось ранее, IGBT представляет собой смесь BJT и MOSFET. Символ IGBT также представляет то же самое, поскольку вы можете видеть, что сторона входа представляет собой полевой МОП-транзистор с выводом затвора, а сторона вывода представляет собой BJT с коллектором и эмиттером. Коллектор и Эмиттер являются выводами проводимости, а затвор — это контрольный вывод , с помощью которого осуществляется управление операцией переключения.
Коллектор и Эмиттер являются выводами проводимости, а затвор — это контрольный вывод , с помощью которого осуществляется управление операцией переключения.
Внутренняя структура IGBT
IGBT может быть сконструирован с эквивалентной схемой, состоящей из двух транзисторов и MOSFET, поскольку IGBT обладает выходом указанной ниже комбинации транзистора PNP, транзистора NPN и MOSFET. БТИЗ сочетает в себе низкое напряжение насыщения транзистора с высоким входным сопротивлением и скоростью переключения полевого МОП-транзистора.Результат, полученный в результате этой комбинации, обеспечивает характеристики переключения выхода и проводимости биполярного транзистора, но напряжение регулируется как полевой МОП-транзистор.
Поскольку IGBT представляет собой комбинацию MOSFET и BJT, они также называются по-разному. различных наименований IGBT : транзистор с изолированным затвором (IGT), транзистор с изолированным затвором и оксидом металла (MOSIGT), полевой транзистор с модулированным усилением (GEMFET), полевой транзистор с кондуктивной модуляцией (COMFET).
Работа IGBT
IGBT имеет три вывода, прикрепленных к трем различным металлическим слоям, металлический слой вывода затвора изолирован от полупроводников слоем диоксида кремния (SIO2). IGBT состоит из 4 слоев полупроводника, соединенных между собой. Слой, расположенный ближе к коллектору, — это слой подложки p + , выше, это слой n- , другой слой p находится ближе к эмиттеру, а внутри слоя p, у нас есть слоев n + .Соединение между слоем p + и n-слоем называется соединением J2, а соединение между n-слоем и слоем p называется соединением J1. Структура IGBT показана на рисунке ниже.
Чтобы понять, как работает IGBT , рассмотрим источник напряжения V G , подключенный к клемме затвора по отношению к эмиттеру. Рассмотрим другой источник напряжения V CC , подключенный между эмиттером и коллектором, где коллектор остается положительным по отношению к эмиттеру. Из-за источника напряжения V CC переход J1 будет смещен в прямом направлении, а переход J2 будет смещен в обратном направлении. Поскольку J2 имеет обратное смещение, ток не будет протекать внутри IGBT (от коллектора к эмиттеру).
Из-за источника напряжения V CC переход J1 будет смещен в прямом направлении, а переход J2 будет смещен в обратном направлении. Поскольку J2 имеет обратное смещение, ток не будет протекать внутри IGBT (от коллектора к эмиттеру).
Сначала учтите, что на клемму Gate не подается напряжение, на этом этапе IGBT будет в непроводящем состоянии. Теперь, если мы увеличим приложенное напряжение затвора, из-за эффекта емкости на слое SiO2 отрицательные ионы будут накапливаться на верхней стороне слоя, а положительные ионы будут накапливаться на нижней стороне слоя SiO2.Это вызовет вставку отрицательно заряженных носителей в p-область, чем выше приложенное напряжение V G , тем больше вставка отрицательно заряженных носителей. Это приведет к образованию канала между переходом J2, который позволяет протеканию тока от коллектора к эмиттеру . Прохождение тока представлено как путь тока на рисунке, когда прикладываемое напряжение затвора V G увеличивается, величина тока, протекающего от коллектора к эмиттеру, также увеличивается.
Типы IGBT
IGBT классифицируется как два типа на основе буферного слоя n +, IGBT, которые имеют буферный слой n +, называются Punch through IGBT (PT-IGBT) , IGBT, которые не имеют буферного слоя n +, называются без пробивки на сквозной IGBT (NPT-IGBT).
Исходя из своих характеристик, NPT-IGBT и PT-IGBT называются симметричными и несимметричными IGBT. Симметричные IGBT имеют одинаковое прямое и обратное напряжение пробоя.Асимметричные IGBT — это те, которые имеют обратное напряжение пробоя меньше, чем прямое напряжение пробоя. Симметричные IGBT в основном используются в цепях переменного тока, тогда как асимметричные IGBT в основном используются в цепях постоянного тока, поскольку им не нужно поддерживать напряжение в обратном направлении.
Разница между пробивкой через IGBT (PT-IGBT) и без пробивки через IGBT (NPT-IGBT)
Пробивка через IGBT (PT-IGBT) | Без дырокола — IGBT (NPT — IGBT) |
Они менее устойчивы к режимам короткого замыкания и имеют меньшую термическую стабильность.
| Они более надежны при отказе от короткого замыкания и обладают большей термостойкостью.
|
Коллектор представляет собой сильно легированный слой P +
| Коллектор представляет собой слаболегированный P-слой.
|
Он имеет небольшой положительный температурный коэффициент напряжения в открытом состоянии, поэтому параллельная работа требует большой осторожности и внимания.
| Температурный коэффициент напряжения в открытом состоянии строго положительный, поэтому параллельная работа проста.
|
Потери при выключении более чувствительны к температуре, поэтому они значительно возрастают при более высокой температуре. | Потеря отключения менее чувствительна к температуре, поэтому она остается неизменной с температурой. |
Работа IGBT как цепи
Поскольку IGBT представляет собой комбинацию BJT и MOSFET, давайте рассмотрим их работу в виде принципиальной схемы.На приведенной ниже диаграмме показана внутренняя схема IGBT , которая включает в себя два BJT, один MOSFET и JFET. Контакты затвора, коллектора и эмиттера IGBT отмечены ниже.
Коллектор транзистора PNP соединен с транзистором NPN через JFET, JFET соединяет коллектор транзистора PNP и базу транзистора PNP. Эти транзисторы скомпонованы таким образом, чтобы образовать паразитный тиристор, созданный для создания контура отрицательной обратной связи .Резистор RB помещается так, чтобы закоротить выводы базы и эмиттера NPN-транзистора, чтобы гарантировать, что тиристор не защелкивается, что приводит к защелкиванию IGBT. JFET, используемый здесь, будет обозначать структуру тока между любыми двумя ячейками IGBT, позволяет использовать MOSFET и поддерживает большую часть напряжения.
Характеристики переключения IGBT
IGBT — это устройство , управляемое напряжением, , поэтому ему требуется только небольшое напряжение на затвор, чтобы оставаться в состоянии проводимости.А поскольку это однонаправленные устройства, они могут переключать ток только в прямом направлении, то есть от коллектора к эмиттеру. Типичная схема переключения IGBT показана ниже, напряжение затвора V G прикладывается к выводу затвора для переключения двигателя (M) с напряжения питания V +. Резистор Rs примерно используется для ограничения тока через двигатель.
Входные характеристики IGBT можно понять из приведенного ниже графика. Первоначально, когда на вывод затвора не подается напряжение, IGBT находится в выключенном состоянии и ток не течет через вывод коллектора.Когда напряжение, приложенное к выводу затвора, превышает пороговое напряжение , IGBT начинает проводить, и ток коллектора I G начинает течь между выводами коллектора и эмиттера. Ток коллектора увеличивается относительно напряжения затвора, как показано на графике ниже.
Ток коллектора увеличивается относительно напряжения затвора, как показано на графике ниже.
Выходные характеристики IGBT имеют три ступени. Первоначально, когда напряжение затвора V GE равно нулю, устройство находится в выключенном состоянии, это называется областью отсечки .Когда V GE увеличивается и если оно меньше, чем пороговое напряжение , то через устройство будет протекать небольшой ток утечки, но устройство все равно будет находиться в области отсечки. Когда напряжение V GE превышает пороговое значение, устройство переходит в активную область , и ток начинает течь через устройство. Протекание тока будет увеличиваться с увеличением напряжения V GE , как показано на графике выше.
Приложения IGBT
БТИЗ
используются в различных приложениях, таких как приводы двигателей переменного и постоянного тока, нерегулируемые источники питания (ИБП), импульсные источники питания (SMPS), управление тяговыми двигателями и индукционный нагрев, инверторы, используемые для объединения полевых транзисторов с изолированным затвором для управления вход и биполярный силовой транзистор в качестве переключателя в одном устройстве и т. д.
д.
Пакеты IGBT
GBT доступны в разных типах пакетов с разными названиями от разных компаний.Например, Infineon Technologies предлагает пакеты для сквозного монтажа и для поверхностного монтажа. Пакет сквозного типа включает ТО-262, ТО-251, ТО-273, ТО-274, ТО-220, ТО-220-3 FP, ТО-247, ТО-247AD. В комплект для поверхностного монтажа входят ТО-263, ТО-252.
БТИЗ | Полевые транзисторы с изолированным затвором
Благодаря изолированным затворам, IGFET всех типов имеют чрезвычайно высокое усиление по току: не может быть устойчивого тока затвора, если нет непрерывной цепи затвора, в которой ток может непрерывно течь.Таким образом, единственный ток, который мы видим через вывод затвора IGFET, — это любой переходный процесс (краткий всплеск), который может потребоваться для зарядки емкости затворного канала и смещения области обеднения, когда транзистор переключается из состояния «включено» в состояние « выключено, или наоборот.
Этот высокий коэффициент усиления по току на первый взгляд может дать технологии IGFET явное преимущество по сравнению с биполярными транзисторами для управления очень большими токами. Если биполярный переходной транзистор используется для управления большим током коллектора, должен быть значительный базовый ток, получаемый или опускаемый какой-либо схемой управления в соответствии с коэффициентом β.В качестве примера: для того, чтобы силовой BJT с β, равным 20, проводил ток коллектора 100 А, должен быть не менее 5 А базового тока, что само по себе является значительным током для миниатюрных дискретных или интегральных схем управления. в обращении:
Транзистор со схемой управления
Было бы неплохо с точки зрения схемы управления иметь силовые транзисторы с большим коэффициентом усиления по току, так что для управления током нагрузки требуется гораздо меньший ток.Конечно, мы можем использовать транзисторы на паре Дарлингтона для увеличения коэффициента усиления по току, но такая схема по-прежнему требует гораздо большего управляющего тока, чем эквивалентная мощность IGFET:
К сожалению, у IGFET есть проблемы с собственным контролем высокого тока: они обычно показывают большее падение напряжения сток-исток в насыщенном состоянии, чем падение напряжения коллектор-эмиттер насыщенного BJT. Это большее падение напряжения означает более высокую рассеиваемую мощность при той же величине тока нагрузки, что ограничивает полезность IGFET-транзисторов в качестве мощных устройств.Хотя некоторые специализированные конструкции, такие как так называемый транзистор VMOS, были разработаны для минимизации этого неотъемлемого недостатка, транзистор с биполярным переходом все еще превосходит по своей способности коммутировать большие токи.
Это большее падение напряжения означает более высокую рассеиваемую мощность при той же величине тока нагрузки, что ограничивает полезность IGFET-транзисторов в качестве мощных устройств.Хотя некоторые специализированные конструкции, такие как так называемый транзистор VMOS, были разработаны для минимизации этого неотъемлемого недостатка, транзистор с биполярным переходом все еще превосходит по своей способности коммутировать большие токи.
Интересное решение этой дилеммы использует лучшие характеристики IGFET с лучшими функциями BJT в одном устройстве, называемом биполярным транзистором с изолированным затвором или IGBT. Также известный как биполярный МОП-транзистор, полевой транзистор с модуляцией проводимости (COMFET) или просто как транзистор с изолированным затвором (IGT), он эквивалентен паре Дарлингтона IGFET и BJT:
Условное обозначение
и эквивалентная схема
По сути, IGFET управляет базовым током BJT, который управляет основным током нагрузки между коллектором и эмиттером. Таким образом, достигается чрезвычайно высокий коэффициент усиления по току (поскольку изолированный затвор IGFET практически не потребляет ток от схемы управления), но падение напряжения между коллектором и эмиттером во время полной проводимости такое же низкое, как у обычного BJT.
Таким образом, достигается чрезвычайно высокий коэффициент усиления по току (поскольку изолированный затвор IGFET практически не потребляет ток от схемы управления), но падение напряжения между коллектором и эмиттером во время полной проводимости такое же низкое, как у обычного BJT.
Недостаток IGBT
Одним из недостатков IGBT по сравнению со стандартным BJT является более медленное время выключения. Для быстрого переключения и высокой пропускной способности по току трудно превзойти биполярный переходной транзистор. Более быстрое выключение IGBT может быть достигнуто за счет определенных изменений в конструкции, но только за счет более высокого падения напряжения в насыщении между коллектором и эмиттером.Однако IGBT предоставляет хорошую альтернативу IGFET и BJT для приложений управления высокой мощностью.
СВЯЗАННЫЙ РАБОЧИЙ ЛИСТ:
IGBT: часто задаваемые вопросы (FAQ)
Компании начинают осознавать потенциал новых рынков и возможности получения доходов в нисходящем направлении, поскольку они исследуют более комплексную модель «кремний — услуги», которая охватывает центр обработки данных и мобильную периферию.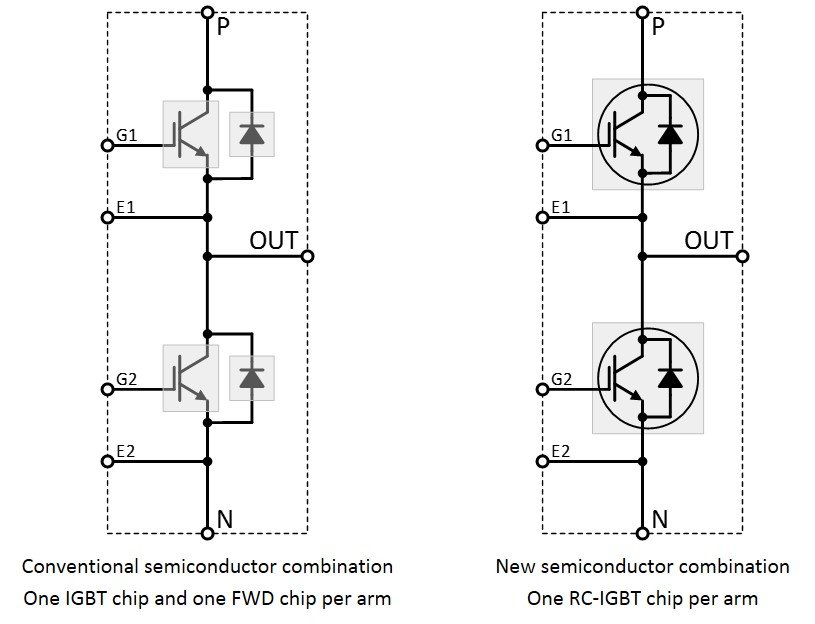 В частности, с сокращением ASP (средние цены продажи) и все более непомерно высокими затратами на проектирование на все более низких узлах многие компании ищут новые источники доходов в широком диапазоне вертикалей, включая Интернет вещей (IoT).
В частности, с сокращением ASP (средние цены продажи) и все более непомерно высокими затратами на проектирование на все более низких узлах многие компании ищут новые источники доходов в широком диапазоне вертикалей, включая Интернет вещей (IoT).
Однако с учетом того, что количество установок Интернета вещей, как ожидается, будет увеличиваться примерно на 15–20% ежегодно до 2020 года, безопасность в настоящее время рассматривается как серьезная возможность, так и серьезная проблема для полупроводниковой промышленности.
Помимо услуг, концепция оборудования с открытым исходным кодом (OSH) и построения микросхем из разукрупненных, предварительно проверенных чиплетов начинает набирать обороты, поскольку компании стремятся сократить расходы и сократить время вывода на рынок гетерогенных конструкций.
Конкретные стратегии раскрытия всего потенциала кремния и услуг, несомненно, будут различаться, поэтому для нас важно исследовать будущее, в котором полупроводниковые компании, а также различные отрасли, организации и правительственные учреждения будут играть открытую и совместную роль в помогая устойчиво монетизировать как микросхемы, так и услуги.
В 2016 и 2017 годах продолжались быстрые приобретения и консолидация отрасли:
- Компания Analog Devices приобрела Linear Technology
- Infineon приобрела International Rectifier
- Компания ROHM приобрела Powervation
- Renesas приобрела Intersil
Крупные производители полупроводников позиционируют себя, чтобы лучше конкурировать в различных сферах, включая облачные вычисления, искусственный интеллект (AI) и беспилотные автомобили.Согласно KPMG, многие компании все чаще рассматривают слияния и поглощения (M&A) как единственный способ стимулировать рост реальной выручки, делая новый акцент на вопросе «производить или покупать», при этом многие выбирают ответ «покупать».
Одновременно с этим продолжали расти расходы на разработку микросхем, что существенно влияло на количество разработок в усовершенствованных узлах. В частности, общее количество запусков SoC Advanced Performance Multicore в первый раз было примерно одинаковым и лишь незначительно увеличилось за последние пять лет. Хотя цены на дизайн неуклонно растут с 40 нм, аналитиков больше всего беспокоит увеличение затрат на дизайн на 7 и 5 нм.
Хотя цены на дизайн неуклонно растут с 40 нм, аналитиков больше всего беспокоит увеличение затрат на дизайн на 7 и 5 нм.
Рич Вавжиняк, старший аналитик Semico Research, подтверждает, что начало проектирования, превышающее 10 нм, будет сдерживаться ростом затрат на разработку. Хотя общее количество проектов, которые переносятся на новые узлы, может не сильно отличаться от предыдущих обновлений геометрии процесса, Вавжиняк говорит, что сроки для таких переходов большинством компаний будут более продолжительными.
Совершенно очевидно, что необходимы новые модели как для НИОКР, так и для доходов, поскольку усиление консолидации отрасли и ослабление АСП являются неустойчивыми в долгосрочной перспективе. Именно поэтому отрасль стремится к Интернету вещей для создания дополнительных потоков доходов, и аналитики McKinsey Global Institute (MGI) оценивают, что IoT может иметь ежегодный экономический эффект от 3,9 до 11,1 триллиона долларов к 2025 году по нескольким вертикалям. Тем не менее, учитывая, что количество установок Интернета вещей, как ожидается, будет увеличиваться примерно на 15–20% ежегодно до 2020 года, безопасность считается как серьезной возможностью, так и проблемой для полупроводниковых компаний.
Таким образом, MGI рекомендует создавать решения безопасности, которые позволяют компаниям, производящим полупроводники, расширяться в смежные области бизнеса и разрабатывать новые бизнес-модели. Например, компании могут помочь создать предложения по комплексной безопасности, которые необходимы для успеха Интернета вещей. В идеале, по мнению MGI, отрасль должна играть ведущую роль при разработке таких предложений, чтобы гарантировать, что они получат свою справедливую долю в цепочке создания стоимости.
С нашей точки зрения, решения для сквозной безопасности Интернета вещей, развернутые как платформа как услуга (PaaS), имеют решающее значение для помощи полупроводниковым компаниям в получении возобновляемых доходов от реализации конкретных услуг.Для клиентов PaaS предлагает простой способ безопасной разработки, запуска и управления приложениями и устройствами без сложностей, связанных с построением и обслуживанием сложной инфраструктуры.
Такие решения безопасности, которые также могут использовать аппаратный корень доверия, должны поддерживать идентификацию устройства и взаимную аутентификацию (проверку), стандартные проверки аттестации, безопасные обновления устройств по беспроводной сети (OTA), аварийное восстановление и ключ управление, а также вывод из эксплуатации и переназначение ключей для лучшего управления устройствами и предотвращения различных атак, включая распределенный отказ в обслуживании (DDoS).
Умные города
Недоступные микросхемы — такие как микросхемы, встроенные в инфраструктуру интеллектуального города Интернета вещей — могут предложить полупроводниковым компаниям возможность реализовать долгосрочную модель PaaS «кремний для обслуживания». В самом деле, инфраструктура будущего умного города почти наверняка будет спроектирована с использованием микросхем в труднодоступных местах, включая подземные водопроводные трубы, воздуховоды для кондиционирования воздуха, а также под улицами и на парковках.
Интеллектуальное уличное освещение, отзывчивые вывески и маячки Bluetooth нового поколения также требуют перспективных решений, чтобы избежать постоянного физического обслуживания и обновлений.Следовательно, микросхема, питающая инфраструктуру умного города, должна быть способна поддерживать безопасную конфигурацию функций в полевых условиях, а также различные услуги на основе PaaS, такие как расширенная аналитика, предупреждения о профилактическом обслуживании, алгоритмы самообучения и интеллектуальное проактивное взаимодействие с клиентами.
Умные дома
Прогнозируется, что к 2020 году мировой рынок умного дома достигнет стоимости не менее 40 миллиардов долларов. По данным Markets and Markets, рост пространства умного дома можно объяснить множеством факторов, включая значительные успехи в секторе Интернета вещей; возрастающие требования к удобству, безопасности и защищенности потребителей; более выраженная потребность в энергосберегающих решениях с низким уровнем выбросов углерода.Однако, как мы уже обсуждали ранее, крайне важно обеспечить реализацию безопасности Интернета вещей на этапе разработки продукта, чтобы предотвратить использование злоумышленниками устройств умного дома и прерывание обслуживания.
В дополнение к потенциально прибыльным возможностям кибербезопасности для полупроводниковых компаний, устройства «умный дом» обещают создать повторяющиеся потоки доходов для поддержки устойчивой модели «от кремния к услугам». В качестве примера Кристопер Дин из MarketingInsider выделяет популярные устройства Echo от Amazon.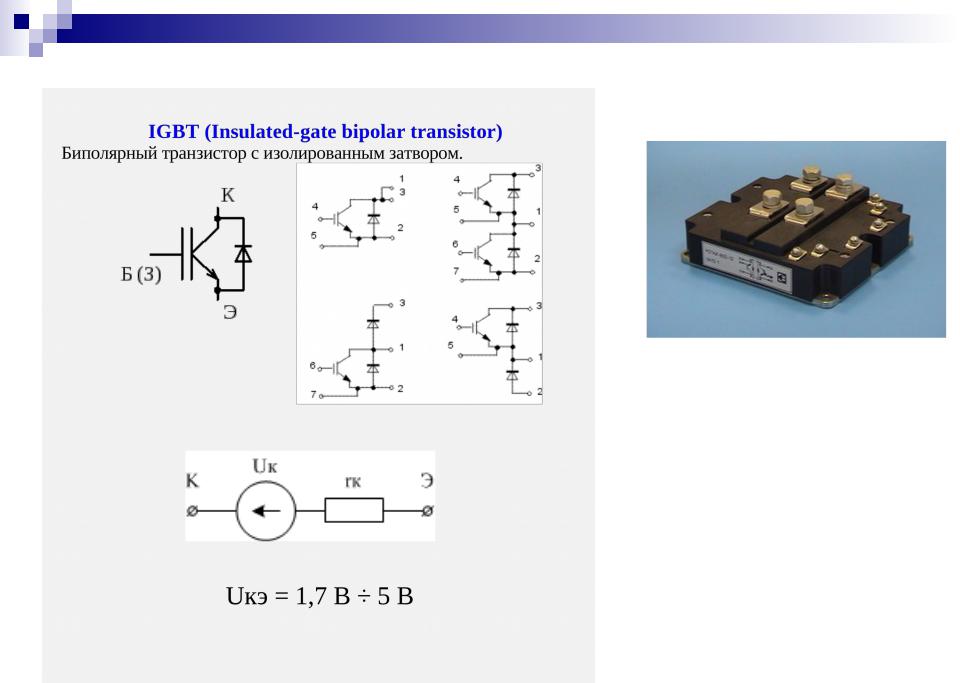 Поскольку уже продано не менее 15 миллионов Echo, пользователи Echo, скорее всего, станут активными потребителями Amazon, используя устройство для отслеживания списков желаний и поиска товаров, которые им впоследствии предлагается купить. Между тем, Nest использует данные термостата в качестве платформы для предложения услуг по управлению энергопотреблением коммунальным компаниям в Соединенных Штатах, при этом компании платят за значимую и действенную информацию о клиентах по подписке.
Поскольку уже продано не менее 15 миллионов Echo, пользователи Echo, скорее всего, станут активными потребителями Amazon, используя устройство для отслеживания списков желаний и поиска товаров, которые им впоследствии предлагается купить. Между тем, Nest использует данные термостата в качестве платформы для предложения услуг по управлению энергопотреблением коммунальным компаниям в Соединенных Штатах, при этом компании платят за значимую и действенную информацию о клиентах по подписке.
Автомобильная промышленность
Согласно IC Insights, в период с 2016 по 2021 год продажи микросхем для автомобильных систем и Интернета вещей будут расти на 70% быстрее, чем общие доходы от IC.В частности, продажи интегральных схем для автомобилей и других транспортных средств, по прогнозам, вырастут с 22,9 млрд долларов в 2016 году до 42,9 млрд долларов в 2021 году, а доходы от функциональности Интернета вещей увеличатся с 18,4 млрд долларов в 2016 году до 34,2 млрд долларов в 2021 году.
Прогнозируемый рост продаж автомобильных микросхем неудивителен, поскольку современные автомобили по сути представляют собой сеть сетей, оснащенных рядом встроенных методов и возможностей связи. Однако это означает, что автомобили теперь более уязвимы для кибератак, чем когда-либо прежде.
Потенциальные уязвимости системы безопасности включают незащищенную связь между транспортными средствами, несанкционированный сбор информации о водителе или пассажирах, захват контроля над критически важными системами, такими как тормоза или акселераторы, перехват данных транспортного средства, взлом сторонних ключей и изменение чрезмерного обновления прошивки по воздуху (OTA). Что касается последнего, производители автомобилей сейчас сосредоточены на предоставлении безопасных OTA-обновлений для различных систем, при этом глобальный рынок автомобильных обновлений OTA, по прогнозам, будет расти со среднегодовым темпом роста 18.2% с 2017 по 2022 год и достигнет 3,89 миллиарда долларов к 2022 году.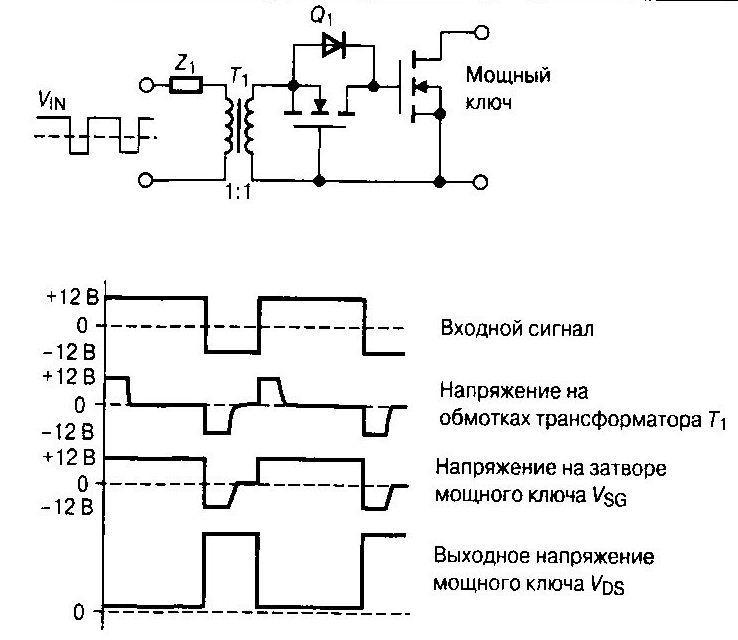
Производители автомобилей также работают над тем, чтобы в цепочке поставок транспортных средств не было украденных и поддельных компонентов. Тем не менее, широкий спектр устройств с серого рынка все еще можно найти для питания дорогостоящих модулей, таких как бортовые информационно-развлекательные системы и фары, а также в критических системах безопасности, включая модули подушек безопасности, тормозные модули и органы управления трансмиссией. Таким образом, защита периферийных устройств и компонентов транспортных средств от несанкционированного доступа путем внедрения ряда многоуровневых аппаратных и программных решений безопасности стала приоритетной задачей для ряда производителей автомобилей.
Помимо внедрения многоуровневых решений безопасности, полупроводниковая промышленность явно выиграет от внедрения подхода IoT «как услуга» в автомобильном секторе. Например, компании могут развернуть сенсорные автомобильные системы, которые заранее обнаруживают потенциальные проблемы и неисправности. Это решение, которое в наиболее оптимальной конфигурации сочетает в себе микросхемы и услуги, может быть продано как аппаратный и программный продукт или развернуто как услуга с ежемесячной или ежегодной абонентской платой.
Это решение, которое в наиболее оптимальной конфигурации сочетает в себе микросхемы и услуги, может быть продано как аппаратный и программный продукт или развернуто как услуга с ежемесячной или ежегодной абонентской платой.
Медицина и здравоохранение
Имплантированные медицинские устройства с длительным сроком службы, несомненно, потребуют от полупроводниковой промышленности высокой степени готовности к будущему, чтобы избежать частых физических обновлений и технического обслуживания. Срихари Яманур, специалист по дизайну в области исследований и разработок в Stellartech Research Corp., отмечает, что медицинские устройства в конечном итоге будут адаптированы для удовлетворения потребностей отдельных пациентов, что расширит применение точной медицины.
Кроме того, ожидается, что отрасль медицинского страхования будет использовать машинное обучение для оптимизации и снижения стоимости медицинского обслуживания, в то время как цифровые медицинские устройства также будут использоваться страховой отраслью для выявления пациентов из группы риска и оказания помощи. Поэтому медицинские устройства, особенно имплантируемые модели, должны быть спроектированы таким образом, чтобы поддерживать «модель перехода от кремния к услугам» с помощью конфигурации функций и безопасных обновлений OTA, а также услуг на основе PaaS, включая сбор и анализ соответствующих данных; проактивное обслуживание, продвинутые алгоритмы; и интуитивно понятный интерфейс как для пациентов, так и для врачей.
Поэтому медицинские устройства, особенно имплантируемые модели, должны быть спроектированы таким образом, чтобы поддерживать «модель перехода от кремния к услугам» с помощью конфигурации функций и безопасных обновлений OTA, а также услуг на основе PaaS, включая сбор и анализ соответствующих данных; проактивное обслуживание, продвинутые алгоритмы; и интуитивно понятный интерфейс как для пациентов, так и для врачей.
Аппаратное обеспечение с открытым исходным кодом и дезагрегированные чиплеты
Помимо услуг, оборудование с открытым исходным кодом, предлагаемое такими организациями и компаниями, как RISC-V и SiFive, начало положительно влиять на индустрию полупроводников, поощряя инновации, сокращая затраты на разработку и ускоряя вывод продуктов на рынок.
Успех программного обеспечения с открытым исходным кодом — в отличие от закрытого, огороженного сада — продолжает создавать важный прецедент для полупроводниковой промышленности. Столкнувшись с непомерно высокими затратами на разработку, ряд компаний предпочитают избегать ненужных сборщиков дорожных сборов, уделяя больше внимания архитектуре с открытым исходным кодом, поскольку они работают над созданием новых потоков доходов, ориентированных на услуги.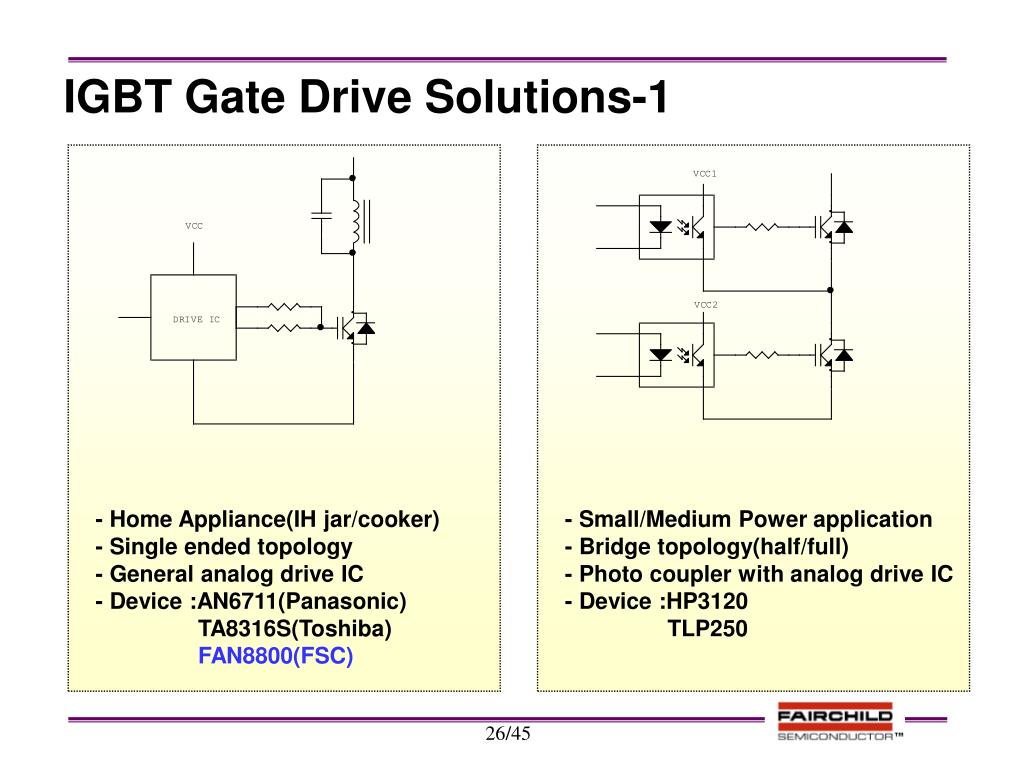
Помимо аппаратного обеспечения с открытым исходным кодом, концепция построения кремния из предварительно проверенных чиплетов начинает набирать обороты, поскольку полупроводниковая промышленность движется к снижению затрат и сокращению времени вывода на рынок гетерогенных конструкций.По словам Энн Стефора Мутчлер из Semiconductor Engineering, концепция чиплета некоторое время находилась в стадии разработки, хотя исторически она воспринималась как потенциальное направление будущего, а не реальное решение в тени убывающего закона Мура. Это восприятие начинает меняться по мере увеличения сложности конструкции, особенно в усовершенствованных узлах (10/7 нм), а также по мере объединения новых рынков, требующих частично настраиваемых решений.
Концепция предварительно проверенных чиплетов вызвала интерес U.Агентство перспективных исследовательских проектов S. Defense (DARPA), которое недавно развернуло свою программу общей гетерогенной интеграции и стратегии повторного использования IP (CHIPS). В сотрудничестве с полупроводниковой промышленностью успешная реализация CHIPS позволит увидеть ряд IP-блоков, подсистем и микросхем, объединенных на промежуточном устройстве в корпусе, подобном 2.5D.
В сотрудничестве с полупроводниковой промышленностью успешная реализация CHIPS позволит увидеть ряд IP-блоков, подсистем и микросхем, объединенных на промежуточном устройстве в корпусе, подобном 2.5D.
Инициатива CHIPS заняла центральное место в августе 2017 года, когда участники из военного, коммерческого и академического секторов собрались в штаб-квартире DARPA на официальном стартовом совещании по программе Агентства по стратегии общей гетерогенной интеграции и повторного использования интеллектуальной собственности (ИС).
Как сообщил на конференции д-р Дэниел Грин из DARPA, программа направлена на разработку новой технологической структуры, в которой различные функции и блоки интеллектуальной собственности, в том числе хранение данных, вычисления, обработка сигналов и управление формой и потоком данных — можно разделить на небольшие чиплеты. Затем их можно смешивать, сопоставлять и комбинировать на промежуточном элементе, что-то вроде соединения частей головоломки. Фактически, говорит Грин, вся обычная печатная плата с множеством различных, но полноразмерных микросхем в конечном итоге может быть уменьшена до гораздо меньшего промежуточного устройства, содержащего кучу гораздо меньших микросхем.
Фактически, говорит Грин, вся обычная печатная плата с множеством различных, но полноразмерных микросхем в конечном итоге может быть уменьшена до гораздо меньшего промежуточного устройства, содержащего кучу гораздо меньших микросхем.
Согласно DARPA, конкретные технологии, которые могут появиться в результате инициативы CHIPS, включают компактную замену целых печатных плат, сверхширокополосные радиочастотные (RF) системы и системы быстрого обучения для извлечения интересной и действенной информации из гораздо больших объемов обычных данных. .
Возможно, неудивительно, что полупроводниковая промышленность уже рассматривает дезагрегированный подход в форме микросхем SerDes и специализированных маломощных интерфейсов «кристалл-кристалл» для конкретных приложений.Безусловно, жизнеспособное разделение кремниевых компонентов может быть достигнуто путем перемещения высокоскоростных интерфейсов, таких как SerDes, на отдельные кристаллы в виде микросхем SerDes, смещения IP аналогового датчика на отдельные аналоговые микросхемы и реализации очень маломощной и малой задержки кристалла в die интерфейсы через MCM или через переходник с использованием технологии 2.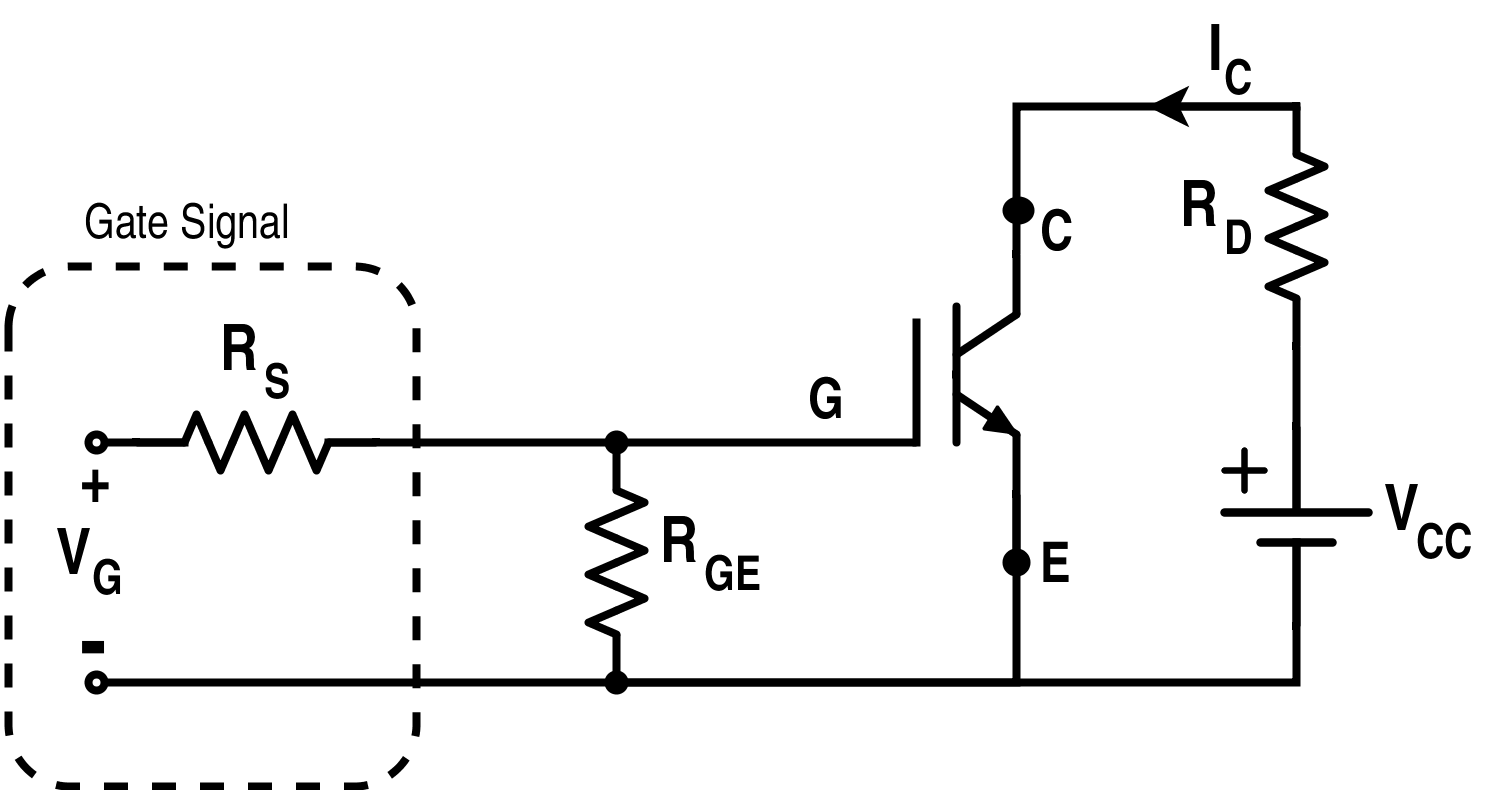 5D.
5D.
Помимо использования заведомо исправной матрицы для SerD в более зрелых узлах (N-1) или наоборот, ожидается, что дезагрегация упростит создание нескольких SKU, оптимизируя при этом затраты и снижая риски.Точнее, при дезагрегировании SoC будут разбиты на более высокопроизводительные и меньшие матрицы, что позволит компаниям создавать определенные конструкции с несколькими вариантами. Действительно, интерфейсы «от кристалла к кристаллу» могут более легко адаптироваться к различным приложениям в области памяти, логики и аналоговых технологий. Кроме того, интерфейсы «от кристалла к кристаллу» не требуют соответствующей скорости линии / передачи и количества полос, в то время как FEC может потребоваться или не потребоваться в зависимости от требований к задержке.
Следует отметить, что несколько компаний активно занимаются агрегацией SoC / ASIC для коммутаторов и других систем.Точно так же полупроводниковая промышленность разрабатывает ASIC с интерфейсами «кристалл-кристалл» на ведущих узлах FinFET, в то время как по крайней мере один серверный чип следующего поколения разрабатывается с дезагрегированным вводом-выводом на отдельном кристалле.
Заключение
За последние пять лет полупроводниковая промышленность столкнулась с множеством сложных проблем. К ним относятся увеличение затрат на разработку, размытие ASP, насыщение рынка и повышенная, но неустойчивая деятельность по слияниям и поглощениям. В течение 2018 года полупроводниковая промышленность продолжает стремиться к возвращению к стабильности и органическому росту в рамках параметров новой бизнес-парадигмы, одновременно жизнеспособной и основанной на сотрудничестве.В этом контексте компании, производящие полупроводники, осознают потенциал новых рынков и возможности получения доходов в нисходящем направлении, поскольку они исследуют более комплексную модель «от кремния к услугам», которая охватывает центр обработки данных и мобильную периферию.
Сюда входят решения для сквозной безопасности Интернета вещей и услуги на основе PaaS, такие как конфигурация функций на месте, расширенная аналитика, предупреждения о профилактическом обслуживании, алгоритмы самообучения и интеллектуальное проактивное взаимодействие с клиентами.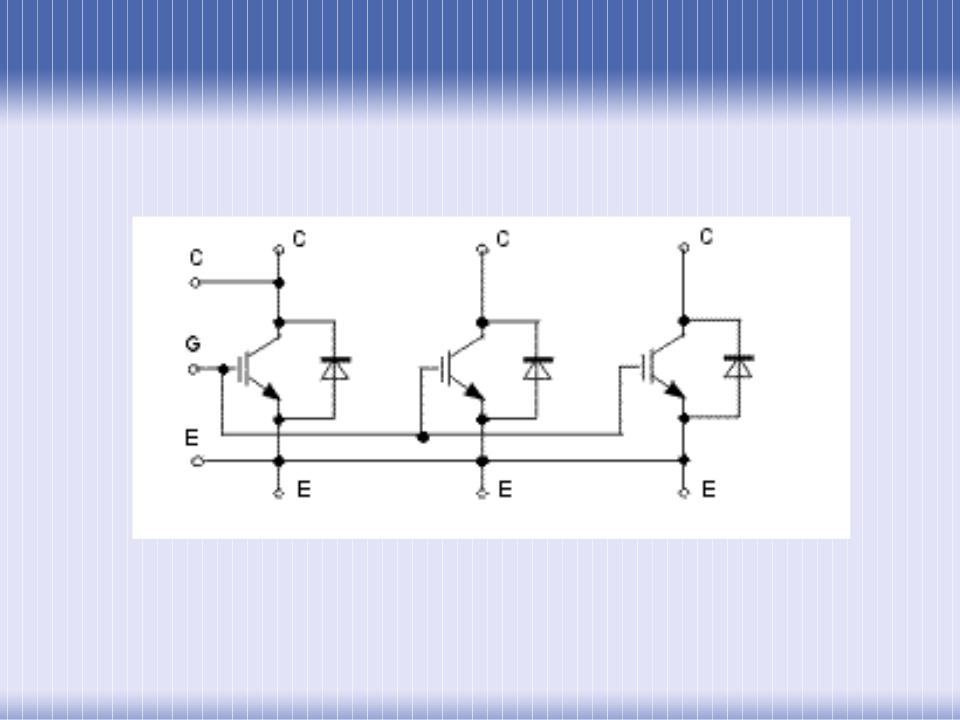 Помимо услуг, концепция оборудования с открытым исходным кодом и создание микросхем из разукрупненных, предварительно проверенных микросхем начинает набирать обороты по мере того, как компании сокращают расходы и сокращают время вывода на рынок гетерогенных конструкций.
Помимо услуг, концепция оборудования с открытым исходным кодом и создание микросхем из разукрупненных, предварительно проверенных микросхем начинает набирать обороты по мере того, как компании сокращают расходы и сокращают время вывода на рынок гетерогенных конструкций.
Конкретные стратегии раскрытия всего потенциала полупроводников, несомненно, будут различаться, поэтому для нас важно изучить будущее, в котором отрасль, наряду с различными исследовательскими организациями и государственными учреждениями, будет играть открытую и совместную роль, помогая устойчиво монетизировать и кремний, и сервисы.
Для получения дополнительной информации по этой теме посетите сайт Rambus.
Шрикант Лохокаре, доктор философии, является вице-президентом и исполнительным директором Global Semiconductor Alliance в Северной Америке.
Учебное пособие по схемам IGBT биполярного транзистора с изолированным затвором
Рис. 1
by Lewis Loflin
Недавно я обнаружил преимущества использования биполярных транзисторов с изолированным затвором (IGBT) по сравнению с MOSFET.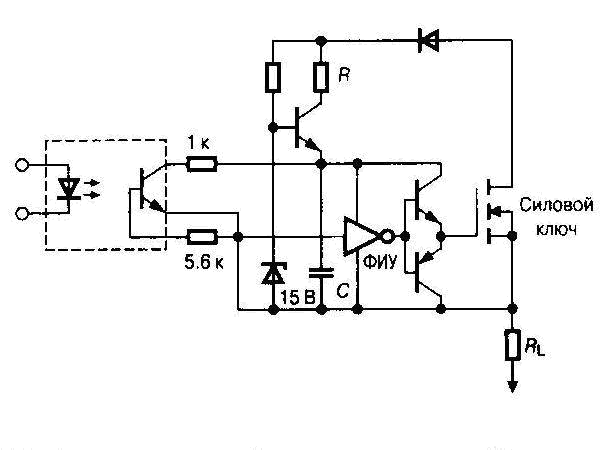 На самом деле у меня было несколько дней, оставшихся после ремонта плазменного резака, и я решил их использовать. Это особенно верно при использовании с оптопарами для фотоэлектрических МОП-транзисторов, таких как VOM1271.
На самом деле у меня было несколько дней, оставшихся после ремонта плазменного резака, и я решил их использовать. Это особенно верно при использовании с оптопарами для фотоэлектрических МОП-транзисторов, таких как VOM1271.
Процитируем два источника о преимуществах IGBT:
По сравнению с IGBT, силовой MOSFET имеет преимущества более высокой скорости коммутации и большей эффективности при работе при низких напряжениях…. IGBT сочетает в себе простые характеристики управления затвором, присущие полевому МОП-транзистору, с высокой силой тока и низким напряжением насыщения биполярного транзистора.
А:
Основными преимуществами использования биполярного транзистора с изолированным затвором по сравнению с другими типами транзисторных устройств являются его высокое напряжение, низкое сопротивление в открытом состоянии, простота управления, относительно быстрая скорость переключения и в сочетании с нулевым током управления затвором, что делает его хорошим выбором для умеренных скорость, приложения высокого напряжения. ..
..
Рис. 1 Основная теория построения IGBT в виде N-канального MOSFET и PNP-транзистора.
Рис. 2a
IXGh35N100 — это те, которые я использовал в своих тестовых схемах. Мои были спасены от платы инвертора плазменной резки, о которой я расскажу ниже.
Помимо высокого напряжения, некоторые из них имеют «максимальный номинальный ток коллектора Ic (макс.), Превышающий 100A».
Символ IGBT находится слева.
В IXGh35N100 нет внутренних диодов маховика.
Рис. 2b
На рис. 2b показан IGBT с внутренними диодами маховика. FGA25N120 рассчитан на 1200 В, 25 А. Напряжение C-E sat при 25 А составляет 2,0 В.
Важным фактором является напряжение насыщения коллектор-эмиттер. В цепях индукционного нагрева используются следующие элементы.
FGPF4633 рассчитан на 330 В, напряжение C-E 1,55 В при 70 А.
IHW20N120R3 1200 В 20 А 1,48 В.
Рис. 3
Пример схемы инвертора IGBT от 12 В до 120 В переменного тока.
Фиг.4
Инверторные аппараты плазменной резки
Раньше ремонтировал портативные плазменные резаки этого типа. Цитата из Википедии:
Плазменные резаки с инвертором
преобразуют сетевое питание в постоянный ток, который подается на высокочастотный транзисторный инвертор в диапазоне от 10 кГц до примерно 200 кГц. Более высокие частоты переключения позволяют использовать трансформатор меньшего размера, что приводит к уменьшению габаритов и веса.
Первоначально используемые транзисторы были полевыми МОП-транзисторами, но сейчас все чаще используются IGBT. При использовании параллельно подключенных полевых МОП-транзисторов, если один из транзисторов активируется преждевременно, это может привести к каскадному отказу одной четверти инвертора.Более позднее изобретение, IGBT, не подвержено этому виду отказа. IGBT обычно можно найти в сильноточных машинах, где невозможно параллельное соединение достаточного количества MOSFET-транзисторов.
Рис. 5
Рис. 5 использует IGBT для отключения 170 В постоянного тока для высокочастотного трансформатора. Это используется в микроволновых печах Panasonic.
Более высокая частота позволяет использовать меньшие (более дешевые) трансформаторы. Это также снижает вес. D701, D701, C703 и C704 образуют удвоитель напряжения.R701 — это высоковольтный резистор утечки.
Поскольку я мог использовать ту же установку для тестирования IGBT, что и n-канальные MOSFET, я протестировал те, что были у меня.
IGBT, по крайней мере, те, которые у меня есть, не должны использоваться, если это не цепь очень высокого напряжения. Они имеют высокое падение напряжения (Vce ~ 2 В) с низковольтными h-мостовыми схемами и лучше подходят для переключения на более высокое напряжение.
См. Тестовые силовые МОП-транзисторы, результаты IGBT, наблюдения
Вывод: IGBT не работают напрямую с 3.Микроконтроллеры 3В и 5В, такие как Arduino. Для включения требуется минимум 7 вольт. Высокое напряжение от 1,5 до 2 В может привести к потере энергии.
Высокое напряжение от 1,5 до 2 В может привести к потере энергии.
IGBT
отличаются от полевых МОП-транзисторов как положительным потоком, так и потоком электронов, который может передавать большую мощность даже при 2 В Vce на нагрузку. Они действительно предназначены для коммутации высокого напряжения.
| Устройство | * Vce | * Vce (sat) | * Ic | Ic 10V | Vce | |
| h30R1202 | 1200V | 1.48V | 20A | 3,41A | 1,96V | |
| IXGh35N100A | 1000V | 3,5V | 50A | 3,4A | ** 1,96V126 | ? | ? | 3.7A | 1.68V |
* из спецификации.
** данные не найдены.
Оптическая развязка управления двигателем H-моста YouTube
Оптическая изоляция элементов управления двигателем с Н-мостом
Теория оптопары и схемы YouTube
Драйверы оптоизолированных транзисторов для микроконтроллеров
All NPN Transistor H-Bridge Motor Control YouTube
Управление двигателем с Н-мостом на всех NPN транзисторах
Учебное пособие по широтно-импульсной модуляции YouTube
Учебное пособие по широтно-импульсной модуляции
PIC12F683 Микроконтроллер и схемы YouTube
PIC12F683 Микроконтроллер и схемы
Базовая структура
и ее преимущества
Биполярный транзистор с изолированным затвором
Термин IGBT — это сокращенная форма биполярного транзистора с изолированным затвором, это трехконтактное полупроводниковое устройство с огромной биполярной токоведущей способностью. Многие разработчики думают, что IGBT имеет биполярное устройство CMOS i / p и биполярное o / p, управляемое напряжением. Таким образом, это устройство спроектировано так, чтобы использовать преимущества как BJT, так и MOSFET устройств в виде монолита. Он сочетает в себе лучшие качества обоих для достижения характеристик оптимального устройства.
Многие разработчики думают, что IGBT имеет биполярное устройство CMOS i / p и биполярное o / p, управляемое напряжением. Таким образом, это устройство спроектировано так, чтобы использовать преимущества как BJT, так и MOSFET устройств в виде монолита. Он сочетает в себе лучшие качества обоих для достижения характеристик оптимального устройства.
Это устройство подходит для нескольких применений, таких как использование в силовой электронике, в частности, в ШИМ (широтно-импульсная модуляция), ИБП (источники бесперебойного питания), SMPS (импульсные источники питания) и других силовых цепях.Это увеличивает эффективность, динамические характеристики и снижает уровень слышимого шума. Он аналогичным образом устанавливается в цепи преобразователя резонансного режима. Оптимизированный IGBT доступен как для низких потерь переключения, так и для низких потерь проводимости.
Что такое IGBT?
IGBT (биполярный транзистор с изолированным затвором) — это трехконтактный электронный компонент, который называется эмиттером, коллектором и затвором. Два из его вывода, а именно коллектор и эмиттер, связаны с трактом проводимости, а оставшийся вывод «G» связан с его управлением.Сумма усиления, достигаемая IGBT, представляет собой соотношение между его входным и выходным сигналами. Для обычного BJT величина усиления почти равна отношению тока o / p к току i / p, которое называется бета-коэффициентом.
Два из его вывода, а именно коллектор и эмиттер, связаны с трактом проводимости, а оставшийся вывод «G» связан с его управлением.Сумма усиления, достигаемая IGBT, представляет собой соотношение между его входным и выходным сигналами. Для обычного BJT величина усиления почти равна отношению тока o / p к току i / p, которое называется бета-коэффициентом.
Символ IGBT
Для полевого МОП-транзистора (металлооксидного полупроводникового полевого транзистора) ток i / p отсутствует, поскольку вывод затвора изолирован от основного токоведущего канала. Таким образом, коэффициент усиления полевого транзистора равен коэффициенту усиления полевого транзистора, который равен отношению изменения тока o / p к изменению i / pv. Тогда IGBT можно рассматривать как силовой BJT, а базовый ток этого транзистора равен обеспечивается полевым МОП-транзистором.IGBT в основном используется в схемах усилителей слабого сигнала, таких как BJT или MOSFET. Когда транзистор объединяет более низкие потери проводимости BJT и MOSFET, получается идеальный твердотельный переключатель, который идеально подходит для различных приложений силовой электроники.
IGBT просто переключается в положение «ВКЛ» и «ВЫКЛ» путем срабатывания и отключения его клеммы Gate. Постоянный + Ve сигнал напряжения i / p на «G» и «E» будет удерживать устройство в состоянии «ON», в то время как вычитание сигнала i / p приведет к его выключению, как BJT или MOSFET. .
Базовая структура IGBT
Базовая структура N-канального IGBT показана ниже. Эта структура очевидна, поскольку поперечное сечение кремния IGBT почти такое же, как у вертикального силового MOSFET, за исключением инжекционного слоя P +. Он имеет ту же структуру MOS gate & P-wells с областями источника N +. В следующей структуре слой N + расположен вверху и называется источником, а нижний слой — стоком или коллектором.
Базовая структура N-канального БТИЗ
БТИЗ с паразитным тиристором включает в себя 4-слойные структуры NPN.Есть некоторые IGB, которые изготавливаются без буферного слоя N +, называемые NPT IGBTS без пробивки), тогда как некоторые IGBT изготавливаются с буферным слоем N +, называемые PT IGBT (punch through). Производительность устройства может значительно увеличиться за счет наличия буферного слоя. IGBT работает быстрее, чем силовой BJT, чем силовой MOSFET.
Производительность устройства может значительно увеличиться за счет наличия буферного слоя. IGBT работает быстрее, чем силовой BJT, чем силовой MOSFET.
Принципиальная схема IGBT
На основе базовой структуры IGBT можно нарисовать простую схему с использованием транзисторов PNP и NPN, JFET, OSFET, как показано на рисунке ниже.Коллекторный вывод NPN-транзистора соединен с базовым выводом PNP через JFET-транзистор. Эти транзисторы обозначают паразитный тиристор, который создает регенеративный контур обратной связи. Резистор RB означает короткое замыкание выводов база-эмиттер NPN-транзистора, чтобы гарантировать, что тиристор не защелкнется, что приведет к защелкиванию IGBT.
Принципиальная схема IGBT
JFET-транзистор означает построение тока b / n любых двух соседних ячеек IGBT.Он позволяет использовать полевой МОП-транзистор и поддерживает большую часть напряжения. Ниже показан символ схемы для IGBT, который состоит из трех выводов, а именно эмиттера, затвора и коллектора. Поведение при переключении IGBT
Поведение при переключении IGBT
Поведение при переключении IGBT
Эти устройства в основном используются в качестве переключателей, например, для преобразователей частоты и прерывателей, Вариант диода является наиболее важным, потому что, когда переключение IGBT выключено, ток определяется нагрузкой, которая во многих случаях является индуктивной.
При подключении соответствующих диодов допускается протекание тока. Когда этот транзистор снова включается, ток, протекающий в диоде, сначала работает как короткое замыкание. Напряжение можно заблокировать, сняв накопленное напряжение. Это выглядит как добавленный к току нагрузки избыточный ток, который называется током обратного восстановления диода «Irr». Максимальное значение Irr возникает (di / dt = 0), когда величина внезапных напряжений через IGBT и диод соответствует напряжению питания. Когда IGBT включен, ток изменяется, что приводит к возникновению точки перенапряжения за счет изменения тока в зависимых индуктивностях, согласующегося с ∆VCE = Lσ × di / d
NPT-IGBT и PT-IGBT
NPT и PT-IGBT разработаны IXYS Corporation.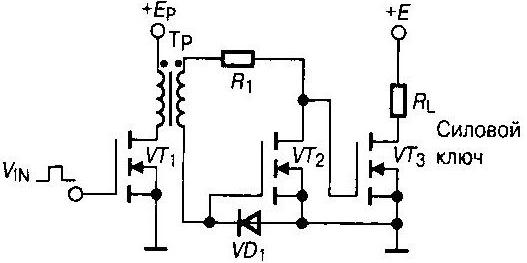 Физическая конструкция БТИЗ NPT и PT показана ниже. Структура PT состоит из дополнительного буферного слоя, который выполняет две функции, а именно: 1) Отказ можно избежать путем сквозного действия, так как этот слой контролирует расширение области истощения при приложенном высоком напряжении. 2) .Ток отказа может быть уменьшен, когда он отключается, и сокращает время спада IGBT, потому что отверстия вставляются коллектором P + не полностью рекомбинируют в этом слое.
Физическая конструкция БТИЗ NPT и PT показана ниже. Структура PT состоит из дополнительного буферного слоя, который выполняет две функции, а именно: 1) Отказ можно избежать путем сквозного действия, так как этот слой контролирует расширение области истощения при приложенном высоком напряжении. 2) .Ток отказа может быть уменьшен, когда он отключается, и сокращает время спада IGBT, потому что отверстия вставляются коллектором P + не полностью рекомбинируют в этом слое.
NPT-IGBT и PT-IGBT
Основы NPT-IGBT, IXYS Corporation 4 IXAN0063 и Abdus Sattar имеют одинаковое напряжение пробоя, и они применимы для приложений переменного тока.PT-IGBT имеют меньшее напряжение пробоя, и это актуально для цепей постоянного тока, где эти устройства не являются необходимыми для поддержки напряжения в обратном направлении.
Разница между NPT-IGBT и PT-IGBT
Это устройство, управляемое напряжением, и ему требуется небольшое напряжение на клемме затвора для поддержания проводимости через устройство.
Это однонаправленное устройство, потому что оно может изменять ток только в прямом направлении, то есть от коллектора к эмиттеру.
Разница между NPT-IGBT и PT-IGBT
Принцип работы BJT очень похож на N-канальный MOSFET.Основное отличие состоит в том, что ток, существующий в проводящем канале, когда ток подается через устройство в его состоянии включения, очень мал в IGBT, по этой причине номинальные токи высоки при согласовании с MOSFET.
Преимущества и недостатки IGBT
Основными преимуществами IGBT по сравнению с различными типами транзисторов являются низкое сопротивление в открытом состоянии, высокая емкость по напряжению, высокая скорость переключения, простота управления и соединение с нулевым током управления затвором, что создает хороший вариант для разумного скорость и различные высоковольтные приложения, такие как PWM, SMPS, регулировка скорости, преобразователь переменного тока в постоянный, питаемый от солнечной батареи, и приложения преобразователя частоты, работающие с сотнями кГц.
Основные недостатки: Скорость переключения ниже для Power MOSFET и выше для BJT. Коллекторный ток, следующий из-за неосновных носителей заряда, приводит к низкой скорости выключения. 2. Существует вероятность защелкивания из-за внутренней структуры тиристора PNPN.
Таким образом, речь идет о работе IGBT и приложениях IGBT. Мы заметили, что IGBT — это полупроводниковое переключающее устройство, которое имеет характеристику o / p, как у BJT, но управляется как MOSFET.Мы уверены, что вы лучше понимаете эту концепцию. Кроме того, любые сомнения относительно приложений IGBT или электрических и электронных проектов, пожалуйста, дайте свой отзыв, комментируя в разделе комментариев ниже. Вот вам вопрос, в чем разница между BJT, MOSFET и IGBT?
Авторы фото:
Биполярный транзистор с изолированным затвором | IGBT
IGBT — относительно новое устройство в силовой электронике, и до появления IGBT силовые MOSFET и Power BJT широко использовались в силовых электронных устройствах. Оба эти устройства обладали рядом достоинств и недостатков. С одной стороны, у нас были плохие характеристики переключения, низкий входной импеданс, вторичный пробой и управляемый током Power BJT, а с другой — отличные характеристики проводимости. Точно так же у нас были отличные характеристики переключения, высокий входной импеданс, PMOSFET, управляемые напряжением, которые также имели плохие характеристики проводимости и проблемные паразитные диоды при более высоких номиналах. Хотя униполярный характер PMOSFET приводит к малому времени переключения, он также приводит к высокому сопротивлению в открытом состоянии при увеличении номинального напряжения.
Оба эти устройства обладали рядом достоинств и недостатков. С одной стороны, у нас были плохие характеристики переключения, низкий входной импеданс, вторичный пробой и управляемый током Power BJT, а с другой — отличные характеристики проводимости. Точно так же у нас были отличные характеристики переключения, высокий входной импеданс, PMOSFET, управляемые напряжением, которые также имели плохие характеристики проводимости и проблемные паразитные диоды при более высоких номиналах. Хотя униполярный характер PMOSFET приводит к малому времени переключения, он также приводит к высокому сопротивлению в открытом состоянии при увеличении номинального напряжения.
Таким образом, возникла потребность в таком устройстве, которое обладало бы достоинствами как PMOSFET, так и Power BJT, и именно тогда IGBT был представлен примерно в начале 1980-х годов и стал очень популярным среди инженеров силовой электроники из-за своих превосходных характеристик. IGBT имеет PMOSFET, как входные характеристики, и Power BJT, как выходные характеристики, поэтому его символ также является объединением символов двух родительских устройств.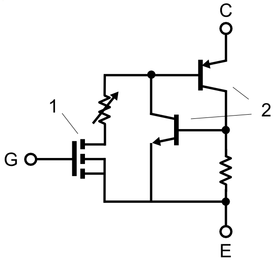 Три терминала IGBT — это затвор, коллектор и эмиттер. На рисунке ниже показан символ IGBT.
Три терминала IGBT — это затвор, коллектор и эмиттер. На рисунке ниже показан символ IGBT.
БТИЗ
известен также под различными другими названиями, такими как Металлооксидный транзистор с изолированным затвором (MOSIGT), полевой транзистор с модуляцией усиления (GEMFET), полевой транзистор с кондуктивной модуляцией (COMFET), транзистор с изолированным затвором (IGT).
Структура IGBT
Структура IGBT очень похожа на структуру PMOSFET, за исключением одного слоя, известного как инжекционный слой, который является p + в отличие от подложки n + в PMOSFET. Этот слой инжекции является ключом к превосходным характеристикам IGBT.Остальные слои называются дрейфом и областью тела. Два соединения имеют маркировку J 1 и J 2 . На рисунке ниже показана структура n-канального IGBT.
При внимательном рассмотрении структуры мы обнаружим, что существует n-канальный полевой МОП-транзистор и два BJT-транзистора — Q 1 и Q 2 , как показано на рисунке.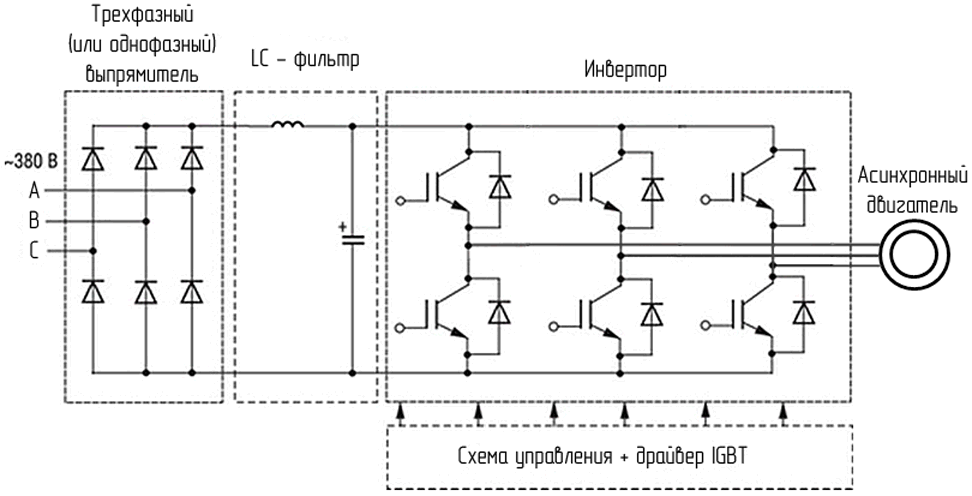 Q 1 — это p + n — p BJT, а Q 2 — n — pn + BJT. R d — это сопротивление области дрейфа, а R b — сопротивление области p тела.Мы можем заметить, что коллектор Q 1 такой же, как база Q 2 , а коллектор Q 2 такой же, как база Q 1 . Следовательно, мы можем прийти к модели эквивалентной схемы IGBT, как показано на рисунке ниже.
Q 1 — это p + n — p BJT, а Q 2 — n — pn + BJT. R d — это сопротивление области дрейфа, а R b — сопротивление области p тела.Мы можем заметить, что коллектор Q 1 такой же, как база Q 2 , а коллектор Q 2 такой же, как база Q 1 . Следовательно, мы можем прийти к модели эквивалентной схемы IGBT, как показано на рисунке ниже.
Два транзистора, соединенные задними сторонами друг к другу, образуют паразитный тиристор, как показано на рисунке выше.
N-канальный IGBT включается, когда коллектор находится под положительным потенциалом по отношению к эмиттеру и затвору, а также с достаточным положительным потенциалом (> V GET ) по отношению к излучаемому.Это условие приводит к образованию инверсионного слоя непосредственно под затвором, что приводит к образованию канала, и ток начинает течь от коллектора к эмиттеру.
Коллекторный ток I c в IGBT состоит из двух компонентов — I e и I h . I e — ток из-за инжектированных электронов, протекающих от коллектора к эмиттеру через инжекционный слой, дрейфовый слой и, наконец, сформированный канал. I h — это дырочный ток, текущий от коллектора к эмиттеру через Q 1 и сопротивление тела R b .Следовательно,
, хотя I h почти несущественно и, следовательно, I c ≈ I e .
В IGBT наблюдается своеобразное явление, известное как фиксация IGBT. Это происходит, когда ток коллектора превышает определенное пороговое значение (I CE ). При этом паразитный тиристор защелкивается, и вывод затвора теряет контроль над током коллектора, и IGBT не выключается, даже когда потенциал затвора снижается ниже V GET . Теперь для отключения IGBT нам понадобится типовая схема коммутации, как и в случае принудительной коммутации тиристоров. Если устройство не выключить как можно скорее, оно может быть повреждено.
Если устройство не выключить как можно скорее, оно может быть повреждено.
Характеристики IGBT
Статические I-V характеристики IGBT
На рисунке ниже показаны статические i-v характеристики n-канального IGBT вместе с принципиальной схемой с отмеченными параметрами.
График аналогичен графику BJT, за исключением того, что параметр, который сохраняется постоянным для графика, составляет V GE , поскольку IGBT — это устройство, управляемое напряжением, в отличие от BJT, которое является устройством, управляемым током.Когда устройство находится в режиме ВЫКЛ (V CE положительный и V GE
Передаточные характеристики IGBT
На рисунке ниже показана передаточная характеристика IGBT, которая в точности совпадает с PMOSFET. IGBT находится во включенном состоянии только после того, как V GE превышает пороговое значение V GET .
IGBT находится во включенном состоянии только после того, как V GE превышает пороговое значение V GET .
Характеристики переключения IGBT
На рисунке ниже показана типичная характеристика переключения IGBT .
Время включения t на , как обычно, состоит из двух составляющих: времени задержки (t dn ) и времени нарастания (t r ). Время задержки определяется как время, за которое ток коллектора увеличивается с тока утечки I CE до 0,1 I C (конечный ток коллектора), а напряжение коллектора-эмиттера падает с CE до 0.9 В CE . Время нарастания определяется как время, за которое ток коллектора повышается с 0,1 I C до I C , а напряжение коллектора-эмиттера падает с 0,9 В CE до 0,1 В CE .
Время выключения t off состоит из трех компонентов: времени задержки (t df ), времени начального спада (t f1 ) и времени окончательного спада (t f2 ). Время задержки определяется как время, когда ток коллектора падает с I C до 0,9 I C , а V CE начинает расти.Время начального спада — это время, в течение которого ток коллектора падает с 0,9 I C до 0,2 I C , а напряжение коллектора-эмиттера повышается до 0,1 В CE . Окончательное время спада определяется как время, в течение которого ток коллектора падает с 0,2 I C до 0,1 I C и 0,1 В CE повышается до конечного значения V CE .
Время задержки определяется как время, когда ток коллектора падает с I C до 0,9 I C , а V CE начинает расти.Время начального спада — это время, в течение которого ток коллектора падает с 0,9 I C до 0,2 I C , а напряжение коллектора-эмиттера повышается до 0,1 В CE . Окончательное время спада определяется как время, в течение которого ток коллектора падает с 0,2 I C до 0,1 I C и 0,1 В CE повышается до конечного значения V CE .
Преимущества и недостатки IGBT
Преимущества: —
Преимущества IGBT показаны ниже
- Требования к низкому приводу затвора
- Низкие коммутационные потери
- Требования к демпфирующей цепи с малым сопротивлением
- Устройство с высоким входным сопротивлением
- Температурный коэффициент сопротивления включенного состояния положительный и меньше, чем у PMOSFET, следовательно, меньше падение напряжения во включенном состоянии и потери мощности.

- Повышенная проводимость из-за биполярного характера
- Лучшая безопасная рабочая зона
Недостатки: —
Недостатки IGBT проявляются ниже
- Стоимость
- Проблема фиксации
- Высокое время отключения
PMOS по сравнению с
Характеристики биполярного транзистора с изолированным затвором
Термин IGBT означает полупроводниковый прибор, а аббревиатура IGBT — биполярный транзистор с изолированным затвором. Он состоит из трех выводов с широким диапазоном допустимых значений биполярного тока.Разработчики IGBT считают, что это биполярное устройство, управляемое напряжением, с входом CMOS и биполярным выходом. Конструкция IGBT может быть выполнена с использованием обоих устройств, таких как BJT и MOSFET, в монолитной форме. Он сочетает в себе лучшие качества обоих для достижения оптимальных характеристик устройства. Применения биполярного транзистора с изолированным затвором включают силовые цепи, широтно-импульсную модуляцию, силовую электронику, источники бесперебойного питания и многое другое.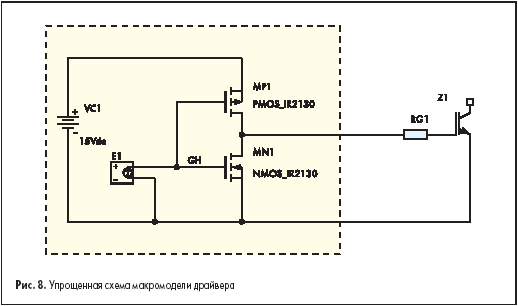 Это устройство используется для повышения производительности, эффективности и снижения уровня слышимого шума.Он также фиксируется в схемах резонансного преобразователя. Оптимизированный биполярный транзистор с изолированным затвором доступен как для низких потерь проводимости, так и для коммутации.
Это устройство используется для повышения производительности, эффективности и снижения уровня слышимого шума.Он также фиксируется в схемах резонансного преобразователя. Оптимизированный биполярный транзистор с изолированным затвором доступен как для низких потерь проводимости, так и для коммутации.
Биполярный транзистор с изолированным затвором
Биполярный транзистор с изолированным затвором
Биполярный транзистор с изолированным затвором представляет собой трехполюсное полупроводниковое устройство, и эти выводы называются затвором, эмиттером и коллектором. Эмиттерные и коллекторные клеммы IGBT связаны с трактом проводимости, а клемма затвора связана с его управлением.Расчет усиления достигается за счет IGBT — радио, b / n его i / p и o / p сигнала. Для обычного BJT сумма коэффициентов усиления почти эквивалентна выходному току и входному току, что называется бета. Биполярные транзисторы с изолированным затвором в основном используются в схемах усилителя, таких как полевые МОП-транзисторы или биполярные транзисторы.
Устройство IGBT
IGBT в основном используется в схемах усилителей малых сигналов, таких как BJT или MOSFET. Когда транзистор объединяет более низкие потери проводимости схемы усилителя, получается идеальный твердотельный переключатель, который идеально подходит для многих приложений силовой электроники.
IGBT просто включается и выключается путем активации и деактивации его клеммы Gate. Постоянное напряжение + Ve i / p сигнал на клеммах затвора и эмиттера будет поддерживать устройство в активном состоянии, в то время как предположение о входном сигнале заставит его выключиться, как в BJT или MOSFET.
Базовая конструкция IGBT
Базовая конструкция N-канального IGBT приведена ниже. Структура этого устройства проста, а секция Si IGBT почти аналогична вертикальной силовой части MOSFET, за исключением инжектирующего слоя P +.Он имеет такую же структуру, как затвор и P-колодцы из оксида металла и полупроводника через области источника N +. В следующей конструкции слой N + состоит из четырех слоев, которые расположены вверху и называется источником, а самый нижний слой — коллектором или стоком.
Базовая конструкция IGBT
Существует два типа IGBT, а именно: IGBT без пробивки (NPT IGBTS) и с пробивкой через IGBT (PT IGBT). Эти два IGBT определены как: когда IGBT разработан с буферным слоем N +, он называется PT IGBT, аналогично, когда IGBT разработан без буферного слоя N +, называется NPT IGBT.Производительность IGBT может быть увеличена за счет наличия буферного уровня. БТИЗ работает быстрее, чем силовой биполярный транзистор и силовой полевой МОП-транзистор.
Принципиальная схема IGBT
На основе базовой конструкции биполярного транзистора с изолированным затвором разработана простая схема драйвера IGBT с использованием транзисторов PNP и NPN, JFET, OSFET, которые показаны на рисунке ниже. JFET-транзистор используется для подключения коллектора NPN-транзистора к базе PNP-транзистора.Эти транзисторы указывают паразитный тиристор на создание петли отрицательной обратной связи.
Принципиальная схема IGBT
Резистор RB указывает контакты BE транзистора NPN, чтобы подтвердить, что тиристор не фиксируется, что приведет к фиксации IGBT. Транзистор обозначает структуру тока между любыми двумя соседними ячейками IGBT. Он позволяет использовать полевой МОП-транзистор и поддерживает большую часть напряжения. Обозначение схемы IGBT показано ниже, которая содержит три клеммы, а именно эмиттер, затвор и коллектор.
Транзистор обозначает структуру тока между любыми двумя соседними ячейками IGBT. Он позволяет использовать полевой МОП-транзистор и поддерживает большую часть напряжения. Обозначение схемы IGBT показано ниже, которая содержит три клеммы, а именно эмиттер, затвор и коллектор.
Характеристики IGBT
Биполярный транзистор с индукционным затвором — это устройство, управляемое напряжением, ему требуется только небольшое напряжение на выводе затвора для продолжения проводимости через устройство
Характеристики IGBT
Поскольку IGBT является устройством, управляемым напряжением, он требуется только небольшое напряжение на затворе для поддержания проводимости через устройство, в отличие от BJT, которым требуется, чтобы базовый ток всегда подавался в достаточном количестве для поддержания насыщения.
IGBT может переключать ток в однонаправленном, то есть в прямом направлении (от коллектора к эмиттеру), тогда как MOSFET может переключать ток в двух направлениях. Потому что он управлял только в прямом направлении.

 Влияние напряжения управления и сопротивления затвора на основные характеристики MOSFET/IGBT
Влияние напряжения управления и сопротивления затвора на основные характеристики MOSFET/IGBT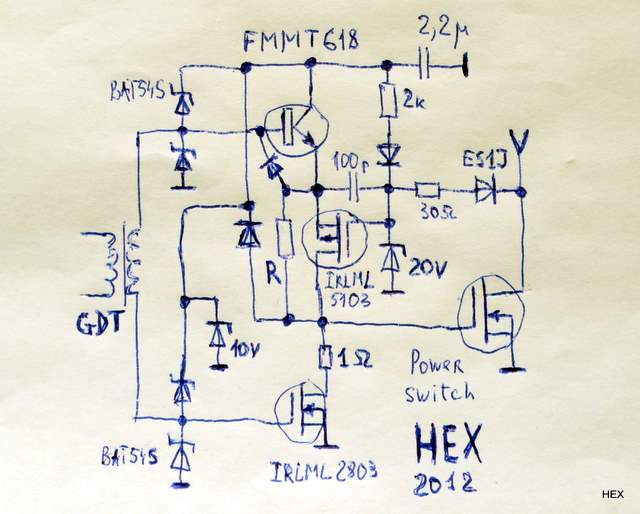
 Paralleling of Chips — From the Classiacl «Worst Case» Consideration to a Statistical Approach // PCIM Europe 2005. Conference Proceedings.
Paralleling of Chips — From the Classiacl «Worst Case» Consideration to a Statistical Approach // PCIM Europe 2005. Conference Proceedings.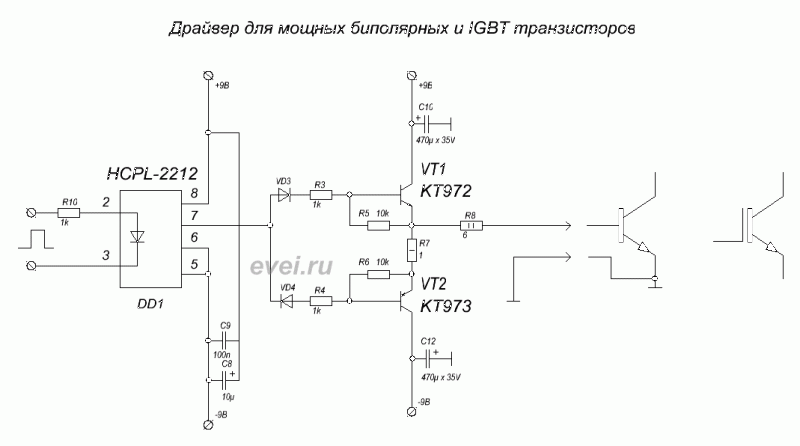 2
2 3 Схема питания верхнего плеча инвертора
3 Схема питания верхнего плеча инвертора
 – М.: Изд. дом «Додека – ХХI», 2002.
– М.: Изд. дом «Додека – ХХI», 2002.

