ВОЛЬТ-АМПЕРНЫЕ ХАРАКТЕРИСТИКИ ПОЛЕВЫХ ТРАНЗИСТОРОВ
Ток стока ПТ зависит как от значения, так и от полярности напряжений сток — исток и затвор — исток. При постоянном смещении на затворе увеличение напряжения на стоке от нуля вызывает резкое возрастание тока стока, которое продолжается до наступления насыщения тока стока. Затем ток устанавливается и остаётся относительно постоянным. Эта зависимость показана на рис. 3, а для типичного полевого прибора с p-n-переходом. Для сравнения на рис. 3, б приведены коллекторные характеристики биполярного транзистора.
Характеристики транзисторов обоих видов похожи друг на друга, за исключением того, что у биполярного транзистора перегиб характеристик происходит при значительно более низких напряжениях на коллекторе.
На выходной характеристике ПТ можно выделить две характерные области (рис. 4). При малых напряжениях сток — исток (область АВ) сопротивление канала имеет омический характер, и ток может протекать в обоих направлениях. В этом состоит отличие полевых транзисторов от электронных ламп, в которых поток электронов всегда имеет одно направление — от катода к аноду. Рабочая область АВ выходной характеристики ПТ используется в том случае, когда полевой транзистор применяется в схеме в качестве переменного сопротивления, управляемого напряжением (аттенюаторы, регуляторы АРУ).
В этом состоит отличие полевых транзисторов от электронных ламп, в которых поток электронов всегда имеет одно направление — от катода к аноду. Рабочая область АВ выходной характеристики ПТ используется в том случае, когда полевой транзистор применяется в схеме в качестве переменного сопротивления, управляемого напряжением (аттенюаторы, регуляторы АРУ).
Рис. 3. Выходные характеристики транзисторов, а — ПТ с p-n-переходом; б — биполярного транзистора.
В области насыщения тока (область ВС на рис. 4) часть канала обеднена носителями заряда из-за влияния электрического поля между затвором и каналом, благодаря чему сопротивление канала становится значительным. Дальнейшее увеличение напряжения между стоком и истоком в этой области вызывает относительно небольшое изменение тока стока, который практически будет зависеть только от напряжения на затворе [1].
Рис. 4. Выходная характеристика ПТ при Uз.и=0
Характерной особенностью полевых транзисторов является то, что напряжение, соответствующее точке B характеристики (точка перегиба характеристики на рис. 4, после которой идёт область насыщения), при напряжении на затворе, равном нулю, численно равно напряжению отсечки и называется напряжением насыщения.
4, после которой идёт область насыщения), при напряжении на затворе, равном нулю, численно равно напряжению отсечки и называется напряжением насыщения.
Входные характеристики полевого транзистора существенно отличаются от характеристик биполярного транзистора. Входные характеристики последнего подобны характеристикам открытого полупроводникового диода, в то время как у полевого транзистора они подобны характеристикам запертого диода (смещённого в обратном направлении). Поэтому ток затвора очень мал. Он равен нескольким наноамперам (для ПТ с управляющим p-n-переходом) при температуре 25°С и экспоненциально зависит от температуры.
Рис. 5. Проходные характеристики ПТ при различной температуре.
Проходная характеристика, показывающая зависимость тока стока от напряжения на затворе, изображена на рис. 5. С достаточной для практических расчётов точностью проходная характеристика полевого транзистора определяется выражением (1), т. е. носит квадратичный характер. Эта особенность проходной характеристики используется в преобразователях частоты для уменьшения перекрёстной модуляции и помех от гармоник гетеродина.
Эта особенность проходной характеристики используется в преобразователях частоты для уменьшения перекрёстной модуляции и помех от гармоник гетеродина.
PREV CONTEXT NEXT
Как проверить полевой транзистор и снять его основные характеристики
Простое универсальное устройство для измерения параметров JFET-транзисторов
со встроенным p-n переходом обеднённого типа и
MOSFET-транзисторов обогащён-
ного типа.
В последнее время в радиолюбительской практике всё чаще встречаются устройства, построенные на полевых транзисторах.
Причиной этого является ряд полезных качеств полевиков, таких как: высокое входное сопротивление, низкий уровень собственных шумов,
малая проходная ёмкость, высокая температурная стабильность и т. д. и т. п.
Казалось бы — вот оно счастье! Ан нет — главным ограничением при использовании любых полевых транзисторов является разброс
параметров. Эти параметры индивидуальны для каждого конкретного экземпляра и могут существенно различаться даже у однотипных
Эти параметры индивидуальны для каждого конкретного экземпляра и могут существенно различаться даже у однотипных
полевых транзисторов из одной партии.
В разных источниках можно найти всевозможные описания измерителий параметров ПТ, но они либо сложны, либо представляют
собой простейшие тестеры для определения начального тока стока и напряжения отсечки.
Предлагаемый к рассмотрению довольно простой прибор позволяет измерять величину напряжения затвор-исток при различных (задаваемых)
токах стока.
Это даёт возможность не только сразу и точно рассчитать номиналы резисторов, задающих режим работы каскада, но и снять
вольт-амперные характеристики полупроводника, а при выполнении пары простейших манипуляций с калькулятором — вычислить крутизну
передаточной характеристики.
Объектами для снятия характеристик могут быть как JFET-транзисторы со встроенным p-n переходом, так и MOSFET транзисторы обогащённого типа.
Параметры считываются при помощи внешнего вольтметра или мультиметра (наличие которого предполагается у каждого радиолюбителя)
в количестве — одна штука.
Рис.1 Схема устройства для измерения характеристик полевых транзисторов
Представленный на Рис.1 измерительный прибор довольно универсален и адаптирован для работы с любыми полевыми транзисторами, для которых
необходимо как положительное смещение затвора относительно истока, так и отрицательное.
С учётом различной проводимости ПТ таких типов полупроводников набралось 4 штуки: JFET n-типа, JFET p-типа, MOSFET n-типа и
MOSFET p-типа.
Для того, чтобы избежать обустройства сложной коммутации в устройстве было решено под каждый вид полевика использовать
отдельные клеммы подключения.
По большому счёту, схема представляет собой линейный стабилизатор тока.
Токовым датчиком здесь является пара резисторов R3, R5 (или R4, R6), суммарное сопротивление которой рассчитывается исходя из формулы
R ≈ 0,6/Iнагр .
При увеличении тока через испытуемый ПТ падение напряжения на датчике растёт. При достижении им значения 0,6В транзистор T2 начинает
открываться,
уровень напряжения на затворе ПТ падает, ток уменьшается. Таким образом происходит стабилизация Iс полевого транзистора.
Поскольку для нормальной работы n-канального JFET транзистора значение Uзи должно находиться в отрицательной области, напряжение на его
истоке зафиксировано на уровне 5,2В посредством делителя R1, R2 и эмиттерного повторителя Т1.
Для n-канального MOSFET транзистора значение Uзи должно находиться в положительной области, поэтому его исток посажен на землю.
Для р-канальных транзисторов всё происходит аналогичным образом, но с обратной полярностью, для чего схема управления на транзисторах Т3 и Т4
перевёрнута относительно питания и земли.
Как было сказано, регулировка тока стока тестируемого транзистора задаётся изменением величины сопротивления токового датчика.
Для удобства пользования прибором весь диапазон регулировки тока разбит на 2 поддиапазона: 0,2…3мА и 2…35мА.
Для того чтобы избежать необходимости использования дополнительного измерительного прибора, потенциометры следует снабдить шкалой
и проградуировать. Ввиду того, что далеко не каждый JFET транзистор в состоянии выдать ток истока — 35мА, градуировку лучше выполнять с
каким-нибудь не сильно мощным MOSFET транзистором, например, из серии 2N7000 — 2N7002.
Тут всё просто. Установив полевой транзистор — в разрыв между стоком и плюсом источника питания временно включить амперметр и нанести
на шкалу резисторов отметки, соответствующие показаниям прибора в обоих поддиапазонах изменения тока.
Как пользоваться прибором?
1. Начальный ток стока полевого транзистора (только для JFET-ов) — это ток стока при Uзи = 0.
Крутим потенциометр, пока вольтметр не покажет Uзи = 0В. Показания на шкале потенциометра и будут являться искомым значением
начального тока стока.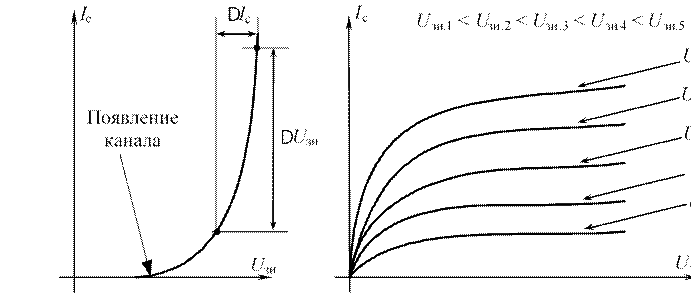
В принципе этот параметр имеет практический смысл только при расчёте каскадов с общим истоком, в которых исток без резистора
посажен напрямую на землю (или шину питания для р-типа).
2. Напряжения отсечки полевого транзистора — это напряжение между затвором и истоком, при котором ток
стока достигает заданного низкого значения (10мкА…1мА).
Параметр для аналоговой электроники мало информативный, а для switch MOSFET-ов задаётся при токе 250мкА и выше — поэтому 200мкА,
выдаваемые прибором для измерения Uзи_отс, вполне достаточны для практического использования.
3. Напряжения Uзи при заданном токе стока — это главный параметр для расчёта усилительного каскада на полевом
транзисторе.
Критериев выбора значения тока стока может быть множество, как с точки зрения достижений необходимой нагрузочной способности,
так и других факторов, таких как: быстродействие, шумовые характеристики, энергопотребление, стабильность параметров и т. д.
д.
Исходя из этих критериев, разработчик, как правило, заранее знает при каком токе будет работать тот или иной каскад на ПТ.
Поэтому и тут всё очень просто: устанавливаем потенциометром необходимый ток стока и измеряем вольтметром Uзи.
Как дальше (с учётом снятых параметров) рассчитать элементы каскадов на полевых транзисторах мы подробно рассмотрели на страницах
ссылка на страницу 1 и ссылка на страницу 2.
4. Крутизна передаточной характеристики — немаловажный параметр для расчёта коэффициента усиления каскада на
полевом транзисторе.
Поскольку существует довольно сильная зависимость крутизны от начального тока стока транзистора, то и измерять её надо в
непосредственной близи от заданного тока стока.
Предположим, что каскад будет работать при токе Iс=2мА. Тогда измерения напряжений Uзи можно провести при токах 1,5 и 2,5 мА, а
значение крутизны вычислить по формуле
S = ΔIc/ΔUзи (мА/В).
Расчёт усилительных каскадов на полевых MOSFET транзисторах
Как просто рассчитать режимы работы и номиналы элементов схем на полевых
MOSFET транзисторах обогащённого типа.
Онлайн калькулятор.
На предыдущей странице мы с вами рассмотрели методику по расчёту режимов работы и номиналов элементов схем каскадов на полевых
транзисторах. Процедура расчёта достаточно проста и не подразумевает необходимости построения нагрузочных линий, как это рекомендуется
при процессе проектирования усилительных каскадов в любой радиотехнической литературе.
В качестве примера был выбран распространённый JFET-транзистор 2SK117 со встроенным p-n переходом обеднённого типа.
По большому счёту, расчёт каскадов, выполненных на MOSFET транзисторах обогащённого типа, ничем не отличается от процедуры
расчёта для JFET-транзисторов, однако, учитывая то, что стоково-затворная ВАХ JFET-ов находится в отрицательной области
напряжений Uзи, а MOSFET-ов смещена в положительную — могут возникнуть определённые вопросы.
В качестве пациента для расчётов выберем N-Channel MOSFET 2N7002, который, строго говоря, был спроектирован для работы в ключевых
устройствах, однако, наряду с 2N7000, довольно часто применяется радиолюбителями в усилительных каскадах радиочастотного диапазона.
Итак, определимся с вводными:
напряжение питания
Еп = 12В, ток покоя стока транзистора
Iс = 10мА, коэффициент усиления по напряжению
Кu = 10.
Далее всё по накатанной: вольт-амперная характеристика 2N7002 из Datasheet-а и схема каскада с общим истоком.
Рис.1 Стоково-затворная ВАХ транзистора 2N7002 и схема каскада с общим истоком
Поскольку ключевые транзисторы даже малой мощности могут работать при значительных величинах импульсных токов, их вольт-амперные
характеристики для наших аналоговых целей имеют явно избыточный размах. Однако приблизительно оценить интересующие нас значения
мы всё ж таки сумеем.
1. Линия, пересекающая на ВАХ точку, равную току истока Iс = 10 mA, приблизительно соответсвует напряжению
Uзи ≈ 2,6В.
2. Опять же, очень приблизительно давайте оценим параметр крутизны передаточной характеристики транзистора вблизи интересующего нас
тока стока:
S = ΔIc/ΔUзи = (75-10)мА / (3-2,6)В = 162 мА/В.
Поскольку при расчёте (в связи с мелкостью масштаба в районе Iс = 10 mA) нам пришлось залезть в область значительно более
высоких токов, то реальный показатель крутизны окажется раза в 1,5 ниже расчётного значения. Лучше бы эту поправку учесть — но мы не будем,
для того, чтобы наглядно продемонстрировать, что даже такие существенные расхождения не сильно повлияют на работоспособность рассчитанной
схемы.
3. Перенесём сюда формулы с предыдущей страницы и добавим пару новых:
Кu = Rc*S/(1 +Rи*S) ;
Uc = (Eп + Uи)/2 ;
Rc = (Eп — Uс)/Iс ;
Uи = Есм — Uзи ;
Rи = Uи/Ic .
Объединив данные формулы, можно рассчитать номиналы всех элементов, ну а поскольку итоговые выражения получаются довольно
громоздкими, то, я думаю, мало кто обидится, если я сразу приведу онлайн калькулятор.
КАЛЬКУЛЯТОР РАСЧЁТА ЭЛЕМЕТОВ КАСКАДОВ ОИ НА ПОЛЕВЫХ MOSFET ТРАНЗИСТОРАХ.
А теперь так же, как на предыдущей странице давайте проверим полученные расчёты в симуляторе.
Некоторая разница между показаниями вольтметров симулятора и значениями результатов расчёта на калькуляторе объясняется просто,
и на это мы заранее обратили внимание при расчёте (по стоково-затворной ВАХ) крутизны передаточной характеристики транзистора.
Несмотря на это, схема с указанными номиналами элементов вполне себе работоспособна и обладает усилением, близким к заданному,
что наглядно подтверждается эпюрами входных и выходных напряжений сигналов на осциллографе.
Рис.2 Результаты моделирования каскада с общим истоком на симуляторе
На самом деле, в связи с достаточно большим разбросом параметров любых полевых транзисторов, произвести точный теоретический расчёт
режимов полупроводника не представляется возможным. Поэтому на практике, как правило, предусматривается возможность точной
подстройки режимов транзистора. К примеру, снижение на симуляторе напряжения смещения затвора транзистора с 3,11 В до 2,95 В приводит к
практически полному приближению режимов полевика к расчётным значениям.
Однако, если заранее измерить основные характеристики ПТ, то можно обойтись и без указанных мероприятий, связанных
с подбором элементов, задающих режим транзистора по постоянному току.
Как это сделать — рассмотрим на следующей странице.
Расчёт усилительных каскадов на полевых транзисторах
Как просто рассчитать режимы работы и номиналы элементов схем на полевых транзисторах в различных схемах включения: c общим
истоком (ОИ), общим стоком (ОС, он же истоковый повторитель) и общим затвором (ОЗ).
Несмотря на крайне богатую терминологию различных типов полевых транзисторов, в большинстве практически встречающихся случаев мы имеем
дело: либо с полевыми транзисторами со встроенным p-n переходом обеднённого типа (JFET-транзисторы), либо с МОП-транзисторами
с изолированным затвором (они же MOSFET-ы в основном обогащённого типа), полное название которых звучит, как Metal Oxide Semiconductor
Field Effect Transistors.
И тот и другой типы полевиков могут быть любого знака полярности, т. е. как n-канальными, так и р-канальными.
Независимо от типов полевых транзисторов, они имеют схожие графики зависимости выходного тока от напряжения затвор‑исток, измеряемые
при фиксированном значении напряжения стока.
Пример подобных вольт-амперных характеристик приведён на рисунке ниже.
Рис.1 ВАХ обеднённых JFET (1) и обогащённых MOSFET (2) полевых транзисторов n-типа.
Для p-канальных транзисторов — полярности напряжений смещения, подаваемых на электроды, а также направление тока стока противоположны.
Как можно увидеть, вольт-амперные характеристики обеднённых (1) и обогащённых (2) и полевых транзисторов отличаются только сдвигом
напряжения отсечки затвор-исток. При этом n — канальный МОП‑транзистор обогащённого типа не проводит ток до тех пор, пока напряжение Uзи
не достигнет некоторого положительного уровня Uотс, в то время как ток стока транзистора обеднённого типа при напряжении Uзи = 0 будет
близок к максимальному.
Полевые транзисторы с р‑n ‑переходом – это всегда приборы обеднённого типа и смещение затвора относительно истока должно находиться
в отрицательной области (для n — канального ПТ), а если и заходить в положительную, то не более чем на +0,5В во избежание
открывания диодного перехода затвор‑канал.
Давайте рассмотрим, как можно рассчитать режимы работы полевика по постоянному току. Для примера возьмём распространённый транзистор
2SK117, широко используемый в каскадах усиления звукового диапазона частот. Приведём две его статических
характеристики из datasheet-а и до кучи схему усилительного каскада с общим истоком.
Рис.2 Статическая характеристика транзистора 2SK117 и схема каскада с общим истоком
Что нам советуют делать при расчёте усилительных каскадов на ПТ практически все умные книжки?
Построить на семействе выходных вольт-амперных характеристик транзистора динамическую линию, также называемую нагрузочной прямой.
Далее по пересечению этой нагрузочной линии с одним и графиков семейства выходных характеристик найти исходную рабочую точку, которая
определяет ток стока и напряжение Uси в режиме покоя. И только после этого переходить к стоково-затворной характеристике ПТ, чтобы определить
необходимую величину Uзи.
Конечно, ни один опытный схемотехник этого делать не будет! А делать он будет следующее:
1. Для начала надо определиться с током покоя транзистора Ic. Критериев выбора величины этого тока может быть множество, как с точки
зрения достижений необходимой нагрузочной способности, так и других факторов, таких как: быстродействие, шумовые характеристики,
энергопотребление, стабильность параметров и т. д. и т. п.
Поскольку 2SK117 является малошумящим полупроводником, а параметр шумовых характеристик в datasheet-е нормируется при токе стока
Id=0.5 mA, то и мы для расчёта выберем этот ток равным
Iс = 0,5мА .
2. Мысленно проводим на графике зависимости тока стока от напряжения затвор-исток красную линию (Рис.2 слева), пересекающую Id = 0.5 mA.
Величина напряжения затвор-исток, исходя из графика, получается
Uзи ≈ -0,23В .
3. Поскольку крутизна передаточной характеристики полевого транзистора
S = ΔIc/ΔUзи является величиной непостоянной, и
существенно зависящей от тока покоя стока, то в datasheet-ах на современные транзисторы она либо отсутствует, либо не имеет
большого практического смысла.
Давайте оценим её значение по всё тому же графику. Изменение напряжения Uзи в интервале — (0,3 …0,1) В приводит к росту стока
0,25…1,3 мА, что даёт нам ориентировочное значение параметра крутизны при заданном токе
S ≈ (1,3-0,25)/(0,3-0,1) = 5,25 мА/В.
4. Всё. Теперь можно вспомнить закон Ома и переходить к расчётам.
Rи = Uзи/Ic = 0,23/0,5 = 0,46 кОм.
Падение напряжения на резисторе Rc имеет смысл выбрать таким, чтобы напряжение стока в режиме покоя находилось в центре линейной
области выходной характеристики транзистора. Это требование выполняется при условии
Uc = (Eп + Uи)/2.
Если, для примера, напряжение питания выбрать равным 12В, то
Uc = (12 + 0,23)/2 = 6,1 В, а
Rc = (Eп — Uс)/Iс = (12 — 6,1)/0,5 ≈ 12 кОм
.
Расчёт по постоянному току окончен. Для того, чтобы рассчитать коэффициент передачи каскада ОИ с резистором в истоке (при отсутствии
шунтирующего конденсатора), необходимо воспользоваться следующей редкой формулой:
Кu = Rc*S/(1 +Rи*S) .
Подставив все цифры, получим значение Кu = 18,2 .
А теперь давайте проверим полученные расчёты в симуляторе.
Глядя на показания измерительных приборов, убеждаемся, что Uc (5,45В) и Ic (0,545мА) находятся в приемлемом диапазоне по отношению к
расчётным значениям.
На диаграммах осциллографа синим цветом указана входная осциллограмма сигнала, имеющего амплитуду 100 мВ, а красным —
выходного с амплитудой около 1,8 В, что выдаёт нам в сухом остатке Кu = 18, что так же полностью совпадает с расчётной величиной.
Рис.3
Для увеличения усиления каскада с общим истоком (Рис.2 справа) резистор Rи можно зашунтировать конденсатором Си и
резистором Rи1. Тогда в формулу для расчёта Ku вместо значения Rи следует подставлять величину, равную Rи ll Rи1.
Если резистор Rи1 имеет нулевое значение, то формула для расчёта коэффициента усиления каскада приобретает совсем простой вид:
Кu = Rc*S .
А ёмкость шунтирующего конденсатора Си (исходя из минимальной (нижней) усиливаемой частоты) можно рассчитать по формуле:
Си(МкФ) > 1600/[Fмин(Гц)*Rи(кОм)] .
Точно таким же образом рассчитываются режимы по постоянному току и номиналы резисторов для схем с общим затвором (Рис.4б) и
с общим стоком, в миру — истоковым повторителем (Рис.4в).
Рис.4 Схемы каскадов на полевых транзисторах ОИ, ОЗ, ОС и ОС со смещением
В случае использования ПТ с низким значением модуля Uотс — напряжение на истоке транзистора
в каскаде с ОС (истоковый повторитель) может оказаться слишком мало для достижения необходимых динамических характеристик.
В таком случае на затвор транзистора подают напряжение смещения Eсм, а номинал резистора Rи рассчитывают по формуле
Rи = (Есм — Uзи)/Ic .
Все расчёты, проведённые выше, были проделаны для наиболее распространённых в маломощных аналоговых цепях полевых транзисторов со
встроенным p-n переходом обеднённого типа (JFET-транзисторы).
На самом же деле, все приведённые формулы и принципы расчёта справедливы и по отношению к МОП-транзисторам с изолированным затвором
обогащённого типа (MOSFET-ы). Однако если всё ещё остались какие-либо вопросы, то на следующей странице проведём подобные манипуляции
и для них.
Полевые транзисторы
Полевыми транзисторами называют активные полупроводниковые приборы, в которых выходным током управляют с помощью электрического поля (в биполярных транзисторах выходной ток управляется входным током). Полевые транзисторы называют также униполярными, так как в процессе протекания электрического тока участвует только один вид носителей.
Различают два вида полевых транзисторов: с управляющим переходом и с изолированным затвором. Все они имеют три электрода: исток (источник носителей тока), затвор (управляющий электрод) и сток (электрод, куда стекают носители).
Транзистор с управляющим p—n-переходом. Его схематическое изображение приведено на рис. 1.21, а условное графическое обозначение этого транзистора – на рис. 1.22, а, б (p— и n-типов соответственно). Стрелка указывает направление от слоя р к слою п (как и стрелка в изображении эмиттера биполярного транзистора). В интегральных микросхемах линейные размеры транзисторов могут быть существенно меньше 1 мкм.
Рис. 1.22 Устройство транзистора
Рис. 1.23 Графическое изображение: а – канал р-типа; б – канал n-типа
Удельное сопротивление слоя n (затвора) намного меньше удельного сопротивления слоя р (канала), поэтому область р-n-перехода, обедненная подвижными носителями заряда и имеющая очень большое удельное сопротивление, расположена главным образом в слое р.
Если типы проводимости слоев полупроводника в рассмотренном транзисторе изменить на противоположные, то получим полевой транзистор с управляющим
р-n-переходом и каналом n-типа. Если подать положительное напряжение между затвором и истоком транзистора с каналом р-типа: изи > 0, то оно сместит p—n-переход в обратном направлении.
При увеличении обратного напряжения на переходе он расширяется в основном за счет канала (в силу указанного выше различия в удельных сопротивлениях). Увеличение ширины перехода уменьшает толщину канала и, следовательно, увеличивает его сопротивление. Это приводит к уменьшению тока между истоком и стоком. Именно это явление позволяет управлять током с помощью напряжения и соответствующего ему электрического поля. Если напряжение изи достаточно велико, то канал полностью перекрывается областью p—n-перехода (напряжение отсечки).
В рабочем режиме р—n-переход должен находиться под обратным или нулевым напряжением. Поэтому в рабочем режиме ток затвора примерно равен нулю (iз ? 0), а ток стока практически равен току истока.
На ширину р—n-перехода и толщину канала прямое влияние также оказывает напряжение между истоком и стоком. Пусть uзи = 0 и подано положительное напряжение uис(рис. 1.24). Это напряжение окажется поданным и на промежуток затвор – сток, т.е. окажется, что uзс = uис и р—n-переход находится под обратным напряжением.
Обратное напряжение в различных областях р—n-перехода различно. В областях вблизи истока это напряжение практически равно нулю, а в областях вблизи стока это напряжение примерно равно величине uис. Поэтому p—n-переход будет шире в тех областях, которые ближе к стоку. Можно считать, что напряжение в канале от истока к стоку увеличивается линейно.
При uис = Uзиотс канал полностью перекроется вблизи стока (рис. 1.25). При дальнейшем увеличении напряжения uис эта область канала, в которой он перекрыт, будет расширяться.
Рис. 1.24 Принцип действия транзистора
Рис. 1.25 Режим отсечки
Схемы включения транзистора. Для полевого транзистора, как и для биполярного, существуют три схемы включения: схемы с общим затвором (03), общим истоком (ОИ) и общим стоком (ОС). Наиболее часто используются схемы с общим истоком (рис. 1.26).
Так как в рабочем режиме ic ? 0, то входные характеристики обычно не рассматриваются.
Выходные (стоковые) характеристики. Выходной характеристикой называют зависимость вида
где f – некоторая функция.
Выходные характеристики для транзистора с р—n-переходом и каналом n-типа приведены на рис. 1.27.
Обратимся к характеристике, соответствующей условию uзи = 0. В линейной области (uис < 4 В) характеристика почти линейна (все характеристики этой области представляют собой почти прямые линии, веерообразно выходящие из начала координат). Она определяется сопротивлением канала. Транзистор, работающий в линейной области, можно использовать в качестве линейного управляемого сопротивления.
При uис > 4 В канал в области стока перекрывается. Дальнейшее увеличение напряжения приводит к очень незначительному росту тока, так как с увеличением напряжения область, в которой канал перекрыт, расширяется. При этом сопротивление промежутка исток-сток увеличивается, а ток ic практически не изменяется. Это область насыщения. Ток стока в области насыщения uзи = 0 и при заданном напряжении исиназывают начальным током стока и обозначают через ic нач. Для рассматриваемых характеристик ic нач = 5 мА при иси = 10 В.
Рис. 1.26 Схема с общей базой
Рис. 1.27 Выходные характеристики
Параметрами, характеризующими свойства транзистора усиливать напряжение, являются:
1) Крутизна стокозатворной характеристики S (крутизна характеристики полевого транзистора):
2) Внутреннее дифференциальное сопротивление Rис диф
3) Коэффициент усиления
Можно заметить, что
Транзисторы с изолированным затвором. Полевой транзистор с изолированным затвором – это транзистор, затвор которого отделен в электрическом отношении от канала слоем диэлектрика. Физической основой работы таких транзисторов является эффект поля, который состоит в изменении концентрации свободных носителей заряда в приповерхностной области полупроводника под действием внешнего электрического поля. В соответствии с их структурой такие транзисторы называют МДП-транзисторами (металл-диэлектрик-полупроводник) или МОП-транзисторами (металл-оксид-полупроводник). Существуют две разновидности МДП-транзисторов: с индуцированным и со встроенным каналами.
Рис. 1.28 Устройство МДП-транзистора со встроенным каналом n-типа
На рис. 1.28 показан принцип устройства транзистора со встроенным каналом.
Основанием (подложкой) служит кремниевая пластинка с электропроводностью p-типа. В ней созданы две области с электропроводностью n+-типа с повышенной проводимостью. Эти области являются истоком и стоком и от них сделаны выводы. Между стоком и истоком имеется приповерхностый канал с электропроводностью n-типа. Заштрихованная область – диэлектрический слой из диоксида кремния (его толщина обычно составляет 0,1 – 0,2 мкм). Сверху диэлектрического слоя расположен затвор в виде тонкой металлической пленки. Кристалл такого транзистора обычно соединен с истоком, и его потенциал принимается за нулевой. Иногда от кристалла бывает сделан отдельный вывод.
Если к затвору приложено нулевое напряжение, то при подаче между стоком и истоком напряжения через канал потечет ток, представляющий собой поток электронов. Через кристалл ток не пойдет, так как один из p—n-переходов находится под обратным напряжением. При подаче на затвор напряжения отрицательной полярности относительно истока (следовательно, и кристалла) в канале образуется поперечное электрическое поле, которое выталкивает электроны из канала в области истока, стока и кристалла. Канал обедняется электронами, его сопротивление увеличивается, ток уменьшается. Чем больше напряжение на затворе, тем меньше ток. Такой режим называется режимом обеднения. Если подать положительное напряжение на затвор, то под действием поля из областей стока, истока и кристалла в канал будут приходить электроны. Сопротивление канала падает, ток увеличивается. Такой режим называется режимом обогащения. Если кристалл n-типа, то канал должен быть p-типа и полярность напряжения меняется на противоположную.
Другим типом является транзистор с индуцированным (инверсным) каналом (рис. 1.29). От предыдущего он отличается тем, что канал возникает только при подаче на затвор напряжения определенной полярности.
При отсутствии напряжения на затворе канала нет, между истоком и стоком
n+-типа расположен только кристалл p-типа и на одном из p-n+-переходов получается обратное напряжение. В этом состоянии сопротивление между стоком и истоком велико и транзистор закрыт. При подаче на затвор напряжения положительной полярности под влиянием поля затвора электроны проводимости будут перемещаться из областей стока и истока и p-области по направлению к затвору. Когда напряжение на затворе достигает своего отпирающего (порогового) значения (еденицы вольт), в приповерхностном слое концентрация электронов настолько увеличивается, что превышает концентрацию дырок, и в этом слое произойдет так называемая инверсия типа электропроводности, т.е. образуется тонкий канал n-типа, и транзистор начнет проводить ток. Чем больше напряжение на затворе, тем больше ток стока. Очевидно, что такой транзистор может работать только в режиме обогащения. Если подложка n-типа, то получится индуцированный канал p-типа. Транзисторы с индуцированным каналом часто встречаются в устройствах переключения. Схемы включения полевых транзисторов подобны схемам включения биполярных. Следует отметить, что полевой транзистор позволяет получить намного больший коэффициент усиления, нежели биполярный. Обладая высоким входным сопротивлением (и низким выходным) полевые транзисторы постепенно вытесняют биполярные.
По электропроводности канала различают p-канальные и n-канальные МДП-транзисторы. Условное обозначение этих приборов на электрических схемах показано на рис. 1.30. Существует классификация МДП-транзисторов по конструктивно-технологическим признакам (чаще по виду материала затвора).
Рис. 1.30 Условные графические обозначения полевых транзисторов
с изолированным затвором: а – со встроенным р-каналом; б – со встроенным
n-каналом; в – с индуцированным p-каналом; г – с индуцированным n-каналом
Интегральные микросхемы, содержащие одновременно p—канальные и n-канальные МДП-транзисторы, называют комплементарными (сокращенно КМДП-ИМС). КМДП-ИМС отличаются высокой помехоустойчивостью, малой потребляемой мощностью, высоким быстродействием.
Частотные свойства полевых транзисторов определяются постоянной времени RC-цепи затвора. Поскольку входная емкость Сзи у транзисторов с р—n-переходом велика (десятки пикофарад), их применение в усилительных каскадах с большим входным сопротивлением возможно в диапазоне частот, не превышающих сотен килогерц – единиц мегагерц.
При работе в переключающих схемах скорость переключения полностью определяется постоянной времени RC-цепи затвора. У полевых транзисторов с изолированным затвором входная емкость значительно меньше, поэтому их частотные свойства намного лучше, чем у полевых транзисторов с р-n-переходом.
4.2.1. Полевые транзисторы с управляющим p-n переходом
Структура и принцип действия ПТ
Полевой транзистор с управляющим p-n-переходом (ПТУП) – это полевой транзистор, затвор которого отделен в электрическом отношении от канала p-n—переходом, смещенным в обратном направлении (рис. 4.14).
Электрод, из которого в канал входят носители заряда, называют истоком; электрод, через который из канала уходят носители заряда, – стоком; электрод, служащий для регулирования поперечного сечения канала, – затвором. При подключении к истоку отрицательного (для n-канала), а к стоку положительного напряжения в канале возникает электрический ток, создаваемый движением электронов от истока к стоку, т.е. основными носителями заряда. В этом заключается существенное отличие полевого транзистора от биполярного. Движение носителей заряда вдоль электронно-дырочного перехода (а не через переходы, как в биполярном транзисторе) является второй характерной особенностью полевого транзистора.
При отсутствии напряжения на входе (Uзи = 0) ток Iс, создаваемый этими электронами, определяется напряжением стока (Uси) и сопротивлением канала, зависящим от его поперечного сечения.
При подаче на переход обратного напряжения Uзи < 0, его ширина равномерно увеличивается, сечение канала уменьшается по всей его длине и сопротивление канала возрастает. Самое низкое сопротивление канала и соответственно самый большой ток через него будет при нулевом напряжении на затворе (Uзи = 0), затем по мере увеличения ширины перехода при возрастании Uзи и соответственно уменьшении сечения канала ток будет падать, и при некотором напряжении на затворе произойдет смыкание переходов, канал полностью перекроется и ток через него перестанет протекать. Это напряжение называется напряжением затвор-исток отсечки (Uзи отс). Канал в этом случае будет иметь вид, показанный на рис. 4.15.
Характеристики ПТУП
Выходные характеристики транзистора. На рис. 4.16 изображено семейство статических выходных характеристик Iс = f (Uси) при различных значениях напряжения на затворе Uзи.
Каждая характеристика имеет два участка – омический (для малых Uси) и насыщения (для больших Uси). При Uзи = 0 с увеличением напряжения Uс ток Iс вначале нарастает почти линейно, однако далее характеристика перестает подчиняться закону Ома. Ток Iс начинает расти медленно, ибо его увеличение приводит к повышению падения напряжения в канале и возрастанию потенциала вдоль канала от истока к стоку. Потенциал же затвора одинаков по всей длине.
Появляется разность потенциалов между каналом и затвором, которая увеличивается в сторону стока. Вследствие этого толщина запирающего слоя увеличивается клинообразно (рис. 4.17) и сопротивление канала также увеличивается, а возрастание тока IС замедляется. При напряжении насыщения Uси нас = Uзи отс сечение канала у стока приближается к нулю, и рост тока стока Iс прекращается.
Реальные характеристики в области насыщения имеют небольшой наклон. Незначительное увеличение тока стока в режиме насыщения при повышении напряжения Uси объясняются некоторым уменьшением эффективной длины канала при расширении перекрытого участка.
Следующая характеристика, снятая при некотором обратном напряжении затвора (U~~зи), когда запирающий слой имеет большую толщину при тех же значениях Uси, будет более пологой на начальном участке, и насыщение наступит раньше, при меньших значениях
U~~си нас = Uзи отс – U~~зи.
Передаточные (стоко-затворные) характеристики (рис. 4.18) представляют собой зависимости тока стока от напряжения на затворе при постоянном напряжении на стоке
Iс = f(Uзи) ׀Uси = const.
Характер этой зависимости ясен из принципа действия полевого транзистора. Ток стока имеет максимальную величину при отсутствии напряжения на затворе (Uзи = 0), когда толщина канала максимальна. При подаче обратного напряжения на затвор переход расширяется, толщина канала уменьшается, сопротивление возрастает, и ток стока уменьшается. Когда напряжение на затворе достигает величины Uзи отс , канал полностью перекрывается и ток стока падает до минимального значения.
Входная характеристика ПТУП – это зависимость Iз = f (Uзи). Представляет собой обратную ветвь ВАХ p-n-перехода (рис. 4.19).
Параметры ПТУП
Основным параметром, используемым при расчете усилительного каскада с полевым транзистором, является статическая крутизна характеристики прямой передачи, т.е. отношение изменения тока стока к изменению напряжения между затвором и истоком:
.
Крутизна обычно измеряется в миллиамперах на вольты и для типовых транзисторов она равна от десятых долей до единиц миллиампер на вольт. Крутизна характеризует управляющее действие затвора.
Дифференциальное выходное сопротивление определяется следующим образом:
.
Оно составляет, примерно от десятков до сотен килоом.
Статический коэффициент усиления по напряжению равен:
.
Он показывает, во сколько раз изменение напряжения на затворе воздействует эффективнее на ток стока, чем изменение напряжения на стоке.
Входное дифференциальное сопротивление равно:
.
Входное сопротивление имеет значение от сотен килоом до десятков мегаом.
Поскольку характеристики полевого транзистора нелинейны, значения дифференциальных параметров зависят от выбранного режима работы по постоянному току.
Эквивалентная схема ПТУП
Основным элементом эквивалентной схемы полевого транзистора (рис. 4.20), характеризующим усилительные свойства прибора, является зависимый генератор тока SUзи. Частотные и импульсные характеристики транзистора определяются емкостями электродов: затвор – сток (Cзи), затвор – сток (Cзс), сток – исток (Cси). Емкости Cзи и Cзс зависят от площади затвора и степени легирования канала, емкость Cзс – самая маленькая среди рассмотренных.
Сопротивления утечки Rзс, Rзи, Rзс весьма велики, и учитываются, как правило, при расчете электрических усилительных каскадов постоянного тока. При расчете импульсных каскадов и усилительных каскадов переменного тока их не учитывают, поскольку проводимость емкостей обычно всегда больше шунтирующих их проводимостей утечки электродов.
Схемы включения полевого транзистора
Полевой транзистор в качестве элемента схемы представляет собой активный несимметричный четырехполюсник, у которого один из зажимов является общим для цепей входа и выхода. В зависимости от того, какой из электродов полевого транзистора подключен к общему выводу, различают схемы (рис. 4.21):
1) с общим истоком и входом на затвор;
2) с общим стоком и входом на затвор;
3) с общим затвором и входом на исток.
Температурная зависимость параметров ПТУП
При изменении температуры свойства полупроводниковых материалов изменяются. Это приводит к изменению параметров полевого транзистора, в первую очередь, тока стока, крутизны и тока утечки затвора.
Зависимость изменения тока стока от температуры определяется двумя факторами: контактной разностью потенциалов p-n-перехода и изменением подвижности основных носителей заряда в канале. При повышении температуры контактная разность потенциалов уменьшается, ширина перехода также уменьшается, канал расширяется, сопротивление его падает, а ток стока увеличивается. Но повышение температуры приводит к уменьшению подвижности носителей заряда в канале и тока стока. Первое сказывается при малых токах стока, второе – при больших.
При определенных условиях действие этих факторов взаимно компенсируется, и ток полевого транзистора не зависит от температуры. На рис. 4.22 приведены стоко-затворные характеристики при различных температурах окружающей среды и указано положение термостабильной точки (ТСТ).
Для кремниевых транзисторов крутизна (S) с увеличением температуры уменьшается. С повышением температуры увеличивается собственная проводимость полупроводника, возрастает входной ток затвора (Iз) через переход и, следовательно, уменьшается Rвх. У полевых кремниевых транзисторов с p-n-переходом при комнатной температуре ток затвора порядка 1 нА. При увеличении температуры ток удваивается на каждые 10 °С. Хотя абсолютное изменение тока незначительно, его надо учитывать при больших сопротивлениях в цепи затвора. В этом случае изменение тока затвора может вызвать существенное изменение напряжения на затворе полевого транзистора и режима его работы.
Туннельные полевые транзисторы
Туннельные полевые транзисторы
Рахим Эсфандьярпур
12 июня 2012 г.
Представлено как курсовая работа для Ph350,
Стэнфордский университет, весна 2012 г.
| Рис. 1: Вверху: Схема туннельного транзистора (TFET) архитектура; Внизу: диаграмма энергетического диапазона, иллюстрирующая Условия включения и выключения TFET. |
Квантовое туннелирование
Формулировка квантовой механики Шредингера
представляет интересный феномен, когда частица проходит сквозь
энергетический барьер, подобный затухающей волновой связи электромагнитного
волны. Одна интерпретация этой двойственности включает Гейзенберга.
принцип неопределенности, который определяет предел того, насколько точно
положение и импульс частицы могут быть известны одновременно.
Это означает, что не существует решений с вероятностью ровно
ноль (или один).Следовательно, вероятность существования данной частицы на
противоположная сторона промежуточного барьера не равна нулю, и такой
частицы появятся — без указания физического перехода
барьер — на «другой» стороне с частотой, пропорциональной этому
вероятность.
Межполосное туннелирование
В TFET туннелирование представляет интерес между полосами
туннелирование. Чтобы произошло межзонное туннелирование, электрон в
валентная зона полупроводниковых туннелей через запрещенную зону до
зона проводимости без помощи ловушек.Ширина запрещенной зоны действует как
потенциальный барьер, через который проходит частица. Электрон
переходит из зоны валанса в зону проводимости без
поглощение или испускание фотона при прямом туннелировании. Туннель
частица приобретает изменение импульса за счет поглощения или испускания фонона
в процессе непрямого туннелирования. В непрямых полупроводниках, чьи
гамма-центрированная прямая запрещенная зона E Γ , намного больше, чем
их непрямая запрещенная зона, E G непрямое туннелирование является основным
процесс туннелирования.Процесс прямого туннелирования незначителен в
материалы непрямой запрещенной зоны, такие как кремний, потому что пропускание
вероятность быстро уменьшается с увеличением высоты барьера. В
туннелирование электронов через запрещенную зону сродни туннелированию частиц
через потенциальный барьер, и наиболее вероятный путь туннелирования
наименьший барьер. Для прямого туннелирования требуется сохранение
перпендикулярного импульса вызывает увеличение туннелирования. А
частица с некоторым перпендикулярным импульсом в валентной зоне должна
туннель в состояние с тем же перпендикулярным импульсом в проводимости
диапазон, что приводит к более длинному пути туннелирования.В косвенном
в процессе туннелирования фонон не передает или поглощает изменение
импульс частицы. Следовательно, электронно-фононное взаимодействие
косвенный процесс туннелирования отделяет перпендикулярный импульс
валентная зона и зона проводимости. Электрон в валентной зоне может
туннель в любое состояние в зоне проводимости, такое что энергия и
перпендикулярный импульс сохраняются:
| (1) | |
Где β — волновой вектор фонона.Под
в континуальном приближении β может иметь любое значение, так что
k c⊥ не зависит от k v⊥ . Тем не менее
энергия, передаваемая для передачи импульса от максимума Γ-долины к
минимум X-долины поперечным акустическим фононом составляет примерно 18
мэВ. [1] Поскольку эта энергия довольно мала, приближение сделано
что при фононном взаимодействии не происходит изменения полной энергии, и
членом ℏω β пренебрегаем. В полевом эффекте
транзисторы, туннелирование происходит с барьерами толщиной около 1-3 нм
и меньше, в котором вентиль управляется через квантовое туннелирование
вместо термического впрыска, снижение напряжения затвора с ~ 1 вольт
до 0.2 В и снижение энергопотребления до 100 раз. Если эти
транзисторы можно масштабировать до микросхем СБИС, они значительно
улучшить производительность интегральных схем в зависимости от мощности.
Туннельные полевые транзисторы
Туннельный полевой транзистор (TFET) относится к
семейство так называемых крутосклонных устройств, которые в настоящее время
исследованы для электронных приложений со сверхмалым энергопотреблением. [2] Ключ
Особенностью TFET, которая имеет решающее значение для коммутации с низким энергопотреблением, является
возможность обратного наклона подпорога S ниже предела 60
мВ / дек для обычных полевых транзисторов.[3]
| (2) |
Основная задача для коммерческой реализации
конкурентоспособные TFET — это ограниченный текущий уровень, который обычно
решается путем создания более высоких уровней допирования и резких профилей допирования.
[4] На рис. 1 показана схема n-канальной архитектуры TFET, которая
включает в себя высоколегированную область источника p +, почти собственный канал
область и n + область стока.
TFET — это просто стробируемый p-i-n диод, который
работает в условиях обратного смещения.В MOSFET источник
Механизм впрыска носителя представляет собой термический впрыск, но в TFET используется
межзонное туннелирование как механизм инжекции носителей в источник. рисунок 1
показывает диаграммы полос n-канального TFET в состояниях OFF и ON.
В выключенном состоянии существует широкий потенциальный барьер между источником
и канал, в результате чего туннелирование не происходит. Только очень
существует небольшой ток утечки. Но когда напряжение затвора превышает
пороговое напряжение, потенциальный барьер между каналом и
источник становится достаточно узким, чтобы пропустить значительный туннельный ток,
которое называется состоянием ВКЛ.Из-за другого носителя-источника
механизм впрыска в TFET по сравнению с MOSFET, он может достичь
менее 60 мВ / дек S (где S — наклон подпорога) [3]. Wang et al.
[5] показали возможность использования TFET для приложений с низким энергопотреблением; некоторые
Сообщалось об интересных исследованиях. Zhang et al. [6] предоставили
Теоретический анализ показывает, что значение S TFET может быть уменьшено ниже 60
мВ / дек.
TFET — амбиполярное устройство, оно будет показывать p-тип
поведение с доминирующей дырочной проводимостью и поведение n-типа с доминирующей
электронная проводимость.Но эту амбиполярность можно подавить
создание асимметрии в уровне или профиле легирования, или путем ограничения
движение одного типа носителей заряда с помощью гетероструктур. В
В принципе, из-за асимметрии TFET могут достигать гораздо более высоких
I ВКЛ -I ВЫКЛ Коэффициент при заданном размахе напряжения затвора
по сравнению с MOSFET, что делает архитектуру TFET привлекательной
автомобиль для реализации цифровой логики низкого напряжения питания (VDD)
схемы. Когда TFET находится в выключенном состоянии (рис.1 слева), валентность
край зоны канала расположен ниже края зоны проводимости
источник, поэтому BTBT подавляется, что приводит к очень маленькому отключенному состоянию TFET
токи, задаваемые p-i-n диодом с обратным смещением. Применяя
отрицательное напряжение затвора подтягивает энергетические полосы вверх.
Проводящий канал открывается, как только канал
валентная зона поднята над зоной проводимости источника, потому что
теперь носители могут туннелировать в пустые состояния канала. Потому что только
носители в энергетическом окне ΔΦ могут туннелировать в канал,
распределение энергии носителей от источника ограничено; в
высокоэнергетическая часть распределения Ферми источника эффективно отсекается
выключено, как показано на рис.осталось 2). Таким образом, электронная система
эффективно «охлаждается», действуя как обычный полевой МОП-транзистор при более низкой
температура. Эта функция фильтрации является причиной того, что мы можем
достичь значения S ниже 60 мВ на декаду (рис. 2 справа). Тем не менее
валентную зону канала можно поднять небольшим изменением напряжения на затворе,
и ширина туннелирования может быть эффективно уменьшена напряжением затвора.
S в TFET не является постоянным, как следствие механизма BTBT, но
это зависит от приложенного смещения затвор-исток, как показано на рис.2
(справа), увеличивающееся с увеличением смещения затвор-исток. В TFET S остается
ниже 60 мВ на декаду при токе стока на несколько порядков
и поэтому у TFET масштабирование напряжения лучше, чем у
МОП-транзистор. Одна из задач в TFET — это реализовать высокие токи, потому что
I НА критически зависит от вероятности передачи,
T WKB , межзонного туннельного барьера. Этот барьер может
можно аппроксимировать треугольным потенциалом, как показано серым
штриховкой на рис.2 (слева), поэтому T можно рассчитать с помощью
Приближение Вентцеля-Крамерса-Бриллюэна (ВКБ):
| (3) |
Где m * — эффективная масса и
E г — запрещенная зона. Здесь λ — экранирующее туннелирование.
длины и описывает пространственную протяженность переходной области на
интерфейс исходный канал; это зависит от конкретной геометрии устройства. В
TFET, при постоянном напряжении стока, В D , В G
увеличение уменьшает λ и увеличивает энергетическую разницу между
зона проводимости в источнике и валентная зона в канале
(ΔΦ), так что в первом приближении ток стока равен
суперэкспоненциальная функция V G .В результате, в отличие от
MOSFET точечный подпороговый размах TFET больше не является
постоянная, но сильно зависит от V G . Самая маленькая субтепловая
значения происходят при самых низких напряжениях затвора. Высокий ток требует
высокая прозрачность туннельного барьера, что увеличивает TWKB, что
в лучшем случае должно быть единство. Уравнение. (3) предлагает оптимизированный дизайн
подходы для повышения тока. Приближение ВКБ работает правильно в
полупроводники с прямой запрещенной зоной, такие как InAs, но имеют ограниченную точность
для структур Si и Ge или когда квантовые эффекты и фононы помогают
туннелирование становится доминирующим.
| Рис. 2: Слева: схематический профиль энергетической зоны для выключено (пунктирные синие линии) и включено (красные линии) в TFET p-типа. Во включенном состоянии электроны в энергии окно ΔΦ (зеленая заливка) может туннелировать из источник зоны проводимости в валентную зону канала. Электроны в хвосте распределения Ферми не могут туннель, потому что в канале нет пустых состояний при их энергии (пунктирная черная линия), поэтому наклон менее Декада 60 мВ может быть достигнута.[7] |
Оптимизация туннельных полевых транзисторов
Целями оптимизации TFET являются одновременное
достичь максимально возможного I ON , самого низкого S ср.
тока стока на много порядков и минимально возможного
Я ВЫКЛ . Чтобы превзойти КМОП-транзисторы, целевые параметры
для TFET: I ON в диапазоне сотен миллиампер;
S avg намного ниже 60 мВ на десятилетие в течение пяти десятилетий тока;
I ВКЛ / I ВЫКЛ > 10 5 ; и V DD G, TFET естественно
оптимизирован для работы при низком напряжении.Чтобы реализовать высокий туннель
ток и крутой наклон, вероятность передачи источника
туннельный барьер должен стать близким к единице при небольшом изменении
В Г . Приближение ВКБ предполагает, что запрещенная зона
(E g ), эффективная масса носителя (m * ) и
длина экранирующего туннеля (λ) должна быть минимизирована для высоких
барьерная прозрачность. Тогда как E g и m * зависят
только на материальной системе, λ сильно зависит от
несколько параметров, таких как геометрия устройства, габариты, легирование
профили и емкость затвора.Малое λ приводит к сильному
модуляция полос канала гейтом. Это требует
диэлектрик затвора с высокой диэлектрической проницаемостью (высокий K) с низким эквивалентом
толщина оксида насколько это возможно. Кроме того, толщина корпуса
канал должен быть минимизирован, показывая в лучшем случае одномерный
электронное транспортное поведение. Резкость профиля легирования при
туннельный переход тоже важен. Чтобы свести к минимуму туннелирование
барьер, высокий уровень легирования источника должен упасть до собственного
канал как можно короче.Это требует изменения
концентрация легирования около 4-5 порядков на расстоянии
всего несколько нанометров. Увеличение легирования источника снижает λ
и может привести к немного меньшему энергетическому барьеру в туннельном переходе
из-за сужения запрещенной зоны. Однако эффект фильтрации энергии
описанное выше становится эффективным только в том случае, если энергия Ферми в источнике
не слишком большой. [7]
Полевые транзисторы с двойным затвором
В интегрированном процессе DG-CMOS / DG-Tunnel-FET
Туннельные полевые транзисторы выиграют от добавления затвора, так что ток будет
быть как минимум вдвое.Таким образом, ток включения увеличивается, в то время как
Ток отключения, все еще в диапазоне фемтоампер или пикоампер, увеличивается
тем же фактором, но остается крайне низким. Стоит отметить, что
для сверхтонких полевых МОП-транзисторов с кремнийон-изолятором (КНИ), согласно некоторым отчетам,
что это улучшение может быть еще выше, когда инверсия объема требует
место. [8]
Температурная зависимость туннельных полевых транзисторов
Зависимость ГИДЛ от температуры и напряжения
эффект в полевых МОП-транзисторах в слабом электрическом поле.В
Зависимость тока ГИДЛ от электрического поля E может быть выражена
как
| (4) |
Параметр представлен как A ∝
E G -7/4 и B ∝ E G 3/2 ,
с шириной запрещенной зоны EG. Из уравнения. (4) ток GIDL выводится
быть очень слабым в зависимости от температуры. Однако второй эффект
существует при слабом электрическом поле. В слабом электрическом поле ток ГИДЛ
можно описать с помощью модели Шокли-Рида-Холла (SRH), которая имеет сильную
температурная зависимость.В более сильном электрическом поле ток ГИДЛ равен
преобладает межполосное туннелирование, которое имеет слабую температуру
зависимость. Из-за сравнимого физического принципа тока GIDL
и TFET, уравнение. (4) может использоваться для отделения SRH части TFET
характеристика от части Band-to-Band туннелирования. Следовательно, начиная
от напряжения затвор-исток примерно -1 В
туннелирование — доминирующий механизм. Как и в случае MOSFET, температура
зависимость меняется с приложенным напряжением.Для полевого МОП-транзистора ноль
точка температурного коэффициента может использоваться для проектирования цифровых схем, чтобы
сделать производительность системы независимой от температуры. Для TFET
напряжение, при котором происходит изменение температурной зависимости, равно
вне допустимого диапазона. Следовательно, комбинация MOSFET и
TFET может использоваться для компенсации температурных эффектов. Для аналога
В схемах температурная зависимость требует более детальной проверки.
Очевидно, что температурный эффект ТФЭТ более сопоставим с температурным эффектом.
биполярный аппарат.Это может позволить использовать новые топологии для «запрещенной зоны».
опорное напряжение цепи. [9]
Туннельные полевые транзисторы с диэлектрическим затвором с высоким k затвором
Улучшенный текущий и уменьшенный подпороговый
качели можно получить путем тщательного выбора диэлектрика затвора. Кэти
Boucart Et al. сравнил 3 нм физическую толщину
Si 3 N 4 и два high-k диэлектрика с диэлектриком
константы 21 и 29 с SiO 2 . Помимо улучшенного
Ион, в результате улучшается точечный и средний подпороговый размах
лучшей связи затвора, обеспечиваемой диэлектриком с высоким k.Выключено
ток менее 1 фА для всех материалов. Ток туннеля
FET не увеличивается просто пропорционально увеличению затвора.
емкости, как у обычного полевого МОП-транзистора. Их числовые
Моделирование показывает, что подпороговое колебание туннельных полевых транзисторов продолжает улучшаться
по мере увеличения диэлектрической проницаемости затвора. Качели для
обычный полевой МОП-транзистор достигает предела 60 мВ / декаду при комнатной температуре и
не может улучшаться дальше. В то время как диэлектрики с высоким k имеют преимущества для
характеристики устройства при непосредственном контакте с кремнием
канал, они могут привести к дефектам на полупроводнике / диэлектрике.
интерфейс.Хотя туннельные полевые транзисторы могут быть менее чувствительны к изменениям
мобильность канала, чем у полевых МОП-транзисторов, так как транспортировка через туннель
переход преобладает над любым рассеянием в канале, стандартная CMOS
технологии изготовления требуют межфазного слоя между
диэлектрик и кремниевый канал. Диэлектрики High-k приносят дополнительные
проблемы, такие как ограничения мягкого и жесткого диэлектрика
сломать. В зависимости от характеристик изготавливаемых хай-к
диэлектрических слоев, может потребоваться ограничение приложенного напряжения затвора.[10]
Заключение
Сегодня TFET представляют собой наиболее многообещающий крутой склон.
кандидат на переключение, имеющий потенциал для использования напряжения питания
значительно ниже 0,5 В и тем самым обеспечивает значительную мощность
диссипация экономии. Благодаря низким токам отключения они идеально подходят
подходит для работы логических приложений с низким энергопотреблением и низким энергопотреблением
на умеренных частотах. Другие перспективные
Применения TFET включают специализированный аналоговый
интегральные схемы с улучшенной температурной стабильностью и малым энергопотреблением
SRAM.
Самая большая проблема — добиться высокой производительности
(высокий I ON ) без ухудшения I OFF , в сочетании с
S менее 60 мВ за десятилетие в течение более четырех десятилетий утечки
текущий. Это требует аддитивного сочетания многих технологий.
бустеры, которые доступны или исследуются.
© Рахим Эсфандьярпур. Автор грантов
разрешение на копирование, распространение и отображение этой работы в неизмененном виде,
со ссылкой на автора, только для некоммерческих целей.Все
другие права, включая коммерческие, сохраняются за
автор.
Список литературы
[1] H. Holonyak, Jr. et al. , «Прямой
Наблюдение фононов во время туннелирования в диодах с узким переходом ».
Phys. Rev. Lett. 3 , 167 (1959).
[2] B. Ganjipour et al. , «Туннельный полевой объект»
Транзисторы на основе гетероструктурных нанопроволок InP-GaAs, АКС Нано
6 , 3109 (2012).
[3] W. Y. Choi et al., «Эффект туннельного поля»
Транзисторы (TFET) с подпороговым колебанием (SS) менее 60 мВ / дек »,
IEEE Electron Device Lett. 28 , 743 (2007).
[4] Ю. И. Панкове, Оптические процессы в
Полупроводники (Довер, 2010).
[5] П.-Ф. Wang et al. , «Дополняющий
Туннельный транзистор для маломощных приложений, Твердотельная электрон.
48 , 2881 (2004).
[6] Q. Zhang, W. Zhao и A. Seabaugh,
«Туннельные транзисторы с низким подпороговым уровнем качания», IEEE Electron Device Lett. 27 , 297 (2006).
[7] А. М. Ионеску и Х. Риль, «Туннельный полевой эффект
Транзисторы как энергоэффективные электронные переключатели », Nature 479 , г.
329 (2011).
[8] F. Balestra et al. , «Двойные ворота»
Транзистор кремний на изоляторе с инверсией объема: новое устройство с
Значительно улучшенная производительность », IEEE Electron Device Lett. 8 , 410
(1987).
[9] T. Nirschi et al. , «Туннельное поле»
Эффектный транзистор (TFET): зависимость от температуры, моделирование
Модель и ее применение »
Proc.Intl. Symp. по схемам и системам ICAS 3 , 713 (2004).
[10] К. Букар и А. М. Ионеску, «Туннель с двумя воротами».
Полевой транзистор с диэлектриком затвора с высоким κ, IEEE Trans. Elect. Dev.
54 , 1725 (2007).
Полевые транзисторы (современные)
дюйм
1945 г. у Шокли появилась идея сделать твердотельное устройство.
полупроводников. Он рассудил, что сильное электрическое поле
может вызвать электрический ток внутри соседнего полупроводника.Он попытался построить один, затем Уолтер Браттейн попытался
построить его, но это не сработало.
Три года спустя Браттейн и Бардин построили
первый рабочий транзистор, германиевый точечный транзистор,
который выпускался как серия «А». Шокли тогда
разработан переходной (сэндвич) транзистор, который был изготовлен
в течение нескольких лет после этого. Но в 1960 году ученый Белла Джон
Аталла разработал новый дизайн, основанный на первоначальных теориях Шокли о полевом эффекте.К концу 1960-х производители перешли из
интегральные схемы переходного типа к полевым устройствам. Cегодня,
большинство транзисторов являются полевыми транзисторами. Вы используете миллионы
из них сейчас.
МОП-транзисторы
Большинство современных транзисторов — это «МОП-полевые транзисторы»,
или металлооксидные полупроводниковые полевые транзисторы. Они были
разработан в основном Bell Labs, Fairchild Semiconductor и сотнями
Кремниевой долины, японских и других производителей электроники.
Полевые транзисторы названы так потому, что
слабый электрический сигнал, проходящий через один электрод, создает
электрическое поле через остальную часть транзистора.
Это поле меняется с положительного на отрицательное, когда входящий сигнал
делает и контролирует второй ток, проходящий через остальные
транзистора. Поле модулирует второй ток, чтобы имитировать
первый — но он может быть существенно больше.
Как это работает
На дне транзистора находится П-образный участок.
(хотя он более плоский, чем истинная буква «U») полупроводника N-типа
с избытком электронов. В центре буквы U находится
секция, известная как «база», сделанная из P-типа (положительно заряженная)
полупроводник со слишком малым количеством электронов. (Собственно, N- и P-типы
можно перевернуть, и устройство будет работать точно так же,
за исключением того, что дырки, а не электроны, вызывают ток.)
Три электрода прикреплены к верхней части этого
полупроводниковый кристалл: один к средней положительной секции и
по одному на каждое плечо U. Подавая напряжение на электроды
на U ток будет течь через него. Сторона, где электроны
входящий известен как источник, и сторона, где электроны
выходит называется стоком.
Если больше ничего не произойдет, ток будет течь от
с одной стороны на другую.Из-за того, как электроны ведут себя при
переход между полупроводниками N- и P-типа, однако
ток не будет течь особенно близко к базе. Он путешествует
только через тонкий канал посередине U.
К основанию прикреплен электрод,
клин из полупроводника P-типа посередине, отделенный от
остальная часть транзистора тонким слоем оксида металла, например
в виде диоксида кремния (играющего роль изолятора).
Этот электрод называется «затвор». Слабый электрический
сигнал, который мы хотим усилить, проходит через гейт. Если
заряд, проходящий через ворота, отрицательный, он добавляет больше электронов
к базе. Поскольку электроны отталкиваются друг от друга, электроны
в U отойдите как можно дальше от базы. Это создает
зона обеднения вокруг базы — целая область, где электроны
не может путешествовать.Канал посередине U через
который может течь, становится еще тоньше. Добавьте достаточно
отрицательный заряд к базе и канал полностью перещипнется,
остановка всего тока. Это как наступить на садовый шланг
чтобы остановить поток воды. (Раньше транзисторы управлялись
эту зону истощения, используя то, как движутся электроны, когда два
полупроводниковые пластины кладут рядом друг с другом, создавая то, что
известен как соединение P-N.В MOS-FET переход P-N заменен оксидом металла, который
оказалось, что массовое производство микрочипов проще.)
А теперь представьте, если заряд проходит через ворота
положительный. Положительное основание притягивает много электронов —
внезапно территория вокруг базы, которая раньше была нейтральной зоной
открывается. Канал для тока через U становится
больше, чем было изначально, и может течь гораздо больше электричества
через.
Переменный заряд на базе, следовательно, меняется
сколько тока проходит через U. Входящий ток может
использоваться как кран для включения или выключения тока по мере его прохождения
остальной транзистор.
С другой стороны, транзистор можно использовать в
и более сложным образом — в качестве усилителя. ток
путешествие через U становится больше или меньше в идеальной синхронизации
с зарядом, входящим в базу, что означает, что он имеет идентичный
шаблон как исходный слабый сигнал.А со второй
ток подключен к другому источнику напряжения, это может быть
сделано, чтобы быть больше. Ток, проходящий через U-образный
идеальная копия оригинала, только в усилении. Транзистор
используется таким образом для стереоусиления в динамиках и микрофонах,
а также для усиления телефонных сигналов при их перемещении по
Мир.
Сноска к Шокли
Шокли наблюдал за ростом Кремниевой долины, но мог
не похоже, чтобы войти в Землю Обетованную, которую он вообразил.Он никогда
удалось сделать полевые транзисторы, в то время как другие компании
проектировали, росли и процветали. Фред Зейтц назвал Шокли
Моисей из Кремниевой долины ».
Другие типы транзисторов:
— Точечный
Транзистор
— Переходный («Сэндвич»).
Транзистор
Ресурсы:
— Как все работает Дэвид Маколей
— Научная энциклопедия Ван Ностранда
— The
Полевой транзистор
— Интервью, Уолтер Браун, 3 мая 1999 г.
Авторские права
1999 г., ScienCentral, Inc. и Американский институт физики.Нет
часть этого веб-сайта может воспроизводиться без письменного разрешения.
Все права защищены.
Органический полевой транзистор: физика устройства, материалы и процесс
1. Введение
Органические полевые транзисторы (OFET) привлекли большое внимание в пластиковой электронике из-за их хорошей обрабатываемости, низкотемпературного осаждения, низкой стоимости , а также совместимость с технологией печати на больших площадях. Хотя обычные полупроводники на основе аморфного кремния достигли большого прогресса с подвижностью носителей заряда около 1.0 см 2 V −1 s −1 , осаждение тонких пленок обычных полупроводников обычно требует высокотемпературного процесса и условий отсутствия пыли, что значительно увеличивает стоимость изготовления. Что наиболее важно, материалы на основе кремния редко обрабатываются на гибких подложках из-за их плохих характеристик растяжения. Тем не менее, по сравнению с обычными полупроводниками на основе кремния, полупроводники на органической основе обладают низкой стоимостью, хорошей технологичностью и могут быть изготовлены на гибких подложках.Следовательно, использование органических полупроводниковых материалов стало важной темой при разработке недорогих, больших по площади, гибких и легких устройств.
Полупроводники на органической основе находят различное применение в качестве ключевых компонентов многочисленных электронных и оптоэлектронных устройств, включая полевые транзисторы (FET), фотоэлектрические элементы (PV) и светоизлучающие диоды (LED). Специально для полевого транзистора было приложено много усилий для разработки новых органических материалов для улучшения характеристик устройства с высокой подвижностью носителей заряда и хорошей стабильностью на воздухе.В любом случае, OFET рассматриваются как ключевой компонент органических интегральных схем для применения в гибких смарт-картах, недорогих метках радиочастотной идентификации (RFID), сенсорных устройствах, дисплеях с органической активной матрицей и т. Д. [1–6]. Однако для практического применения он еще далек от удовлетворительного. В последнее время основное внимание уделяется повышению производительности и стабильности устройств, снижению стоимости изготовления, исследованию новых приложений и разработке простых методов изготовления.Преодоление этих проблем зависит от разработки новых органических полупроводников и оптимизации устройств.
В этой главе органические полевые транзисторы будут обсуждаться с трех аспектов: физика устройства, материалы устройства и обработка устройства. В первом разделе будет рассказано о переносе заряда и связанных с ним механизмах в органических полупроводниковых материалах, а также о методах, используемых для характеристики подвижности носителей заряда, таких как время пролета, полевой транзистор и метод ограничения тока пространственным зарядом (SCLC).Во втором разделе мы обсуждаем органический полевой транзистор с точки зрения базового принципа, структуры устройства и основных параметров, таких как подвижность носителей заряда, коэффициент включения / выключения тока, пороговое напряжение, подпороговое напряжение и соответствующие факторы влияния в OFET. В третьем разделе будет рассказано о выборе органических материалов, в том числе наиболее часто используемых ароматических полупроводников p-типа и полупроводников n-типа. В четвертом разделе будут обсуждаться методы изготовления органических полевых транзисторов, включая осаждение из паровой фазы, осаждение из раствора и некоторые методы выравнивания тонких пленок.
2. Физика устройства
2.1. Транспорт заряда и связанные с ним механизмы
Изучение переноса электронов и дырок в органических материалах имеет долгую историю, уходящую корнями в 60 лет назад. Многие группы приложили усилия по этой теме. В середине 1970-х группа Шер заложила теоретическое описание прыжкового переноса в неупорядоченных материалах, используя модель случайных блужданий в непрерывном времени [7]. До сих пор точная природа переноса заряда в органических полупроводниках остается предметом дискуссий.Однако общее представление можно получить, используя в качестве эталонов неупорядоченные полупроводники и высокоупорядоченные органические монокристаллы. В органических полупроводниках механизм переноса носителей заряда зависит от степени упорядоченности и находится между зонным и прыжковым переносом, которые являются двумя крайними случаями переноса. Обычно полосный перенос можно наблюдать в молекулярных кристаллах высокой степени очистки при низких температурах. Однако ширина полосы в органических полупроводниках меньше, чем в неорганических полупроводниках (обычно несколько kT только при комнатной температуре) из-за слабой электронной делокализации [8].Следовательно, значение подвижности в молекулярных монокристаллах при комнатной температуре достигает только в диапазоне от 1 до 10 см. 2 V −1 с −1 . В другом крайнем случае аморфного органического твердого вещества преобладает прыжковый транспорт, что приводит к гораздо более низким значениям подвижности (в лучшем случае около 10 −3 см 2 V −1 s −1 ).
Когда локализация происходит в сопряженных органических материалах, поляроны, возникающие в результате деформации сопряженной цепи под действием заряда, могут образовываться (или заряд самозахватывается из-за деформации) [9].Этот механизм самозахвата часто описывают как создание локализованных состояний в щели между валентной зоной и зоной проводимости.
Чтобы лучше понять перенос заряда в органических материалах, Холстейн разработал одномерную одноэлектронную модель, модель малых поляронов [9]. В этой модели предполагается, что электрон-электронными взаимодействиями пренебрегают, а энергия решетки, энергия дисперсии электронов и энергия полосатости поляронов являются тремя членами, которые составляют полную энергию системы [9].
Подвижность носителей заряда зависит от температуры и поля. Для зависящей от температуры подвижности, когда подвижность экстраполирована на предел нулевого поля, результаты подгонки Монте-Карло (MC) приводят к следующему выражению:
μ (T) = μ0exp [- (T0T) 2] E1
где μ 0 — подвижность при комнатной температуре, а T 0 — комнатная температура. Поскольку температура помогает преодолевать барьеры, создаваемые энергетическим беспорядком в системе, температура, о которой здесь говорится, зависит только от амплитуды ширины диагонального беспорядка.Это выражение отклоняется от закона Аррениуса, и это выражение в целом хорошо согласуется с экспериментальными данными из-за ограниченного диапазона доступных температур.
Воздействие внешнего электрического поля должно снизить энергетический барьер для переноса зоны электронной проводимости, поскольку часть этой энергии может быть обеспечена движущей силой электрического поля. Только при наличии энергетического беспорядка результаты Монте-Карло обычно дают поведение Пула-Френкеля, когда электрические поля превышают 10 4 –10 5 В / см:
, где μ 0 — низкий подвижность поля, β — коэффициент Пула-Френкеля, а E — приложенное электрическое поле [10].Зависимость от поля становится более выраженной по мере роста энергетического беспорядка. Увеличение амплитуды электрического поля также сопровождается увеличением постоянной диффузии.
2.2. Характеристика подвижности носителей заряда
Подвижность носителей заряда может быть определена различными методами [11, 12]. Подвижность, измеряемая методами с измерением в макроскопических масштабах (~ 1 мм), часто зависит от порядка и чистоты материала. Вместо этого, когда измерение подвижности осуществляется в микроскопических масштабах, результат измерения меньше зависит от этих характеристик.В этом разделе будет кратко описан основной принцип наиболее часто используемых методов измерения подвижности, времяпролетного (TOF), полевого транзистора (FET) и тока, ограниченного пространственным зарядом (SCLC).
2.2.1. Время пролета (TOF)
Для измерения TOF органический активный слой толщиной в несколько микрон помещается между двумя металлическими электродами (рис. 1). Как показано на рисунке 1, сначала материал облучают для генерации зарядов лазерным импульсом рядом с одним электродом. Затем фотогенерируемые дырки или электроны мигрируют через материал к другому электроду в зависимости от полярности приложенного смещения и соответствующего электрического поля (в диапазоне 10 4 –10 6 В / см).После этого ток на этом электроде регистрируется как функция времени. Наконец, для упорядоченных материалов будет получен резкий сигнал, в то время как для неупорядоченных систем произойдет расширение сигнала из-за распределения переходных времен по материалу. Подвижность дырок или электронов оценивается с помощью следующего уравнения:
Рисунок 1.
Схема метода TOF.
, где d — расстояние между электродами, F — электрическое поле, t — усредненное время переходного процесса и V — приложенное напряжение.Измерения TOF четко показывают влияние структурных дефектов, имеющихся в материале, на подвижность носителей заряда. Подвижность носителей заряда в органических материалах впервые была измерена методом TOF Кеплером [13] и Лебланом [14].
2.2.2. Конфигурация полевого транзистора (FET)
Электрические характеристики, измеренные в конфигурации полевого транзистора (FET), также могут быть использованы для определения подвижностей носителей заряда (Рисунок 2). Как ранее говорил Хоровиц [15], полученные выражения «ток-напряжение» для неорганических транзисторов как в линейном, так и в насыщенном режиме также применимы к органическим полевым транзисторам (OFET).Эти выражения в линейном режиме:
Рисунок 2.
Структура тонкопленочного транзистора.
IDS = WLCiµ (VG − VT) VD, VD
IDS = W2LCiµ (VG − VT) 2, VD> VG − VT.E5
Здесь I DS и V DS — ток и напряжение смещения между истоком и стоком, соответственно, V G обозначает напряжение затвора, V T — пороговое значение напряжение, C i — это емкость диэлектрика затвора, а W и L обозначают ширину и длину проводящего канала соответственно.В полевых транзисторах заряды мигрируют на границе раздела между органическим полупроводником и диэлектриком в пределах канала шириной несколько нанометров [16,17]. Есть несколько факторов, которые влияют на перенос заряда, такие как структурные дефекты на границе раздела внутри органического слоя, морфология и полярность поверхности диэлектрика, а также ловушки, существующие на границе раздела (это зависит от химической структуры поверхности диэлектрика затвора). Контактные сопротивления на интерфейсах металл / органическое соединение истока и стока также играют очень важную роль, и когда длина канала уменьшается, а транзистор работает при малых полях, это становится более важным.Во всяком случае, его влияние можно учесть с помощью четырехзондового измерения [18].
Подвижности носителей заряда, извлеченные из вольт-амперных кривых полевого транзистора в насыщенном режиме, обычно выше, чем в линейном режиме, из-за различного распределения электрического поля. Было обнаружено, что подвижность зависит от напряжения затвора [19] и часто связана с наличием ловушек, что обычно вызвано структурными дефектами и / или примесями и / или плотностью носителей заряда (которая модулируется напряжением В G ) [20].
Диэлектрическая проницаемость изолятора затвора — еще один важный параметр. Например, измерения на монокристаллах рубрена [21] и цепочках политриариламина [22] показывают, что подвижность носителей заряда уменьшается с увеличением диэлектрической проницаемости из-за поляризационных эффектов на границе раздела. На поверхности диэлектрика поляризация, индуцированная носителями заряда в проводящем канале органических полупроводников, взаимодействует с движением носителей, которые могут быть отлиты в виде полярона Фролиха [23, 24].
2.2.3. Ток, ограниченный пространственным зарядом (SCLC)
Подвижности также можно извлечь из электрических характеристик, измеренных в диодной конфигурации с органическим слоем, зажатым между двумя металлическими электродами (Рисунок 3). В этом случае мы предполагаем, что транспортировка носителя ограничена массой, а не контактом. Электрод выбирается таким образом, что при низком напряжении инжектируются только электроны или дырки. В отсутствие ловушек и при низких электрических полях поведение плотности тока J , квадратично масштабируемой с приложенным смещением V , является характеристикой тока, ограниченного пространственным зарядом (SCLC), и соответствует току, полученному, когда число количество введенных зарядов достигает максимума, поскольку их электростатический потенциал предотвращает инжекцию дополнительных зарядов [25].В этом случае плотность заряда максимально приближается к инжекционному электроду, а не однородна по материалу [26]. В этом режиме, когда вклады диффузии не учитываются, мы можем описать характеристики J — V как:
Рисунок 3.
Структура устройства на основе SCLC.
, где ε r — диэлектрическая проницаемость активного слоя, а d — толщина устройства. (Обратите внимание, что при высоких электрических полях необходимо учитывать полевую зависимость подвижности.) При наличии ловушек кривые J — V становятся более сложными. Во-первых, на кривых J — V демонстрируется линейный режим с транспортом, ограниченным впрыском. Затем происходит резкое увеличение промежуточного диапазона приложенных смещений. Наконец, достигается зависимость V 2 режима SCLC без ловушек. Протяженность промежуточной области определяется пространственным и энергетическим распределением состояний ловушки, которое обычно моделируется гауссовым [27] или экспоненциальным распределением [28].
3. Органические полевые транзисторы
3.1. Основные принципы полевых транзисторов
В 1962 году Веймер впервые представил концепцию тонкопленочных транзисторов (TFT) [29]. Эта структура хорошо адаптирована к материалам с низкой проводимостью и в настоящее время используется в транзисторах из аморфного кремния. Как показано на рисунке 2, омические контакты формируются непосредственно между электродами истока и стока с проводящим каналом. По сравнению со структурой полевого транзистора металл-изоляция-полупроводник (MISFET) в структуре TFT есть два важных отличия.Во-первых, отсутствует обедненная область, изолирующая устройство от подложки. Во-вторых, вместо режима инверсии, TFT работает в режиме накопления, хотя это устройство с изолированным затвором. В результате следует быть особенно осторожным при передаче уравнений тока стока с MISFET на TFT. Фактически, отсутствие обедненной области приводит к упрощению уравнения следующим образом [30]:
Id = WLCiµ (VG − VT − VD2) VDE7
Здесь пороговое напряжение — это напряжение затвора, а проводимость канала (при низких напряжениях стока) равна таковой всего полупроводникового слоя.
3.2. Важные параметры в OFET
3.2.1. Мобильность
Характеристики полевого транзистора J — V в различных режимах работы могут быть аналитически выражены с помощью предположения постепенного приближения канала, что означает, что электрическое поле, параллельное току, генерируемому напряжением стока, намного меньше по сравнению с полем. перпендикулярно току, создаваемому напряжением на затворе [30, 31].
В линейном режиме ток стока прямо пропорционален В G , а подвижность полевого эффекта в линейном режиме ( μ lin ) может быть извлечена из градиента I D по сравнению с V G при постоянном V D .
ID = WLCiµ (VG − VT − VD2) VD, VD
IDsat = W2LCiµ (VG-VT) 2, VD> VG-VTE9IDsat = W2LCiµ (VG-VT) E10
Ур. (10) предсказывает, что построение квадратного корня из тока насыщения в зависимости от напряжения затвора приведет к получению прямой линии.Подвижность получается из наклона линии, а пороговое напряжение соответствует экстраполяции линии при нулевом токе. Однако в режиме насыщения плотность заряда сильно меняется вдоль проводящего канала, от максимума около электрода истока до практически нуля на электроде стока. Следовательно, подвижность в органических полупроводниках во многом зависит от различных параметров, в том числе от плотности носителей заряда. Между тем, в режиме насыщения подвижность не является постоянной по длине канала, и извлеченное значение представляет собой только среднее значение.Поэтому часто бывает рациональнее извлекать подвижность в линейном режиме, в котором плотность заряда более однородна. Обычно это делается через крутизну g m , которая следует из первой производной уравнения. (3) относительно напряжения затвора [30].
gm = ∂ID∂VG = WLCiµVDE11
Это уравнение предполагает, что подвижность не зависит от напряжения затвора. Однако подвижность фактически зависит от напряжения затвора. В этом случае дополнительный член ∂ μ / ∂ V G должен быть включен в уравнение.(5), так что этот метод применим только тогда, когда подвижность медленно изменяется с напряжением затвора [30]. Более того, этот метод очень чувствителен к ограничению инжекции заряда и его извлечению на электродах истока и стока.
3.2.2. Коэффициент включения / выключения тока
Коэффициент включения / выключения тока является еще одним важным параметром полевого транзистора, который можно извлечь из передаточных характеристик. Это соотношение тока стока во включенном состоянии (при определенном напряжении затвора) и тока стока в выключенном состоянии ( I на / I выкл ).Для наилучшего поведения транзистора это значение должно быть как можно большим. Если пренебречь эффектами контактного сопротивления на электродах исток-сток, ток включения в основном зависит от подвижности полупроводника и емкости диэлектрика затвора. Отключение тока в основном определяется током утечки затвора. Он может быть увеличен для электродов затвора без рисунка и полупроводниковых слоев из-за проводящих путей на границе раздела подложки и объемной проводимости полупроводника.Более того, непреднамеренное легирование может также увеличить отключенный ток [31].
3.2.3. Пороговое напряжение
Пороговое напряжение возникает из-за нескольких эффектов и сильно зависит от используемых органических полупроводников и диэлектриков. Вообще говоря, пороговое напряжение может быть вызвано интерфейсными состояниями, зарядовыми ловушками, встроенными диполями, примесями и т. Д. [31, 32]. И его можно уменьшить, увеличив емкость затвора, которая индуцирует больше зарядов при более низких приложенных напряжениях.Во многих случаях пороговое напряжение не всегда является постоянным для данного устройства. Значение V th имеет тенденцию к увеличению, когда органические транзисторы работают в расширенном временном масштабе. Это называется поведением напряжения смещения, и оно существенно влияет на применимость органических транзисторов в электрических цепях и реальных приложениях. И поэтому в настоящее время интенсивно исследуется [33, 34]. Гистерезис тока может быть вызван смещением порогового напряжения во временной шкале измерений вольтамперного сигнала.В органических запоминающих устройствах можно использовать большие стабильные пороговые сдвиги, например, вызванные поляризацией сегнетоэлектрического диэлектрика затвора.
4. Органические полупроводниковые материалы
Подвижность органических полупроводников достигла значительного прогресса в OFET по сравнению с первоначально сообщенными 10 −5 см 2 V −1 с −1 для политиофена в 1986 г. [35] до 10 см 2 V −1 с −1 для существующих полимеров на основе дикетопирролопиррола (DPP) [36].Высокая подвижность органических полупроводников по сравнению с обычным аморфным кремнием указывает на большой потенциал применения органических электронных устройств. Замечательный прогресс органических полупроводников открывает путь для органической электронной промышленности. Как правило, для высокоэффективных органических полупроводников важную роль играют некоторые критические факторы, такие как молекулярная структура, упаковка молекул, электронная структура, выравнивание энергии и чистота. Среди них настройка молекулярной упаковки особенно важна для высокоэффективных полупроводников, поскольку перенос носителей заряда осуществляется вдоль молекулярных π-орбиталей.Следовательно, степень перекрытия соседних молекулярных орбиталей существенно определяет подвижность носителей заряда. Молекулярная упаковка с сильными межмолекулярными взаимодействиями благоприятствует эффективному переносу заряда и высокой полевой подвижности. Электронная структура и уровни энергии имеют решающее значение для материалов и стабильности устройства. Чтобы получить высокоэффективные и стабильные органические полупроводники, необходима структурная модификация с помощью доноров и акцепторов электронов. За исключением упомянутых выше аспектов, морфология пленки, такая как границы зерен, также может влиять на перенос носителей заряда.Границы зерен и неупорядоченные домены могут препятствовать эффективному межмолекулярному скачку заряда между ними. Следовательно, увеличение размера кристаллического зерна и однородности пленки может эффективно улучшить перенос заряда и подвижность. В этом разделе мы представляем некоторые особенности соединений с подвижностью аморфного кремния / над аморфным кремнием и / или с высокой стабильностью.
4.1. Полупроводники P-типа
За последние два десятилетия полупроводниковые материалы p-типа достигли большого прогресса благодаря своей простой конструкции и синтетическому подходу.Органические полупроводники P-типа в основном содержат ацен, гетероацен, тиофены, а также их коррелированные олигомеры и полимеры, а также двумерные (2D) дискообразные молекулы. Подробная информация об этих соединениях содержится в нескольких исчерпывающих обзорах [32, 36]. Среди них полициклические ароматические углеводороды являются наиболее представительными в классе соединений благодаря своим уникальным свойствам. Некоторые типичные полупроводники p-типа показаны на диаграмме 1.
Диаграмма 1.
Химическая структура некоторых полупроводниковых материалов p-типа.
Пентацен ( 1 ), как эталон органических полупроводников, впервые был описан в 1970-х годах, но многочисленные применения OFET были реализованы только недавно [37, 38]. Благодаря сильным межмолекулярным взаимодействиям и мотиву упаковки «елочкой» пентацен демонстрирует эффективный перенос заряда. Следовательно, поликристаллическая тонкая пленка пентацена ( 1 ) и тетрацена ( 2 ) показала удивительно высокую подвижность, приближающуюся к 0,1 см 2 V -1 с -1 [37] и 3.0 см 2 V −1 s −1 [39] соответственно. Замещенное производное тетрацена рубрен ( 3 ) показало самую высокую подвижность носителей заряда с 20 см 2 V −1 s −1 для монокристаллического устройства в конфигурации FET [40]. Это означает, что сопряженный ацен является хорошим строительным блоком для полупроводников p-типа. Позже сообщалось о фталоцианинах ( 4 ) и более протяженных ядрах гекса- пери -бензокороненов (HBC) ( 5 ), содержащих двумерное (2D) ароматическое ядро, и в них были обнаружены типично дискотичные столбчатые жидкокристаллические фазы.В результате HBC показал повышенную подвижность вдоль колонки за счет твердотельной организации. Более того, OFET на основе HBC методом зонной разливки продемонстрировали высокую подвижность до 0,01 см. 2 V −1 s −1 [41]. Химия на основе ацена проложила путь к созданию эффективных полупроводниковых материалов p-типа.
Серосодержащие гетероацены и их производные составляют еще одну большую группу ароматических углеводородов p-типа, как показано на диаграмме 1.Тиеноацены и их производные также были синтезированы и исследованы как полупроводники для материалов p-типа. Асимметричный олигоацен, такой как тетраценотиофен ( 6 ), также был синтезирован и показал аналогичную подвижность (0,3 см 2 V −1 s −1 ) по сравнению с их центросимметричными аналогами, обработанными в тех же условиях. [42]. Тетратиеноацен ( 7 ) с арильными группами имел более высокую подвижность до 0,14 см. 2 V −1 s −1 при осаждении из паровой фазы [43].Считалось, что взаимодействие серы и серы в мотиве упаковки усиливает перенос носителей заряда. Введение серы и других гетероатомов вызвало различное выравнивание энергии и кристаллическую упаковку, что способствует развитию материалов p-типа.
Среди полимеров p-типа поли (3-гексилтиофен) (P3HT) ( 8 ) был тщательно изучен и показал высокую подвижность благодаря своим хорошим кристаллическим свойствам и хорошо упорядоченной ламельной структуре, которая способствует эффективному переносу заряда [ 44].И он широко используется в качестве донора электронов в органических солнечных элементах. Полимеры на основе DPP, такие как PDDPT-TT ( 9 ), были показаны как высокоэффективные полупроводниковые материалы с подвижностью дырок более 10 см. 2 V −1 s −1 . Кроме того, устройство продемонстрировало отличный срок хранения и стабильность работы в условиях окружающей среды. Наконец, были продемонстрированы инверторы с исключительно высоким коэффициентом усиления и функциональные кольцевые генераторы на гибких подложках [45, 46].
4.2. Полупроводники N-типа
Хотя полупроводниковые материалы p-типа достигли значительного прогресса, разработка органических полупроводников n-типа все еще отстает от органических полупроводников p-типа из-за низкой производительности устройства, нестабильности окружающей среды и сложного синтеза. Ввиду их важной роли в органической электронике, такой как p-n-переходы, биполярные транзисторы и дополнительные схемы, желательно разработать стабильные полупроводниковые материалы n-типа с высокой подвижностью носителей заряда для органических полевых транзисторов.
На сегодняшний день органические полупроводники n-типа с высокой подвижностью относительно редки и значительно отстают от полупроводников p-типа, и большинство материалов n-типа все еще нестабильны на воздухе в условиях окружающей среды из-за своей высокой и самой низкой незанятой молекулярной орбитали (LUMO). ) уровень энергии. De Leeuw et al. предположил, что проблема нестабильности воздуха возникает из-за окислительно-восстановительной реакции с кислородом и водой [47]. Основываясь на этом результате, мы можем рассчитать уровень энергии НСМО, и он должен быть ниже -3,97 эВ, чтобы быть стабильным по отношению к воде и кислороду.Органические полупроводники N-типа в основном содержат галоген или цианозамещенные полупроводники n-типа, которые можно преобразовать из материалов p-типа, производных перилена, производных нафталина, материалов на основе фуллерена и т. Д. (Диаграмма 2).
Диаграмма 2.
Химическая структура некоторых полупроводниковых материалов n-типа.
Важный полупроводниковый материал n-типа перфторпентацен ( 11 ) впервые был описан Сакамото и др. [48]. Эта молекула имеет такую же кристаллическую упаковку, что и пентацен, а транзисторы, изготовленные из пленок, полученных вакуумным напылением, показали высокую подвижность вплоть до 0.11 см 2 V −1 с −1 и отношение включения / выключения 10 5 . Считалось, что присоединение атомов фтора может снизить уровень энергии НСМО этого соединения. Однако уровень энергии НСМО недостаточно низкий, чтобы сделать устройство OFET стабильным в условиях окружающей среды. Аналогичным образом 2,5,8,11,14,17-гексафтор-гекса- пери -гексабензокоронен был синтезирован Kikuzawa et al. из гексакис (4-фторфенил) бензола [49]. Это фторированное соединение также подходило для изготовления n-канальных транзисторов из-за пониженного уровня энергии НСМО, показав подвижность 1.6 × 10 −2 см 2 V −1 с −1 и отношение включения / выключения 10 4 . Основываясь на этих результатах, они показали, что замещение галогена является подходящим способом получения полупроводников n-типа.
Производные нафталиндиимида ( 12 ) и перилендиимида ( 13 ) являются двумя наиболее изученными материалами n-типа, используемыми в OFET. Простые диимиды нафталина и перилена могут быть получены из бисангидридов и первичных аминов. Как правило, ароматический диимид в транзисторах проявляет характер n-типа из-за функционализации имида.Затем добавляли циано или галоген для улучшения стабильности на воздухе. Нафталиндиимид, замещенный электроноакцепторными группами CN в положении ядра, был описан Jones et al. [50]. Эта молекула показала подвижность до 0,11 см. 2 V -1 s -1 , а также хорошую стабильность при окружающей среде по сравнению с незамещенным соединением. Цианозамещенный перилендиимид также был описан той же группой [51]. Также наблюдалась хорошая стабильность на воздухе, что указывает на то, что цианозаместитель является еще одним эффективным способом снижения уровня энергии НСМО и получения стабильных материалов n-типа.Позже следует упомянуть NDI с расширением ядра, несущий две 2- (1,3-дитиол-2-илиден) малонитрильные группы в ядре ( 14 ) из-за его хорошей обрабатываемости в растворе и хорошей стабильности на воздухе [52] .
На основании этих результатов можно было сделать вывод, что существует эффективный способ получения стабильных материалов n-типа, комбинируя имидную функционализацию и циано- или галогеновые замены. Электронодефицитные ароматические диимиды, такие как овалендиимид (ODI-CN), привлекают все большее внимание как перспективные полупроводники n-типа для OFET ( 15 ) [53].Материалы этого класса показали не только высокопланарную сопряженную основную цепь, но и легко настраиваемые электронные свойства за счет основных и имидно-азотных заместителей с электроноакцепторными группами и алкильными цепями, соответственно.
Подобно малым органическим молекулам, высокоэффективные полимеры n-типа, о которых сообщалось до сих пор, намного реже, чем полимеры p-типа. Однако для создания дополнительных схем и пластиковой электроники крайне важна разработка полимерных полупроводников с высокими рабочими характеристиками и хорошей стабильностью на воздухе.Согласно предыдущим работам, наиболее многообещающими результатами для полимеров n-типа является полимер на основе нафталина (P (NDI2OD-T2)), который продемонстрировал беспрецедентно высокие характеристики с подвижностью> 0,1 см. 2 V −1 с −1 (до 0,85 см 2 V −1 с −1 ) и соотношением включения / выключения 10 6 и отличной стабильностью воздуха в условиях окружающей среды. Кроме того, полупроводники можно обрабатывать методами глубокой печати, флексографии и струйной печати, а также получать полностью печатные полимерные комплементарные инверторы (с коэффициентом усиления 25–65) [54].
5. Технологии изготовления
Осаждение полупроводников является определяющим этапом изготовления OFET. И это существенно повлияет на производительность устройств. Здесь мы познакомимся с некоторыми важными методами, обычно используемыми при изготовлении OFET.
5.1. Вакуумное испарение
Этот метод позволяет осаждать и очищать низкомолекулярные органические полупроводники. Процесс выполняется в сверхвысоком вакууме. Органический полупроводниковый материал помещают в металлическую лодочку и нагревают с помощью эффектов Джоуля или электронной пушки, а подложку помещают над лодочкой, чтобы обеспечить рост и образование органических материалов.В принципе, таким способом нельзя осаждать высокомолекулярные органические полупроводники, потому что они слишком тяжелые для испарения и имеют тенденцию к разложению при высоких температурах. Основное преимущество вакуумного напыления — легкий контроль чистоты и толщины нанесенной пленки. Между тем, эти высокоупорядоченные кристаллические тонкие пленки можно реализовать, контролируя скорость осаждения и температуру подложки. Его главный недостаток — необходимость в сложных инструментах.Это отличается от техники обработки раствора, которая проста и недорога.
5.2. Жидкое осаждение
Жидкое осаждение является важной частью большинства процессов изготовления OFET, как для нанесения активных слоев, так и для управления слоями, нанесенными другими способами. Многие органические полупроводниковые материалы были разработаны так, чтобы быть растворимыми или диспергируемыми в растворах, что дает возможность для изготовления устройства. Многие стратегии были применены к осаждению органических полупроводников для использования в OFET.Общие методы осаждения включают центрифугирование, литье в каплю, нанесение покрытия погружением, нанесение покрытия распылением и нанесение покрытия валиком (рис. 4) [55].
Рис. 4.
Схематическое изображение обсуждаемых методов осаждения на основе раствора. Воспроизведено с разрешения Ref. [55]. Авторское право 2014 г., Королевское химическое общество.
Печать включает в себя семейство методов и позволяет одновременно наносить и создавать узор на целевом материале. Этот метод в основном включает печать с выбросом капель, печать контактных штампов, методы косвенной и офсетной печати и выдачу капиллярных игл.Сравнение этих методов с точки зрения преимуществ и недостатков было опубликовано в некоторых обширных обзорах [55, 56]. Среди них пьезоструйная печать доминирует в технологиях производственной печати OFET из-за ее превосходной совместимости и доступности сложных печатающих головок для сообщества разработчиков. В этом методе некоторые параметры, такие как вязкость чернил, поверхностное натяжение чернил и поверхностная энергия подложки, имеют решающее значение для выброса и осаждения капель. Необходимо контролировать растекание и сушку капель, чтобы избежать эффекта «кофейного кольца» и образования массивов с точным узором.Некоторые методы, такие как сочетание кристаллизации в антирастворителе и струйной печати, использовались для получения тонких пленок с высокой степенью кристалличности органических полупроводников. С помощью этого подхода были получены тонкопленочные транзисторы со средней подвижностью носителей до 16,4 см 2 V −1 с −1 на основе монокристаллических тонких пленок 2,7-диоктил [1] бензотиено [ 3, 2-b] [1] бензотиофен (C8-BTBT) [57].
5.3. Выравнивание тонкой пленки
Осаждение кристаллических органических полупроводников с контролируемой ориентацией в плоскости является одной из важных задач для высокоэффективных OFET.Принято считать, что перенос заряда в органических материалах происходит посредством прыжкового механизма, который зависит от степени перекрытия орбиталей между молекулами. Поскольку в органических полупроводниках носители заряда предпочтительно транспортируются вдоль направления π-π укладки, макроскопически ориентированные органические пленки обладают потенциально более высокой подвижностью и обеспечивают более необычные свойства, такие как оптически и электрически анизотропные характеристики. Поэтому многие методы осаждения были исследованы для формирования рисунка и выравнивания органических полупроводников [56].Эти методы в основном включают (1) выравнивание механических сил, таких как перенос трения, наноимпринтинг и метод Ленгмюра-Блоджетт (LB); (2) нанесение органических полупроводников непосредственно на ориентирующие слои, полученные различными методами, такими как трение и фотооблучение; (3) выращивание органических полупроводников на неорганических монокристаллах; (4) использование выравнивания, вызванного магнитным или электрическим полем; (5) использование технологии обработки в растворе для выравнивания органических полупроводников на изотропных подложках.
Среди методов обработки раствора традиционные методы, такие как центрифугирование и литье по каплям, не могут контролировать ориентацию тонкой пленки. Поэтому для решения этой проблемы использовались некоторые методы. Например, зонное литье предлагает способ контролировать ориентацию нанесенных слоев. В этом процессе непрерывно подаваемый горячий раствор наносится с помощью сопла на движущуюся опору с контролируемым температурным режимом. При соответствующих скоростях подачи раствора и испарения растворителя внутри мениска образуется стационарный градиент концентрации, который приводит к направленной кристаллизации [58].Покрытие погружением — еще один метод, обеспечивающий лучшее выравнивание тонких пленок в устройствах, обработанных раствором [59, 60]. Этот процесс можно контролировать с помощью скорости подъема подложки, испарения растворителя и капиллярного потока. Выбор растворителя особенно важен из-за его влияния на скорость испарения растворителя. Скорость сушки, которая влияет на морфологию тонких пленок, можно количественно контролировать во время процесса нанесения покрытия погружением, регулируя скорость подъема подложки.
Осаждение из раствора — это недавно разработанный подход, который позволяет наносить высококристаллические и ориентированные тонкие пленки на изотропные подложки [61].Этот метод связан с ракельным ножом, при котором для распределения вязкого раствора по субстрату используется лезвие. Небольшой объем разбавленного органического раствора зажат между двумя предварительно нагретыми кремниевыми подложками, которые перемещаются относительно друг друга с контролируемой скоростью. Верхняя пластина действует как режущий инструмент и считается гидрофобной, а нижняя пластина действует как подложка устройства. Движение пластин обнажает фронт жидкости, который быстро испаряется, образуя затравочную пленку, состоящую из множества кристаллических зерен.Эти кристаллы действуют как центры зародышеобразования и позволяют оставшимся молекулам в растворе расти вдоль направления сдвига (рис. 5) [61]. Сообщалось, что с помощью этого метода могут быть сформированы метастабильные мотивы упаковки молекул (или кристаллическая структура с деформированной решеткой), которые могут изменять межмолекулярное расстояние π-π упаковки и улучшать свойства переноса заряда [62].
Рис. 5.
Схематическая диаграмма метода сдвига раствора (a) и (b), полученные с помощью кросс-поляризованного оптического микроскопа, изображения срезанных на раствор тонких пленок TIPS-пентацена, сформированных со скоростью сдвига 04 мм / с. Адаптировано с разрешения Ref. [62]. Авторское право 2011, Издательская группа Nature.
Покрытие с помощью щелевого штампа также является многообещающим методом управления выравниванием тонких пленок и процессом самосборки для приложений OFET. Доказано, что это упрощенный и технологичный подход к изготовлению высокопроизводительных полевых транзисторов большой площади. Этот метод позволяет экономить сырье и надежно, точно и воспроизводимо контролировать однородность пленки. Покрытие щелевого штампа масштабируется до больших площадей и, следовательно, применимо для изготовления недорогой электроники большой площади.Мы впервые применили эту технику при изготовлении OFET [63]. Рисунок 6 схематически иллюстрирует этот процесс. Пластина вакуумного отсоса с регулируемой температурой использовалась для фиксации и предварительного нагрева подложек до определенной температуры. Небольшой объем органического раствора наносится на модифицированную поверхность подложки с помощью щелевой фильеры с различными зазорами покрытия от 15 до 90 мкм. Скорость отсадки регулируется в диапазоне 0,1–19,9 мм / с. Предварительно экспонированная затравочная пленка может действовать как центры зародышеобразования и позволять оставшимся молекулам в растворе расти вдоль направления покрытия [63].
Рис. 6.
Схема нанесения покрытия щелевым штампом и АСМ-изображение пленки с наложенной молекулярной структурой. (a), (b) и (c) указывают кристаллические оси кристаллической структуры. Адаптировано с разрешения [63]. Авторское право 2013, WILEY-VCH Verlag GmbH & Co. KGaA, Вайнхайм.
6. Выводы и перспективы на будущее
В целом за последние несколько лет в разработке, синтезе и переработке органических полупроводников был достигнут впечатляющий прогресс.В будущем органические полупроводники станут более привлекательными благодаря сопоставимым характеристикам с традиционными аморфными неорганическими полупроводниковыми материалами и их почти бесконечной возможности настройки. Между тем, для крупномасштабного производства недорогих устройств весьма желательны процессы осаждения пленок на основе растворов при низких температурах с высокой подвижностью носителей заряда.
В настоящее время больше внимания уделяется обрабатываемым в растворе стабильным на воздухе высокоэффективным органическим полупроводникам n-типа; взаимосвязь между молекулярной структурой органического полупроводника и характеристиками устройства; и выравнивание тонкой пленки полупроводника большой площади.Между тем, некоторые важные вопросы все еще требуют дальнейшего изучения, такие как стабильность работы, недорогой процесс изготовления на больших площадях, интеграция устройств, а также функционализация сенсорных полей. Изучение дефектной электронной структуры органических полупроводников также будет важной темой в ближайшие годы.
Таким образом, хотя органические материалы и устройства все еще имеют некоторые недостатки, их можно улучшить и использовать в широком спектре недорогих функциональных устройств для удовлетворения потребностей различных рынков, и они обязательно станут уникальной особенностью нашей продукции. жизнь в будущем.
Переходные полевые транзисторы
— JFETs
Теперь есть обновленные и расширенные версии наших страниц FET по адресу https://learnabout-electronics.org/Semiconductors/fet_01a.php.
Нажмите зеленую кнопку, чтобы перейти к новым версиям
Перейти на новую страницу
JFET (переходные полевые транзисторы)
Хотя существует множество запутанных названий полевых транзисторов (FET), в основном существует два основных типа:
1.Типы PN-перехода с обратным смещением, JFET или Junction FET (также называемые JUGFET или Junction Unipolar Gate FET).
2. Устройства на полевых транзисторах с изолированным затвором (IGFET).
Все полевые транзисторы можно назвать УНИПОЛЯРНЫМИ устройствами, потому что носители заряда, которые переносят ток через устройство, все одного типа, то есть либо дырки, либо электроны, но не то и другое вместе. Это отличает полевые транзисторы от биполярных устройств, в которых и дырки, и электроны ответственны за ток в любом одном устройстве.
JFET
Это был самый ранний из доступных полевых транзисторов. Это устройство, управляемое напряжением, в котором ток течет от вывода SOURCE (эквивалент эмиттера в биполярном транзисторе) к DRAIN (эквивалент коллектору). Напряжение, приложенное между выводом истока и выводом GATE (эквивалентным базе), используется для управления током истока-стока. Основное различие между JFET и биполярным транзистором состоит в том, что в JFET ток затвора не течет, ток через устройство управляется электрическим полем, отсюда и «полевой транзистор».Конструкция полевого транзистора и символы схем показаны на рисунках 1, 2 и 3.
Конструкция JFET
Конструкция JFET может быть теоретически довольно простой, но на самом деле сложной, требуя очень чистых материалов и методов чистых помещений. Полевые транзисторы JFET изготавливаются в различных формах, некоторые из которых выполнены в виде дискретных (одиночных) компонентов, а другие — с использованием планарной технологии в качестве интегральных схем.
Рис. 1.1 Конструкция диффузионного полевого транзистора
На рис. 1.1 показана (теоретически) простейшая форма конструкции Junction FET (JFET) с использованием методов диффузии.Он использует небольшую пластину из полупроводника N-типа, в которую вливаются две области P-типа, образующие затвор. Ток в форме электронов течет через устройство от истока к стоку по кремниевому каналу N-типа. Поскольку только один тип носителей заряда (электроны) переносит ток в полевых транзисторах с N каналом, эти транзисторы также называют «униполярными» устройствами.
Посмотрите, как работает интерактивная диаграмма
Рис. 1.2 Планарная конструкция JFET
На рис. 1.2 показано поперечное сечение полевого транзистора с N-канальным плоским переходом (JFET). Ток нагрузки протекает через устройство от истока к стоку по каналу, сделанному из кремния N-типа.В планарном устройстве вторая часть затвора образована подложкой P-типа.
Также доступны полевые транзисторы с P-каналом
и принцип работы такой же, как и для типа N-канала, описанного здесь, но полярности напряжений, конечно, обратные, а носителями заряда являются дырки.
Рис. 1.3 Обозначения цепей JFET
Обновлено 14 июля 2010 г.
Начало страницы След.
Глава 4. Полевые транзисторы.Металлооксидный полупроводниковый полевой транзистор (MOSFET) и переходной полевой транзистор (JFET)
Полевые транзисторы (FET)
Полевые транзисторы (FET) Литература: Hayes & Horowitz (стр. 142-162 и 244-266), Rizzoni (главы 8 и 9) В полевом транзисторе (FET) ширина проводящего канала в полупроводнике и ,
Подробнее
Полупроводниковые приборы
emicoductor evices Проф.Збигев Лисик epartmet of emicoductor ad Optoelectroics evices room: 116 e-mail: [email protected] Uipolar устройства IFE T&C JFET Trasistor Uipolar evices — Trasistors asic
Подробнее
МОП-транзистор
MOSFET-транзистор Основным активным компонентом всех кремниевых микросхем является MOSFET-металлооксидный полупроводниковый полевой транзистор. Условное обозначение G Затвор S Источник D Сток Напряжение на затворе управляет
Подробнее
Смещение в усилителях MOSFET
Смещение в усилителях с МОП-транзисторами Смещение: создание схемы для установления желаемых напряжений и токов постоянного тока для работы усилителя. Четыре распространенных способа :.Смещение путем фиксации GS. Смещение при фиксации
Подробнее
Простая линейная регрессия
Smple Lear Regresso Regresso equato эквивалент, который описывает среднее отношение между переменным respose (депедет) и эплатором (депедетом). 6 8 Экваториальный уклон-переход для левого склона (, 6). (,) 6 6 8
Подробнее
Лекция №21. Структура МОП-конденсатора
Лекция № 21 ОБЗОР Электротатации MOS-апактора Читать: oure Reader EE130 Lecture 21, Slde 1 MOS apactor Structure MOS capactor (croectonal vew _ TE x EE130 Lecture 21, Slde 2 Typcal MOS capactor and trantor
Подробнее
Пиковое обратное напряжение
13.09.2005 Пиковое инерциальное напряжение.doc 1/6 Пиковое инерционное напряжение В: Я так запутался! И прямоугольный, и полный прямоугольный прямоугольник обеспечивают прямую связь. Тем не менее, прямоугольный прямоугольник использует 4 дуги перехода, тогда как
Подробнее
Декларация SPICE MOSFET
Объявление SPICE MOSFET MOSFET — это 4-оконечное устройство, которое указано в списке соединений как: Mname ND NG NS NB ModName Необязательные параметры: L = значение W = значение AD = значение AS = значение PD = значение
Подробнее
Мостовой выпрямитель
04.09.2004 г. Brdge ectfer.doc 1/9 The Brdge ectfer Теперь рассмотрим, как это сделано: 1 Lne (t) — O (t) _ 4 3 Мы называем это crcut прямоугольником. Давайте проанализируем t и посмотрим, что t делает! Во-первых, ср
Подробнее
Основы CV-измерения
Основы V-измерения M-конденсатор V-измерение Измерение дифференциала малой модуляцией переменного тока напряжения смещения (dc d d G G M j G M ω M j ω Y M G M G M Многозначная точка обзора и диаграмма (здесь
Подробнее
Глава 10 Расширенные схемы CMOS
Шлюзы передачи Глава 10 Расширенные схемы CMOS Шлюз передачи NMOS Активная схема инвертора подтягивания заставляет задуматься об альтернативных вариантах использования устройств NMOS.Рассмотрим схему, показанную в
Подробнее
Полноволновой выпрямитель
9/3/2005 The Full Wae ectfer.doc / 0 The Full-Wae ectfer Consder the following juncton dode crcut: s (t) Power Lne s (t) 2 Обратите внимание, что мы используем трансформатор с таким расчетом. Работа трансформатора к
Подробнее
Полевые транзисторы
506 19 Принципы работы с полевыми транзисторами в электронике 191 Типы полевых транзисторов 193 Принципы и работа полевого транзистора с полевым транзистором 195 Важность полевого транзистора с полевым транзистором 197 в качестве усилителя 199 Существенные особенности
Подробнее
Основы массопереноса
Глава Fudametals массового переноса Когда в системе фазовой фазы присутствуют две или более разновидностей, чьи коцетрато не имеют формы, масса переносится на другие коцетратообразцы в системе.I многофазная система
Подробнее
Анализ схем в s-области
S-Doman naly -Doman rcut naly Tme doman t doman около rcut aplace Tranform omplex frequency doman doman Transformed rcut Dfferental Equaton lacal technque epone waveform aplace Transform nvere Tranform —
Подробнее
МОП-конденсатор ГЛАВА ЦЕЛИ
Hu_ch05v3.fm Page 157 Friday, February 13, 2009 2:38 PM 5 МОП-конденсатор ЦЕЛИ ГЛАВЫ Эта глава позволяет глубже понять современные МОП-структуры (металлооксидные полупроводники). Ключевые темы
Подробнее
Простая модель линейной регрессии
Простая модель Regresso Model Correlato Coffcet s o-parameter просто указывает, что два переменных связаны друг с другом, но это не дает никакого отношения к корреляции.Модели Regresso помогают vestgatg
Подробнее
ПРИЛОЖЕНИЕ III СОБСТВЕННОСТЬ КОНВЕРТА
Приложение III ПРИЛОЖЕНИЕ III СОБСТВЕННОСТЬ «КОНВЕРТ» Optmzato представляет очень строгую структуру для решения поставленной задачи. Вот причина того, почему эоклассические экоомки, которые предполагают, что поведение optmzg являются наиболее успешными
Подробнее
(6) (2) (-6) (- 4) (-4) (6) + (-2) (- 3) + (4) (3) + (2) (- 3) = -12-24 + 24 + 6 + 12 6 = 0
Глава 3 Домашнее задание Soluton P3.-, 4, 6, 0, 3, 7, P3.3-, 4, 6, P3.4-, 3, 6, 9, P3.5- P3.6-, 4, 9, 4 ,, 3, 40 ————————————————- — P 3.- Определите значения, 4, 3 и 6
Подробнее
α α λ α = = λ λ α ψ = = α α α λ λ ψ α = + β => θ θ β> β β θ θ θ β θ β γ θ β = γ θ> β> γ θ β γ = θ β = θ β = θ β = β θ = β β θ = = = β β θ = + α α α α α = = λ λ λ λ λ λ λ = λ λ α α α α λ ψ + α =
Подробнее
1.Временная стоимость денег
Корпоративное лицо [00-0345]. Временная ценность Moey. Compoudg и Dscoutg Captalzato (compoudg, fdg future values) — это процесс перемещения значения вперед во времени. Это дает будущую ценность для релевантного компьютера
.
Подробнее
Интегральные схемы и системы
Федеральный университет Санта-Катарина Центр технологий Компьютерные науки и электроника Интегральные схемы и системы INE 5442 Лекция 11 MOSFET часть 2 guntzel @ inf.ufsc.br I D -V DS Характеристики
Подробнее
Численные методы в MS Excel
TMME, vol4, o.1, p.84 Числовые методы с MS Excel М. Эль-Гебели и Б. Юшау 1 Отдел математических сцен Кг Фахд Уверсты из Petroleum & Merals. Дхахра, Сауд Араба. Аннотация: Мы покажем, как
Подробнее
Формулы базовой статистики
С комплементом таттметра.com, te для старой справки Set De Morga Law Bac tattc formula Meaure of Locato Sample mea (AUB) c A c B c Commutatvty & (A B) c A c U B c A U B B U A ad A B B A Aocatvty
Подробнее
РАСЧЕТ СИСТЕМЫ ЗАЗЕМЛЕНИЯ
РАСЧЕТ СИСТЕМЫ ЗАЗЕМЛЕНИЯ BAZIAN STEAL FACTORY S / S 132 / 11kV, 1×30 / 40MVA Курдистан, регион Сулеймани Май 2011 года Bazian Steal Factory S / S 132 / 11kV, 1×30 / 40 MVA Содержание: 1. Введение… 3 2. Список литературы
Подробнее
КМОП дифференциальный усилитель
МОП-дифференциальный усилитель. Текущие уравнения дифференциального усилителя DD D D (7 D (E D / G G GS GS G (0 E D / (G (a (b Рисунок. General MOS Differential Amplifier: (a Схематическая диаграмма, (b nput Gate oltaes
Подробнее
Введение в ремонтопригодность
Это продукт для обеспечения качества Концепция обеспечения качества включает в себя: операционную меру эффективности; характеристики дизайна; дополнительные характеристики, поддерживающие дизайн; стоимость продукта; производительность каждого этапа продукта
.
Подробнее
Бесплатный онлайн-курс: Транзистор — полевой транзистор и биполярный переходный транзистор от Coursera
Демистификация стратегии SEO-контента: Coursera, MasterClass и edX
Посмотреть
близко
Класс Центральный
Курсы
Субъекты
Информационные технологии
Здоровье и медицина
Математика
Бизнес
Гуманитарные науки
Инженерное дело
Наука
Образование и обучение
Социальные науки
Художественный дизайн
Data Science
Программирование
Личное развитие
Все предметы
Просмотреть все предметы
Ежемесячные отчеты о курсе
Начиная с этого месяца
Новые онлайн-курсы
Самостоятельный темп
Самый популярный
Курсы от
900+ университетов
Меню
Информационные технологии
Информационные технологии
Искусственный интеллект
Алгоритмы и структуры данных
Интернет вещей
Информационные технологии
Кибер-безопасности
Компьютерная сеть
Машинное обучение
DevOps
Глубокое обучение
Блокчейн и криптовалюта
Квантовые вычисления
Посмотреть все компьютерные науки
Здоровье и медицина
Здоровье и медицина
Питание и благополучие
Болезни и расстройства
Здравоохранение
Здравоохранение
Уход
Анатомия
Ветеринарная наука
Посмотреть все Здоровье и медицина
Математика
Математика
Статистика и вероятность
Основы математики
Исчисление
Алгебра и геометрия
Посмотреть всю математику
Бизнес
Бизнес
Менеджмент и лидерство
Финансы
Предпринимательство
Развитие бизнеса
Маркетинг
Стратегическое управление
Специфическая отрасль
Бизнес-аналитика
Бухгалтерский учет
Отдел кадров
Управление проектом
Продажи
Дизайн-мышление
Реклама
Программное обеспечение для бизнеса
Посмотреть все Бизнес
Гуманитарные науки
Гуманитарные науки
История
Литература
Иностранный язык
Грамматика и письмо
Философия
Религия
ESL
Культура
Виды спорта
Журналистика
Этика
Лингвистика
Просмотреть все гуманитарные науки
Инженерное дело
Инженерное дело
Электротехника
Инженерное дело
Гражданское строительство
Робототехника
Нанотехнологии
ГИС
.
